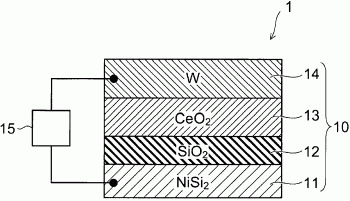
专利摘要
提供了一种通/断比高的变阻型存储装置。根据一个实施方的变阻型存储装置包括:第一电极,包含第一元素;电阻变化层,设置于所述第一电极上,包含所述第一元素的氧化物;氧传导层,设置于所述电阻变化层上,包含第二元素和氧,具有氧离子传导性,并且其相对介电常数高于所述电阻变化层的相对介电常数;以及第二电极,设置于所述氧传导层上。在使所述第一电极和所述第二电极之间的电压从零连续地增加时,所述电阻变化层在所述氧传导层之前经历电介质击穿。
权利要求
1.一种变阻型存储装置,包括:
第一电极,包含第一元素;
电阻变化层,设置于所述第一电极上,包含所述第一元素的氧化物;
氧传导层,设置于所述电阻变化层上,包含第二元素和氧,具有氧离子传导性,并且其相对介电常数高于所述电阻变化层的相对介电常数;以及
第二电极,设置于所述氧传导层上,并且
变阻型存储装置被配置为使得在所述第一电极和所述第二电极之间的电压从零连续地增加时,所述电阻变化层先于所述氧传导层经历电介质击穿。
2.根据权利要求1所述的变阻型存储装置,还包括电源电路,该电源电路被配置来在所述第一电极和所述第二电极之间施加电压,
满足如下数学式,
其中,Vapp是所述电源电路能够输出的电压,EVRBD是所述电阻变化层的电介质击穿所需的电场强度,tVR是所述电阻变化层的厚度,kVR是所述电阻变化层的相对介电常数,tOC为所述氧传导层的厚度,kOC为所述氧传导层的相对介电常数数学式。
3.根据权利要求1所述的变阻型存储装置,其中所述第一元素的电负性和氧的电负性之间的差的绝对值小于所述第二元素的电负性和氧的电负性之间的差的绝对值。
4.根据权利要求1所述的变阻型存储装置,其中所述电阻变化层由共价键合的氧化物构成。
5.根据权利要求1所述的变阻型存储装置,其中所述第一元素是硅。
6.根据权利要求5所述的变阻型存储装置,其中所述第一电极由包含杂质的硅或金属硅化物形成。
7.根据权利要求1所述的变阻型存储装置,其中所述第一电极由这样的材料形成,通过所述材料,通过局部阳极氧化,形成与所述电阻变化层的材料相同种类的材料。
8.根据权利要求1所述的变阻型存储装置,其中所述氧传导层由离子性地结合的氧化物构成。
9.根据权利要求1所述的变阻型存储装置,其中所述氧传导层的晶体结构是荧石型的。
10.根据权利要求1所述的变阻型存储装置,其中所述氧传导层含有从由氧化铈、氧化铪、氧化锆、氧化钛、钛酸锶以及氧化钇稳定的氧化锆构成的群组中选择的一种或多种氧化物。
11.根据权利要求10所述的变阻型存储装置,其中所述氧传导层由氧化铈构成。
12.根据权利要求1所述的变阻型存储装置,其中所述第二电极由不与所述第二元素反应的材料形成。
说明书
技术领域
本发明涉及变阻型存储装置。
背景技术
近年来,已经发现这样一种现象,当对某些种金属氧化物施加电压时,该金属氧化物的电阻值在两种水平的值之间变化,并提出了利用该现象的存储装置。这种存储装置被称为变阻型存储装置(电阻随机存取存储器:ReRAM)。
图14A-14C是示意性地示出了常规的变阻型存储装置的操作的图,图14A示出了初始状态,图14B示出了低电阻状态,而图14C示出了高电阻状态。
图15是示出了常规的变阻型存储装置的I-V特性的图,其中横轴取电压,纵轴取电流。
如图14A所示,在常规的变阻型存储装置101的存储器单元110中,下部电极111、电阻变化层112以及上部电极113按该顺序被层叠。另外,在变阻型存储装置101中设置有电源电路115,该电源电路115连接于下部电极111与上部电极113之间。电阻变化层112由金属氧化物构成,并包含大量的缺氧部114。缺氧部114是其中氧的浓度相对低而金属的浓度相对高的部分。在初始状态下,缺氧部114随机地分散在电阻变化层112中,并且电阻变化层112具有高的电阻值。在图15中,初始状态被示出为状态S0。
如图15中的操作M1所示,当电源电路115对下部电极111和上部电极113之间施加使上部电极113成为正极而下部电极111成为负极的电压(正电压)时,如图14B所示,在电阻变化层112中形成由缺氧部114构成的电流路径。该电流路径被称为“细丝(filament)”,并且将在处于初始状态的电阻变化层112中形成细丝116的操作称为“成形”。由此,如在图15中的状态S1所示,电阻变化层112转变为低电阻状态(LRS),流过大的电流。电源电路115设置有电流限制机构,流过存储器单元110的电流限制为例如5mA或更小。
接着,如图15中操作M2所示,使施加在下部电极111和上部电极113之间的电压连续地减少为负电压。于是,如图15中状态S2所示,在电压达到规定的负的值时,电阻变化层112转变为高电阻状态(HRS),流过的电流降低。将该操作称为“复位(reset)”。据推测,在高电阻状态下,缺氧部114从细丝116的一端部错位开,如图14C所示。
之后,如图15中操作M3所示,当使电压持续地接近零时,I-V特性根据欧姆定律变化,而电阻变化层112仍保持高电阻状态。然后,当电压增加过零并达到某一正值时,如图15中状态S3所示,电阻变化层112回到低电阻状态,电流不连续地增加。该操作被称为“置位(set)”。此时,推测认为细丝116的缺失部被恢复并再次连续地布置在下部电极111与上部电极113之间,如图14B所示。
此后,可以通过重复进行操作M2和M3,重复复位和置位,以在低电阻状态和高电阻状态之间任意切换。以这样的方式,能够在一个存储器单元上写入信息的两个值。可以通过检测在电极间施加规定的读取电压(例如,-0.1V的电压)时流过的电流的幅度,读取写入的信息。
然而,这样的常规变阻型存储装置具有如下问题:电阻值的通/断比(ON/OFF ratio)(即,在施加规定的读取电压时,在低电阻状态时流过的电流的幅度相对于在高电阻状态时流过的电流的幅度之比值)低。在图15所示的例子中,通/断比为约101。在该情况下,在将10个存储器单元串联连接并通过电流时,即使所有存储器单元都处于高电阻状态,也流过与一个存储器单元处于低电阻状态时基本等同的电流,并难以得到所存储的值。因此,如果通/断比低,则难以实现存储器单元的更高集成度。在其中在金属氧化物中形成细丝的常规系统的变阻型存储器单元中,通/断比最高为约102。
另外,在常规的变阻型存储装置中,需对初始状态下的电阻变化层实施成形。成形是基于期待在电阻变化层内偶然形成细丝,因此控制是困难的。
非专利文献1公开了这样的技术,其中将电阻变化层配置成薄膜来促进细丝的形成,而使得不需要进行成形。非专利文献1记载了如下内容:在(TiN/TiOx/HfOx/TiN)堆叠结构中,成形电压可以随着作为电阻变化层的HfOx膜的膜厚降低而降低,以及在将HfOx膜的膜厚设为3nm或更低时,能够使成形电压基本为零。
非专利文献2公开了这样的技术,其中通过在电阻变化层中添加不同种类的元素来导入缺陷,使得细丝更容易成形。非专利文献2记载了如下内容:在(Al/AlO:N/Al)堆叠结构中,可以通过在作为电阻变化层的(AlO:N)膜中引入氮来使成形电压与置位电压相等。
然而,非专利文献1和2中所公开的技术只能够使成形电压降低至与基本等于置位电压或其以下的程度,并且不能提高通/断比。因此,难以实现存储器单元的高度集成。
[引用列表]
[非专利文献]
非专利文献1:H.Y.Lee1,等人所著,Technical Digest of International electron Devices Meeting(IEDM)2008,p.297-300
非专利文献2:Wanki Kim,等人所著,2011Symposium on VLSI Technology Digest of Technical Papers.p.22-23
发明概述
[要解决的问题]
本发明的目的之一在于提供一种通/断比高的变阻型存储装置。
[用于解决问题的方案]
根据一个实施方式的一种变阻型存储装置包括:第一电极,包含第一元素;电阻变化层,设置于所述第一电极上,并包含所述第一元素的氧化物;氧传导层,设置于所述电阻变化层上,包含第二元素和氧,具有氧离子传导性,并且其相对介电常数高于所述电阻变化层的相对介电常数;以及第二电极,设置于所述氧传导层上。在使所述第一电极和所述第二电极之间的电压从零连续地增加时,所述电阻变化层在所述氧传导层之前经历电介质击穿。
附图说明
图1是示出根据一个实施方式的变阻型装置的剖面图。
图2A和2B是示出根据该实施方式的变阻型存储装置的操作的示意剖面图。图2A示出低电阻状态,图2B示出高电阻状态。
图3A和3B是示意性地说明该实施方式的效果的图,横轴取状态,纵轴取在施加固定的读取电压时流过的电流的幅度。图3A示出常规的装置,图3B示出该实施方式的装置。
图4是示出多晶二氧化铈(CeO2)和多晶的氧化钇稳定的氧化锆(poly-YSZ)的氧离子传导性的曲线图,横轴取温度,纵轴取氧离子的传导率。
图5是示出使得不需要成形的电阻变化层的厚度与氧传导层的氧离子传导性之间的关系的曲线图,横轴取电阻变化层的厚度,纵轴取氧传导层的氧离子传导率。
图6是示出不同因素对所需的置位电压的影响的曲线图,横轴取氧传导层的厚度,纵轴取置位电压。
图7A是示出第一示例的试样的剖面图,而图7B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
图8A是示出第一比较例的试样的剖面图,而图8B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
图9A是示出第一示例的试样的剖面的TEM照片,而图9B是示出第一比较例的试样的剖面的TEM照片。
图10A是示出第二示例的试样的剖面图,而图10B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
图11A是示出第二比较例的试样的剖面图,而图11B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
图12A是示出第三示例的试样的剖面图,而图12B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
图13A是示出第四示例的试样的剖面图,而图13B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
图14A至14C是示意性地示出常规的变阻型存储装置的操作的图。图14A示出初始状态,图14B示出低电阻状态,图14C示出高电阻状态。
图15是示出常规的变阻型存储装置的I-V特性的曲线图,横轴取电压,纵轴取电流。
具体实施方式
下面,参照附图来说明本发明的实施方式。
图1是示出了根据该实施方式的变阻型装置的剖面图。
如图1所示,在根据本实施方式的变阻型存储装置(以下,简单地将其称为“装置1”)中,设置有存储器单元10。在存储器单元10中,下部电极11、电阻变化层12、氧传导层13以及上部电极14按该顺序被层叠。例如,电阻变化层12与下部电极11及氧传导层13接触,氧传导层13与上部电极14接触。在装置1中,设置有在下部电极11和上部电极14之间施加电压的电源电路15。在本说明书中,为了便于说明,将从下部电极11向上部电极14的方向称为“向上”,将相反的方向称为“向下”;但这些与重力的方向无关。
首先,利用各部件的材料的示例来说明存储器单元10的结构。图1示出了下面说明的材料的化学式。但是,各部件的材料并不限于以下的例子。关于各部件所要求的材料的一般特性稍后说明。
下部电极11由包含硅(Si)的材料形成,例如由二硅化镍(NiSi2)形成。
电阻变化层12由共价键合的氧化物形成,例如由氧化硅(例如,二氧化硅(SiO2))形成。
氧传导层13是具有氧离子传导性的层,其由离子性结合的氧化物(诸如,氧化铈(CeOx)(例如,二氧化铈(CeO2))形成。
上部电极14由导电性材料(例如,钨(W))形成。
可以通过,例如,EB(电子束)气相沉积、溅射法、CVD(化学气相沉积)或ALD(原子层沉积)等,依次沉积二硅化镍、氧化硅、氧化铈以及钨,来在基板(未示出)上形成如这样的存储器单元10。替代地,可以在基板上依次沉积二硅化镍、氧化铈以及钨,之后可以执行热处理,来在由二硅化镍构成的下部电极11和由氧化铈构成的氧传导层13之间的界面处形成氧化硅层。
接着,说明根据本实施方式的变阻型存储装置的操作。
图2A和2B是示出了根据本实施方式的变阻型存储装置的操作的示意性剖面图。图2A示出了低电阻状态,而图2B示出高电阻状态。
如图1所示,在初始状态下,电阻变化层12由具有均匀组分的氧化硅形成,并且几乎不包括缺氧部。因此,在初始状态下,电阻变化层12具有高的绝缘性。
首先,说明“成形”的操作。
如图2A所示,通过电源电路15在下部电极11和上部电极14之间施加使下部电极11成为负极而使上部电极14成为正极的电压(以下称为“正电压”),并使该电压从零连续增加。由于由二氧化铈(CeO2)构成的氧传导层13的相对介电常数为约28,而由二氧化硅(SiO2)构成的电阻变化层12的相对介电常数为约4,因此氧传导层13的相对介电常数比电阻变化层12的相对介电常数高。另一方面,由于相对介电常数与电场强度之积是恒定的,因此在电阻变化层12中产生的电场的强度比在氧传导层13中产生的电场的强度高。因此,当该电压增加时,电阻变化层12先于氧传导层13经历电介质击穿。
由此,在电阻变化层12中形成缺氧部16在厚度方向上成线形伸展的电流路径17。缺氧部16是与周围相比氧浓度低且硅浓度高的部分。结果,电阻变化层12成为“低电阻状态”,并且电阻值不连续地减少。此时,缺氧部16中所包含的氧被离子化成氧离子18(O2-),受到电场的作用而被排放到处于正极侧的氧传导层13中。此外,氧传导层13由离子性地结合的氧化物形成,因此从一开始就包含大量的氧离子。在“低电阻状态”下,存储器单元10的电阻值几乎由氧传导层13的电阻值决定。在本说明书中,将电阻变化层12成为“低电阻状态”并且存储器单元10的电阻值几乎是氧传导层13的电阻值的情况称为“电阻变化层在氧传导层之前经历电介质击穿”。
接着,说明“复位”的操作。
如图2B所示,当通过电源电路15在下部电极11和上部电极14之间施加使下部电极11成为正极而使上部电极14成为负极的电压(以下称为“负电压”)时,朝向作为正极侧的电阻变化层12的力作用于氧离子18。由此,氧传导层13中的氧离子18向电阻变化层12依次移动。
已进入电阻变化层12的氧离子18的一部分到达缺氧部16而使缺氧部16消失。氧离子18的另一部分穿过电阻变化层12中并到达下部电极11,使下部电极11中所包含的硅氧化,例如,造成硅的局部阳极氧化。由此,以下部电极11的上表面为起始点,氧化硅19向电阻变化层12内部生长。通过这些作用,缺氧部16被再氧化来修复电介质击穿,使电流路径17的大部分或整体消失,因此,电阻变化层12成为“高电阻状态”。此时,如果电流路径17整体被消灭时,则电阻变化层12的电阻值恢复至成形前的值。在“高电阻状态”下,存储器单元10的电阻值几乎由电阻变化层12的电阻值决定。
接着,说明“置位”的操作。
如图2A所示,当通过电源电路15在下部电极11与上部电极14之间施加正电压时,电阻变化层12再次经历电介质击穿,并再形成由缺氧部16构成的电流路径17。由此,电阻变化层12返回到“低电阻状态”。此时,如果通过上述的“复位”消除了电流路径17的整体,则该“置位”时发生的现象将与上述的“成形”时发生的现象几乎相同,并且置位所需的置位电压与成形所需的成形电压几乎相等。
这样,在存储器单元10中,电阻变化层12重复电介质击穿和修复,由此具有低电阻状态和高电阻状态这两个状态,并存储信息。在复位时,氧传导层13对电阻变化层12供给氧离子,并且下部电极11对电阻变化层12供给硅;从而,修复电阻变化层12的电介质击穿。
接着,说明本实施方式的效果。
首先,说明如上所述那样配置的存储器单元10作为变阻型的存储元件的效果。
在根据本实施方式的装置1中,氧传导层13的相对介电常数比电阻变化层12的相对介电常数高。因此,当在下部电极11和上部电极14之间施加电压时,施加到电阻变化层12的电场的强度比施加到氧传导层13的电场的强度高。由此,即使在选择了具有如氧化硅层那样的高电介质击穿电压并且具有高的绝缘性的层作为电阻变化层12的情况下,当在下部电极11和上部电极14之间电压从零连续地增加时,电阻变化层12也先于氧传导层13经历电介质击穿。结果,使得能够进行“成形”和“置位”。
另一方面,在根据本实施方式的变阻型存储装置1中,电阻变化层12由氧化硅构成,下部电极11包含硅,氧传导层13具有传导氧离子的能力。因此,在施加使下部电极11成为正极并使上部电极14成为负极的负电压时,氧传导层13可以对电阻变化层12供给氧,并且下部电极11中所包含的硅可以与经由氧传导层13和电阻变化层12供给的氧结合而形成氧化硅。由此,使缺氧部16消失,并且可以在电阻变化层12中生成氧化硅19;并且,能够修复电阻变化层12中的电介质击穿。结果,能够使电阻变化层12可以从“低电阻状态”转变为“高电阻状态”。即,使得能够实现“复位”。
由此,能够将存储器单元10用作变阻型的存储元件。
接着,说明使通/断比增加的效果。
如上所述,在本实施方式中,由于氧传导层13的相对介电常数比电阻变化层12的相对介电常数高,因此即使在将绝缘性良好的绝缘层用作电阻变化层12时,也能够可靠地执行“置位”操作。通过将高绝缘性的层用作电阻变化层12,能够提高电阻变化层12的初始状态下的电阻值。
在本实施方式中,通过由包含硅的下部电极11和具有氧离子传导性的氧传导层13夹持电阻变化层12,在复位时,能够有效地消除电阻变化层12中形成的电流路径17。由此,可以消除电流路径17的整体或大部分,并能够使电阻变化层12的电阻值回到初始状态的值或与其接近的值。
结果,能够提高电阻变化层12处于高电阻状态时的电阻值,并可以提高通/断比。
可以从其它角度将该效果表述如下。即,在常规的变阻型存储装置中,由含有大量的缺氧部的特殊的金属氧化物形成电阻变化层,对该电阻变化层进行成形来形成细丝;并通过控制细丝的端部和电极之间的导通状态来在低电阻状态和高电阻状态之间切换。因此,在高电阻状态下,电阻由细丝的端部和电极之间的小的间隙决定,因此通/断比低。
与此相对地,在本实施方式中,通过提供包含硅的下部电极11和具有氧离子传导性的氧传导层13,能够几乎完全修复氧化硅层的电介质击穿。因此,对于电阻变化层12整体,重复电介质击穿和修复,来在低电阻状态和高电阻状态之间切换。因此,通/断比高。
在本实施方式中,通过提供下部电极11和氧传导层13,可以使用氧化硅层作为电阻变化层12,而传统上尽管氧化沟层具有优良的绝缘性但不被用作电阻变化层。因此,根据本实施方式的变阻型存储装置其操作原理与常规的变阻型存储装置完全不同,并由此,能够实现优良的特性。
图3A和3B是示意性地说明上述效果的图,横轴取状态,纵轴取在施加恒定的读取电压时流过的电流的幅度。图3A示出常规的装置,而图3B示出本实施方式的装置。
图3A和3B所示的灰色的长方形是示出流过的电流的幅度的棒条图。另外,圆示出在电阻变化层中形成的缺氧部,并且沿着图的垂直方向的位置对应于电阻变化层的厚度方向上的位置。这些表明:在高电阻状态下残留在电阻变化层中的电流路径越长,则流过的电流越大,并且通/断比越低。图3A和3B的图示说明既不是严格的,也不是定量的。
如图3A所示,在图14A~14C和图15所示的常规的变阻型存储装置中,虽然在装置的制造制造过程中通过成形来形成细丝116(电流路径),但是在后续的复位和置位中,只有细丝116的一端部被破坏和修复。因此,和成形时的电阻值的变化量相比,复位和置位时的电阻值的变化量显著小。因此,通/断比小。
与此相对地,如图3B所示,在图1A~1C和图2所示的根据本实施方式的变阻型存储装置1中,由于下部电极11和氧传导层13的存在,在复位时,电介质击穿几乎被完全修复,电流路径17的整体或大部分被消除。也即,在复位和置位中,电流路径17的整体或大部分重复消失和再形成。因此,复位和置位时的电阻值的变化量与成形时的电阻值的变化量几乎相等,并且通/断比大。
接着,说明能够省略成形的效果。
如上所述,如果在复位时能够使电流路径17的整体消失,则高电阻状态与初始状态类似,并且成形电压与置位电压相等。因此,无需特别实施成形。结果,能够实现不需要成形的“无成形”变阻型存储装置。如下面所述的,为了使电流路径17的整体消失,较薄的电阻变化层12较有利,而较高的氧传导层13的氧离子传导性较有利。
接着,说明使装置的操作速度提高的效果。
在本实施方式的装置1中,在电阻变化层12上提供氧传导层13,在复位时,可以通过施加电压来从氧传导层13对电阻变化层12供给氧离子,迅速修复电阻变化层12的电介质击穿。因此,复位的速度高。在置位时,能够将电阻变化层12中的氧迅速排出到氧传导层13。因此,置位的速度也高。
在以上的说明中,使用形成存储器单元10的各部件的材料的示例来说明了其操作和效果。下面,将说明存储器单元10的每一部件所要求的材料的一般特性。即使每一部件的材料在以下所示的范围中变更时,装置1的操作和效果也和上述中的类同。
首先,说明电阻变化层12的材料。
电阻变化层12是这样的材料,其在高电阻状态下为绝缘的,且在复位时其电介质击穿被通过供给氧而修复;因此,优选为某种氧化物。为了在高电阻状态时实现足够高的电阻值以及防止因噪声等引起的电介质击穿,优选为绝缘特性优良并且电介质击穿电压高的材料。具体地说,形成电阻变化层12的材料优选具有10MV/cm或更高的电介质击穿电场。作为这种材料,共价键合的氧化物是优选的,并且被氧化的元素的电负性和氧的电负性之间的差的绝对值优选为例如1.7或更低。
为了在对下部电极11和上部电极14之间施加电压时在电阻变化层12中产生强的电场来可靠地产生电介质击穿,电阻变化层12的材料的相对介电常数优选为低。尤其是,相对介电常数优选为10或更小。作为满足上述条件的材料的具体示例包括氧化硅、锗的氧化物和铝的氧化物,特别优选二氧化硅(SiO2)。电阻变化层12的厚度优选为例如1~5nm。
接着,说明氧传导层13的材料。
氧传导层13的材料是这样的材料,其自身包含氧离子并具有高的氧离子传导性。氧离子的传导性越高,则能够越快速地修复较厚的电阻变化层12的电介质击穿。尤其是,优选氧离子的传导性为10-10S/cm或更高。为了使低电阻状态时存储器单元整体的电阻值降低,氧传导层13的材料优选为带隙小的材料。尤其是,优选带隙为6eV或更小的材料。为了当在下部电极11和上部电极14之间施加电压时在电阻变化层12中产生强的电场,优选氧传导层13中产生的电场弱。因此,优选的是,氧传导层13的材料的相对介电常数高,尤其是,相对介电常数优选为10或更高。氧传导层13的厚度优选为例如1至20nm。
作为这样的材料,离子性地结合的氧化物是优选的,并且其中被氧化的元素的电负性和氧的电负性之间的差的绝对值为1.7或更高的氧化物是优选的。氧传导层13的材料优选为具有荧石(fluorite)型晶体结构的材料。作为满足上述条件的材料的具体示例,对于具有荧石型晶体结构的材料,可以给出从由氧化铈(CeOx)和氧化钇稳定的氧化锆(YSZ;(Y2O3)1-x(ZrO2)x)构成的群组中选择的一个或多个氧化物。作为具有其它晶体结构的材料,给出从由氧化铪(HfOx)、氧化锆(ZrOx)、氧化钛(TiOx)和钛酸锶(STO)构成的群组中选择的一种或多种氧化物。二氧化铈(CeO2)和二氧化铪(HfO2)是特别优选的。二氧化铈频繁地在3价态和4价态之间切换,并提供高的氧离子传导性。
图4是示出了多晶二氧化铈(poly-CeO2)和多晶氧化钇稳定的氧化锆(poly-YSZ)的氧离子传导性的曲线图,横轴表示温度、纵轴表示氧离子的传导性。
如图4所示,在约500℃以上的温度范围中,多晶YSZ的氧离子传导性比多晶二氧化铈的氧离子传导性高,而在约500℃以下的温度范围中,多晶二氧化铈的氧离子传导性更高。特别是在室温(27℃)附近,存在104~108倍左右的差别。由于存储装置在室温附近操作,因此,就氧离子传导性而言,和YSZ相比,二氧化铈优选作为氧传导层13的材料。
可以在二氧化铈(CeO2)中添加少量的镧系元素,诸如镧(La)或钆(Gd)。由此,这些添加元素在二氧化铈的晶粒边界产生偏析(segregate),使氧离子的传导性改善。
接着,说明电阻变化层12的材料和氧传导层13的材料之间的关系。
为了使得能够进行成形和置位,需使得,在使下部电极11和上部电极14之间的电压从零连续地增加时,电阻变化层12在氧传导层13之前经历电介质击穿。为此,优选的是,电阻变化层12中产生的电场比氧传导层13中产生的电场强,因而优选的是,电阻变化层12的相对介电常数比氧传导层13的相对介电常数低。如上所述,由于电阻变化层12优选具有高的绝缘性和低的相对介电常数,因此电阻变化层12优选由共价键合的氧化物构成。另一方面,由于氧传导层13优选具有比电阻变化层12高的导电性高和高的相对介电常数,因此氧传导层13优选由离子性地结合的氧化物构成。因此,优选地,电阻变化层12中所包含的被氧化的元素(例如,硅)的电负性和氧的电负性之间的差的绝对值小于氧传导层13中所包含的被氧化的元素(例如,铈)的电负性和氧的电负性之间的差的绝对值。
优选地,电阻变化层12的厚度是能够通过氧传导层13将氧离子供给至下部电极11和电阻变化层12之间的界面的厚度。由此,可以不仅从氧传导层13侧,还从下部电极11侧,通过氧化硅的生成来修复电介质击穿,并且能够在电阻变化层12的整个厚度方向上修复电介质击穿。结果,能够使高电阻状态下的电阻值返回至与初始状态相当的值,并使得能够进一步提高通/断比。换言之,置位的效果变得和成形的效果等同,而成形变得不是必须的。氧离子能够扩散的电阻变化层12的厚度与氧传导层13的氧离子传导率的平方根成比例。也即,在氧传导层13的氧离子传导率以σ表示,在处于热平衡下氧离子能够渗透的电阻变化层12的厚度以t表示时,下面的数学式1成立。
[式1]
在将根据各材料的参数代入上述数学式1来创立等式时,如果包含t的左边小于包含σ的右边,则在电阻变化层12的整个厚度方向上供给氧离子,并且成形不是必需的。
图5是示出不需要成形的电阻变化层的厚度和氧传导层的氧离子传导性的关系的曲线图,横轴取电阻变化层的厚度,纵轴取氧传导层的氧离子的传导率。
图5中的曲线Z对应于上述数学式1。图5示出了由多晶二氧化铈形成氧传导层13的情况和由多晶YSZ形成了氧传导层13的情况。
如图5所示,在所示出的表示电阻变化层12的所述厚度和氧传导层13的氧离子传导性的关系的点处于区域R1时,在复位时由氧传导层13供给的氧离子到达电阻变化层12和下部电极11之间的界面,因此高电阻状态下的电阻变化层12的电阻值返回至初始状态的值。在该情况下,不需要成形。
另一方面,在所示的点处于区域R2中的情况下,在复位时,氧离子不会到达电阻变化层12和下部电极11之间的界面,因此高电阻状态下的电阻变化层12的电阻值不会回到初始状态的值,并且比其低。相反地,为了使电阻变化层12从初始状态转变为低电阻状态,仅置位操作是不够的,需要专用的成形操作。
如图5所示,为了省略成形操作,需要使电阻变化层12的厚度不超过由氧传导层13的氧离子传导性决定的规定的厚度。即,氧传导层13的氧离子传导性越高,就可以使电阻变化层12越厚,并实现无需成形。电阻变化层12越厚,则可以使通/断比越高。因而,为了实现无需成形并提高通/断比,优选地,由氧离子传导性高的材料形成氧传导层13,并且高精度地控制电阻变化层12的厚度。
接着,说明下部电极11的材料。
下部电极11需要具有作为电极所需的导电性,并且下部电极11包含与电阻变化层12中所包含的元素中的被氧化的元素相同的元素。对于下部电极11,优选地,通过局部阳极氧化来形成与电阻变化层12的材料相同种类的材料。
在电阻变化层12由氧化硅构成的情况下,作为下部电极11的材料,给出掺杂杂质的并具有p型或n型导电性的硅,或金属硅化物。作为金属硅化物,作为示例,给出镍硅化物。有多种镍硅化物,其中,具有最高百分比的硅含量的二硅化镍(NiSi2)是特别优选的。
接着,说明上部电极14的材料。
上部电极14由导电性材料形成以具有作为电极所需的导电性。优选地,其由不与氧传导层13反应的材料形成。这是因为,如果上部电极14与氧传导层13反应,则在界面将形成金属间化合物层,而电阻值将增加,并且将难以进行氧传导层13的组成和厚度的控制。为了防止上部电极14与氧传导层13反应,Gibbs自由能优选高于氧传导层中所含的金属的自由能,例如高于-700kJ。满足这样的条件的上部电极14的材料的具体示例包括钨(W)和铂(Pt)。在上部电极14的主体部分由钨层形成的情况下,为了抑制氧进入该钨层中,可以在钨层上形成由氮化钛(TiN)等构成的阻挡层。
接着,说明根据本实施方式的变阻型存储装置1的操作所需的置位电压。
施加在下部电极11和上部电极14之间的电压Vapp根据各层的电场和厚度之积而在电阻变化层12和氧传导层13之间分配。即,在将电阻变化层12的厚度以tVR表示,将其电场强度以EVR表示,将氧传导层13的厚度以tOC表示,将其电场强度以EOC表示时,下述数学式2成立。
[式2]
Vapp=EVR×tVR+EOC×tOC
在将电阻变化层12的电介质击穿所需的电场强度表示为EVRBD,将其所需的置位电压表示为Vset,将电阻变化层12的相对介电常数表示为kVR,并将氧传导层13的相对介电常数表示为kOC时,由于电场强度和相对介电常数之积固定,因此置位电压Vset由下述数学式3给出。成形电压与上述的类同。图1所示的电源电路15需要能够输出不小于由下述数学式3表示的置位电压Vset的电压Vapp。
[式3]
在电阻变化层12由二氧化硅(SiO2)形成并且氧传导层13由二氧化铈(CeO2)形成的情况下,考虑到SiO2的相对介电常数kSiO2为约4,CeO2的相对介电常数kCeO2为约28,因此,在将SiO2的绝缘电场强度表示为ESiO2BD时,上述数学式3能够表述为如下述的数学式4。
[式4]
基于上述数学式4,针对氧传导层13的材料为CeO2(k=28)或HfO2(k=16)的情况,计算出氧传导层13的厚度tOC和电阻变化层12的厚度tSiO2所需的置位电压Vset。此时,将SiO2的绝缘电场强度ESiO2BD设为14MV/cm。图6中示出计算结果。
图6是示出了不同因素对所需的置位电压的影响的图,横轴取氧传导层的厚度,纵轴取置位电压。
如图6所示,电阻变化层12的厚度tSiO2越薄,则置位电压Vset越低。氧传导层13的厚度tOC越薄,则置位电压Vset越低。使用相对介电常数较高的CeO2作为氧传导层13的材料的情况,比使用相对介电常数相对低的HfO2的情况,更有利于置位电压Vset的降低。然而,优选地,电阻变化层12厚至足以在高电阻状态时可靠地提供规定的电阻值的程度。另外,优选地,氧传导层13厚至足以对电阻变化层12供给充分的氧离子的程度。
其中将SiO2用作电阻变化层12的材料、将CeO2用作氧传导层13的材料的变阻型存储装置,在将读取电压设置为-0.1V的情况下,能够实现超过1×104的高的通/断比(高电阻状态的电阻值相对于低电阻状态的电阻值之比的值)。例如,作为通/断比,能够实现1×105至1×108的值。即使对存储器单元10执行温度范围不低于常温且不大于700℃的热处理(例如,温度为400-700℃的热处理),也仍原样地维持该高的通/断比。因而,在变阻型存储装置的制造工序中,可以执行在700℃或以下(例如,400-700℃)的高温环境中进行的工艺。也就是说,将SiO2用作电阻变化层12的材料并将CeO2用作氧传导层13的材料的变阻型存储装置不仅能够提供优良的通/断比,还能够采用高温的热处理作为制造工艺,制造工艺的灵活度高。
接着,说明示例和比较例。
在以下说明的各示例和比较例中,通过EB气相沉积法实际制作试样,并测定其I-V特性。将各试样的平面尺寸设置为一边为20μm的方形。在第一示例和第一比较例中,通过TEM(透射电子显微镜法)观察试样的剖面,并拍摄了照片。
(第一示例和第一比较例)
图7A是示出第一示例的试样的剖面图,而图7B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
图8A是示出第一比较例的试样的剖面图,而图8B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
图9A是示出第一示例的试样的剖面的TEM照片,而图9B是示出第一比较例的试样的剖面的TEM照片。
如图7A所示,在第一示例中,通过EB气相沉积法按顺序沉积二硅化镍(NiSi2)、氧化铈(CeO2)和钨(W)。将沉积的氧化铈的量设置为20nm。
由此,如图9A所示,由二硅化镍构成的层、由氧化铈构成的层以及由钨构成的层按该顺序被层叠。在二硅化镍层和氧化铈层之间形成厚度为大约2nm的均匀的氧化硅层(SiO2)。另一方面,在氧化铈层和钨层之间未形成反应层。
将该试样连接到电源电路,在电流限制值(c.c.)处于2mA的情况下,测量I-V特性。结果,如图7B所示,发现低电阻状态和高电阻状态,并呈现了明显的滞回。利用处于-0.1V的读取电压来测量通/断比,获得超过1×104的值的极高的通/断比。即使在对根据第一实施例的试样在常温至700℃的温度范围中执行热处理时,也能够维持1×104至1×108的高的通/断比。
在首次电压上升期间(即,对处于初始状态的试样首次使电压从零连续地增加时)的行为表现与置位期间(即,在第二次以及后续次使电压从零连续地增加时)的行为表现几乎一致。在图7B中,所示出的指示首次电压上升的点与所示出的指示置位的点重叠。如此,在第一示例中,高电阻状态的电阻值返回至初始状态的电阻值,并置位的行为表现和首次电压上升的行为特性变得相同。由此,在第一示例中实现了无需成形。
另一方面,如图8A所示,在第一比较例中,由氮化钛(TiN)形成下部电极11。在其上按顺序沉积氧化铈(CeO2)和钨(W)。沉积的氧化铈的量设置为20nm。
由此,如图9B所示,在由氮化钛构成的层上,按顺序沉积由氧化铈构成的层以及由钨构成的层。氧化钛层(TiO2)形成在氮化钛层和氧化铈层之间。形成电阻变化层12的氧化钛(TiO2)的相对介电常数(约40)比形成氧传导层13的氧化铈(CeO2)的相对介电常数(约28)高。
如图8B所示,对于第一比较例的I-V特性,通/断比为约1×102,比第一示例的低。另外,置位呈现和成形不同的行为特性,并且没有实现无需成形。推测这是因为电阻变化层12的相对介电常数比氧传导层13的相对介电常数高,并且电场没有充分地集中在电阻变化层12中。
(第二示例和第二比较例)
图10A是示出第二示例的试样的剖面图,而图10B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
图11A是示出第二比较例的试样的剖面图,而图11B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
如图10A所示,在第二示例中,制备p+型导电型的硅基板作为下部电极11,并执行温度为800℃的热氧化处理;从而,在硅基板的上表面上形成厚度为4nm的氧化硅层(SiO2)。接着,通过EB气相沉积法,沉积20nm的沉积量的氧化铈(CeO2),之后,沉积钨(W)。
如图10B所示,在第二示例中,通/断比也表现出超过1×104的高的值。认为这是因为,在复位时,由p+型硅构成的下部电极11经受局部阳极氧化,并有效修复电阻变化层12的电介质击穿。由此表明:在由硅形成下部电极11时,也能够获得特性良好的存储器单元。与第一示例类似,推测认为,即使在根据第二示例的试样经历从常温至700℃的范围中的热处理时,也能够维持高的通/断比。
在第二示例中,置位的行为特性和成形的行为特性并不完全一致,没有实现无需成形。这被认是因为,在复位时,由于形成电阻变化层12的SiO2层的4nm的大的厚度,因此电介质击穿未被完全修复。推测认为,如果将SiO2层的厚度设置得更小,那么将能够实现无需成形。
另一方面,如图11A所示,在第二比较例中,使用与第二示例类似的方法,在p+型的导电类型的硅基板的上表面上形成了厚度为4nm的氧化硅层(SiO2)。接着,形成钨层,而不形成氧化铈层(CeO2)。即,在第二比较例中,不提供氧供给层13。
如图11B所示,在第二比较例中,电阻状态只呈现一个状态,并且未获得作为存储器单元的操作。
(第三实施例)
图12A是示出第三示例的试样的剖面图,而图12B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
如图12A所示,第三示例与上述的第一示例的不同之处在于,由氧化铪(HfO2)形成氧传导层13。氧化铪层的厚度被设置为2nm。在其它方面,第三示例的配置和第一示例类同。即,在第三示例中,由二硅化镍(NiSi2)形成下部电极11,由钨(W)形成上部电极14。在二硅化镍层(下部电极11)和氧化铪层(氧传导层13)之间形成氧化硅层(SiO2)。
如图12B所示,在第三示例中,也发现了与第一示例类似的I-V特性。在将读取电位设置为-0.1V时,第三示例的通/断比为3×107。因此,在由氧化铪(HfO2)形成氧传导层13时,也能够实现高的通/断比。另外,首次电压上升和置位操作的行为特性几乎一致,并能够实现无需成形。
(第四示例)
图13A是示出第四示例的试样的剖面图,而图13B是示出该试样的I-V特性的曲线图,横轴取电压,纵轴取电流。
如图13A所示,第四示例与上述的第一示例的不同之处在于,由导电类型为p+型的硅形成下部电极11,以及由氧化铪(HfO2)形成氧传导层13。氧化铪层的厚度被设置为2nm。除此以外,配置和第一示例类同。在p+型的硅层(下部电极11)和氧化铪层(氧传导层13)之间形成氧化硅层(SiO2)。
如图13B所示,在第四示例中,也发现与第一示例类似的I-V特性。在将读取电位设置为-0.1V时,第四示例的通/断比为2×105。如此,通过由p+型硅构成的下部电极11和由氧化铪(HfO2)构成的氧传导层13的组合也能够实现高的通/断比。在第四示例中,首次升压和置位操作的行为特性不一致,并没有实现无需成形。这被认为是因为,形成电阻变化层12的SiO2层的厚度大。
上述的实施方式示出了其中使用与下部电极11的材料不同的材料作为上部电极14的材料的例子。然而,本发明不限于此,上部电极14的材料也可以和下部电极11的材料相同。也即,上部电极14的材料可以是包含电阻变化层12中所包含的被氧化的元素的导电材料,例如包含硅的材料。由此,在上部电极14和氧传导层13之间也形成由例如氧化硅构成的电阻变化层12,并能够实现存储器单元的多值操作。也即,通过在氧传导层13的上侧和下侧上形成两个电阻变化层,能够获得四种状态:(1)其中两个电阻变化层12都处于低电阻状态的状态;(2)其中只有下侧的电阻变化层12处于低电阻状态的状态;(3)其中只有上侧的电阻变化层12处于低电阻状态的状态;以及,(4)其中两个电阻变化层12都处于高电阻状态的状态。因此,例如,在一个存储器单元能够存储两位信息。
前述实施方式中说明的存储器单元可以嵌入到交叉点(cross-point)型存储装置中。例如,在如下的结构中,前述的存储器单元10可以连接在各位线和各字线之间,在所述结构中,在其上表面形成了包括电源电路15的驱动电路的硅基板上,沿Z方向交替地层叠包含在X方向延伸的多条字线的字线互连层和包含在Y方向延伸的多条位线的位线互连层。由此,能够三维地集成存储器单元,并且能够增加记录密度。此时,可以将前述的下部电极11和上部电极12分别用作字线和位线,或者,也可以在下部电极11和上部电极12以外,提供字线和位线。例如,可以对每个存储器单元10连接一个二极管。
以上说明的实施方式能够提供具有高通/断比的变阻型存储装置。
虽然上面说明了本发明的某些实施方式,但是这些实施方式是仅作为例子呈现的,并不意图限定发明的范围。实际上,这里说明的新颖的实施方式能够以多种其它方式来实施;此外,可以进行这里描述的实施方式的形式上的多种多样的省略、置换、变更,而不脱离发明的精神。所附权利要求及其等同意图覆盖落在本发明的范围和精神内的这些形式或修改。
产业应用性
本发明可以提供具有高通/断比的变阻型存储装置。
附图标记说明
1:变阻型存储装置;10:存储器单元;11:下部电极;12:电阻变化层;13:氧传导层、14:上部电极;15:电源电路;16:缺氧部;17:电流路径、18:氧离子;19:氧化硅;101:变阻型存储装置;111:下部电极;112:电阻变化层;113:上部电极;114:缺氧部;115:电源电路;116:细丝;M1、M2、M3:操作;S0、S1、S2、S3:状态;R1、R2:区域;Z:曲线。
变阻型存储装置专利购买费用说明
![]()
Q:办理专利转让的流程及所需资料
A:专利权人变更需要办理著录项目变更手续,有代理机构的,变更手续应当由代理机构办理。
1:专利变更应当使用专利局统一制作的“著录项目变更申报书”提出。
2:按规定缴纳著录项目变更手续费。
3:同时提交相关证明文件原件。
4:专利权转移的,变更后的专利权人委托新专利代理机构的,应当提交变更后的全体专利申请人签字或者盖章的委托书。
Q:专利著录项目变更费用如何缴交
A:(1)直接到国家知识产权局受理大厅收费窗口缴纳,(2)通过代办处缴纳,(3)通过邮局或者银行汇款,更多缴纳方式
Q:专利转让变更,多久能出结果
A:著录项目变更请求书递交后,一般1-2个月左右就会收到通知,国家知识产权局会下达《转让手续合格通知书》。
动态评分
0.0