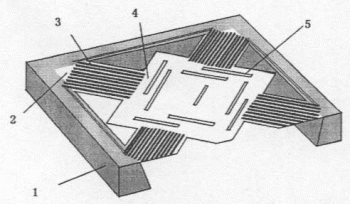
专利摘要
本发明涉及一种与互补金属氧化物半导体(ComplementaryMetal-OxideSemiconductor,CMOS)兼容的微机械热电堆红外探测器结构及其制作方法,其特征为利用(100)单晶硅各向异性腐蚀特性采用正面特定的开口通过正面腐蚀实现大吸收面积微机械热电堆结构,所制作的红外探测器特征在于框架与中间悬浮的红外吸收区构成热电堆的冷结区和热结区;支撑臂连接框架和红外吸收区以及承载热电堆;长条形开口覆盖整个红外吸收区。本发明提供的结构和工艺具有腐蚀时间短、器件占空比大,器件成品率高等特点,特别适合大阵列红外探测器的制作。
权利要求
1.一种与CMOS工艺兼容的微机械热电堆红外探测器,其特征在于框架(1)与中间悬浮的红外吸收区(4)构成热电堆(2)的冷结区和热结区;支撑臂(3)连接框架(1)和红外吸收区(4)以及承载热电堆(2);长条形开口(5)覆盖整个红外吸收区(4)。
2.按权利要求1所述的与CMOS工艺兼容的微机械热电堆红外探测器,其特征在于所述的支撑臂(3)为双边对拉或四边对拉结构。
3.按权利要求2所述的与CMOS工艺兼容的微机械热电堆红外探测器,其特征在于支撑臂(3)为四支撑臂结构、双支撑臂结构或四边对拉宽支撑臂结构。
4.按权利要求1所述的与CMOS工艺兼容的微机械热电堆红外探测器,其特征在于长条形开口(5)是在红外吸收区(4)上刻蚀的腐蚀窗口,沿<100>晶向的正方形底面棱台形坑。
5.按权利要求1或4所述的与CMOS工艺兼容的微机械热电堆红外探测器,其特征在于长条形开口腐蚀得到正方形单元。
6.按权利要求1所述的与CMOS工艺兼容的微机械热电堆红外探测器,其特征在于所述的支撑臂(3)和红外吸收区(4)是由在硅片上淀积的氧化硅和氮化硅复合膜构成的。
7.制作如权利要求1所述的与CMOS工艺兼容的微机械热电堆红外探测器的方法,其特征在于工艺步骤是:
(a)取<100>晶向双抛硅片进行氧化后,以低压化学气相沉积的方法双面沉积氮化硅/多晶硅层,然后再生长氧化硅层;
(b)光刻并刻蚀窗口,使用离子注入的方法或扩散的方法对多晶硅进行p型或p/n型掺杂并作高温退火激活;
(c)光刻并刻蚀出多晶硅电阻条,作为热电堆电偶材料;
(d)在多晶硅电阻条表面生长氧化硅层;
(e)在氧化层上光刻引线孔图形,用氢氟酸腐蚀氧化硅形成引线孔,在正面沉积金属层,并光刻出金属线条,金属条和掺杂的多晶硅条通过引线孔实现欧姆接触,形成p/n型多晶硅或多晶硅、金属热偶对,成为热电堆的主要结构;
(f)在正面的复合膜上光刻出腐蚀窗口,去除窗口内的氮化硅、氧化硅,使用各向异性腐蚀液进行腐蚀,使红外吸收层和支撑臂完全释放,即得到了红外热堆探测器。
8.按权利要求7所述的与CMOS工艺兼容的微机械热电堆红外探测器的制作方法,其特征在于所述的各向异性腐蚀液为四甲基氢氧化铵或氢氧化钾。
说明书
技术领域技术领域
本发明涉及一种与互补金属氧化物半导体(CMOS)兼容的微机械热电堆红外探测器结构及其制作方法,特别适用于大阵列红外探测器的制造。本发明属于红外探测器领域。
技术背景背景技术
近年来,红外探测器在公共安全、医学诊断、环境监测、安全系统、天文研究、辅助驾驶以及芯片的实时热检测等方面的应用日益受人关注。随着应用的日益普及,对红外探测系统的微型、灵敏、精巧、隐秘与高可靠也要求日益强烈。与传统的光量子型探测器件相比,非制冷型红外技术采用目前日臻成熟的MEMS技术,利用光-热-电转化探测红外光,由于不需要制冷机和扫描机构,降低了整机的重量、复杂性、功耗、成本,是红外技术低成本、小型化的主流发展方向。
热电型红外探测器是通过把入射光转化成热,然后再进行测量。热电堆红外探测器及其阵列是最早研究并实用化的热电型红外成像器件之一,它通过测量金属或半导体由于塞贝克效应产生的热电势来探测红外辐射的。过去,热电堆红外探测器都是使用真空镀膜的方法制造,这样制造出的器件尺寸比较大,而且不能批量生产。随着大规模集成电路的发展,尤其是MEMS技术的发展,红外热电堆的制造技术迅速更新。目前,微机械红外热电堆一般采用背腐蚀法,如J Schieferdecker等在《Infrared thermopile sensors withhigh sensitivity and very low temperature coefficient》一文中采用的方法,腐蚀时间长,需要正反两面对准曝光,与CMOS工艺兼容性差,增加了工艺难度,制造成本也较高。近期一些微机械红外热电堆也采用了表面加工的方法,如徐峥谊等在《正面腐蚀方法制作新型微机械红外热电堆探测器》中采用正面加工得到了热电堆红外探测器,但是由于工艺方法的限制,其不能得到大的红外吸收面积,占空比较小,不利于器件性能的提高、阵列化。
发明内容发明内容
本发明的目的在于提供一种与CMOS兼容的正面腐蚀微机械红外热电堆结构及其制作方法。
本发明之微机械热电堆红外探测器是在<100>晶向硅片上制作的,结构如附图1所示,包括框架1,热电堆2,支撑臂3,红外吸收区4,长条形开口5等五部分。其中,框架1与中间悬浮的红外吸收区4构成热电堆2的冷结区和热结区,支撑臂起到连接框架1和红外吸收区4以及承载热电堆2的目的。支撑臂3和红外吸收区是由在硅片上淀积的氧化硅和氮化硅复合膜构成。支撑臂3可以是双边对拉或四边对拉结构,如附图2所示的(a)四支撑臂结构、(b)双支撑臂结构以及(c)四边对拉宽支撑臂结构。热电堆2可以采用与CMOS工艺兼容的P型多晶硅、N型多晶硅、Al、Au等材料中的任意两种组合制作。长条形开口5是在红外吸收区4上刻蚀的腐蚀窗口,其沿<100>方向,是利用(100)面单晶硅各向异性腐蚀的特性来设计的。腐蚀后将形成以开口为对角线,沿<110>晶向的正方形底面棱台形坑,如图3所示。长方形开口5可以通过设计适当的分布覆盖。长方形开口5的分布设计如附图4所示,是以各开口俯视得到的正方形为单元,选择合适大小的正方形,考虑支撑臂3的宽度和红外吸收区4的大小及应力,覆盖整个红外吸收区4,这样支撑臂释放的同时,可以达成整个器件的快速释放成形。
本发明采用的制作方法如图5所示,具体如下:
1.取<100>晶向双抛硅片进行氧化后,以低压化学气相沉积(LPCVD)的方法双面沉积氮化硅/多晶硅层,然后再生长氧化硅层。
2.光刻并刻蚀窗口,使用离子注入的方法或扩散的方法对多晶硅进行p型或p/n型掺杂并作高温退火激活。
3.光刻并刻蚀出多晶硅电阻条,作为热电堆电偶材料。
4.在多晶硅电阻条表面生长氧化硅层。
5.在氧化层上光刻引线孔图形,用氢氟酸腐蚀氧化硅形成引线孔,在正面沉积金属层,并光刻出金属线条,金属条和掺杂的多晶硅条通过引线孔实现欧姆接触,形成p/n型多晶硅或多晶硅、金属热偶对,成为热电堆的主要结构。
6.在正面的复合膜上光刻出腐蚀窗口,去除窗口内的氮化硅、氧化硅,使用各向异性腐蚀液,如四甲基氢氧化铵(TMAH)或氢氧化钾(KOH)进行腐蚀,到红外吸收层和支撑臂完全释放,即得到了红外热堆探测器。
本发明的优点如下:
1.采用本发明的正面腐蚀释放热电堆结构的方法,可以短时间内迅速释放大面积器件结构,提高成品率,降低生产成本;
2.制作工艺与现有CMOS工艺兼容。由于器件中所需要的薄膜材料都是在常规IC工艺材料范围内,而且采用了不同于以往的体硅正面腐蚀释放结构层工艺,器件整体工艺与CMOS兼容,成本更低;
3.悬浮膜的设计使得红外吸收区面积占空比大,有利于器件性能提高。
综上所述,本发明提出的热电堆红外探测器采用特定的正面开口结构进行湿法腐蚀释放热电堆结构,其有效红外吸收面积可占约50%的单元像素面积、具有占空比大、腐蚀时间短、成品率高、成本低、与CMOS兼容性好、适合阵列化等特点。
附图说明附图说明
图1为本发明之CMOS兼容正面腐蚀的微机械多晶硅热电堆红外探测器结构立体示意图。
图2为本发明之CMOS兼容正面腐蚀的微机械多晶硅热电堆红外探测器结构三种设计示意图。(a)为四支撑臂结构,(b)为二支撑臂结构,(c)为宽支撑臂结构。
图3为沿<100>方向的长条形开口设计(a)及其腐蚀结果示意图(b)。
图4为本发明之长条形开口设计示意说明图。
图5为本发明之CMOS兼容正面腐蚀的微机械多晶硅热电堆红外探测器结构制作过程。(a)薄膜生长,(b)图形化掺杂,(c)热电堆成形,(d)钝化层制作,(e)互连线,(f)结构释放。
图6为具体实施例1制作的器件扫描电镜照片。
图中1为框架,2为热电堆,3为支撑臂,4为红外吸收区,5为长条形开口
具体实施方式实施例1:
本实施例结构参见图1。其制作工艺如下:
1.在(100)单晶硅上LPCVD沉积一层SiO2/Si3N4双层介质膜结构,总膜厚约为5000。然后在其上生长一层厚约4000的多晶硅,接着生长约1000氧化硅,如图5-(a)所示。
2.经过光刻、BOE(Buffered Oxide Etch,缓冲氧化层腐蚀剂)等工艺在表面形成氧化硅窗口图形后,利用光刻胶作为离子注入掩蔽层,P、B等离子注入多晶硅,形成多晶硅电阻条,作为热电堆电偶材料,如图5-(b)所示。
3.光刻坚膜之后,BOE湿法腐蚀其余多晶硅表面的氧化硅,离子干法刻蚀电阻条图形外的多晶硅,等离子去胶,1000℃高温退火激活离子形成热电堆图形,如图5-(c)所示。
4.在多晶硅电阻条表面PECVD生长2000左右的氧化硅,作为最后硅各向异性腐蚀工艺的多晶硅钝化保护层,如图5-(d)所示。
5.经过光刻、BOE等工艺后露出多晶硅电阻条引线接触孔。溅射2000铝或钛金等金属作为电阻之间的引线,采用带胶剥离工艺图形化金属引线,如图5-(e)所示。
6.离子干法刻蚀SiO2/Si3N4双层介质膜形成腐蚀窗口,采用浓度为25%的TMAH各向异性腐蚀溶液释放悬空薄膜绝热结构,80℃水浴3小时即可完成结构释放,然后进行酒精脱水干燥得到器件,如图5-(f)所示。
经过以上步骤流片后所得器件照片见图6。
实施例2:
本实施例结构俯视图参见图2-(b),其余同实施例1。
实施例3:
本实施例结构俯视图参见图2-(c),其余同实施例1。
与互补金属氧化物半导体工艺兼容的微机械热电堆红外探测器及制作方法专利购买费用说明
![]()
Q:办理专利转让的流程及所需资料
A:专利权人变更需要办理著录项目变更手续,有代理机构的,变更手续应当由代理机构办理。
1:专利变更应当使用专利局统一制作的“著录项目变更申报书”提出。
2:按规定缴纳著录项目变更手续费。
3:同时提交相关证明文件原件。
4:专利权转移的,变更后的专利权人委托新专利代理机构的,应当提交变更后的全体专利申请人签字或者盖章的委托书。
Q:专利著录项目变更费用如何缴交
A:(1)直接到国家知识产权局受理大厅收费窗口缴纳,(2)通过代办处缴纳,(3)通过邮局或者银行汇款,更多缴纳方式
Q:专利转让变更,多久能出结果
A:著录项目变更请求书递交后,一般1-2个月左右就会收到通知,国家知识产权局会下达《转让手续合格通知书》。
动态评分
0.0