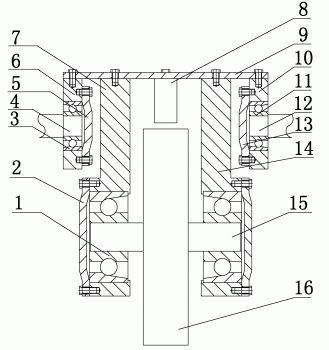
专利摘要
本发明公开了一种可自适应调节抛光间隙的磁流变抛光轮组件,包括固定板以及安装于固定板下方的抛光轮,固定板的下方设有配重块,所述固定板与一摆动机构相连并可通过所述摆动机构完成摆动。本发明是一种结构简单紧凑、成本低廉、安装方便、可靠性好、加工精度高、能够保证抛光轮与工件间间隙稳定的可自适应调节抛光间隙的磁流变抛光轮组件。
说明书
技术领域技术领域
本发明主要涉及到磁流变抛光设备领域,特指一种磁流变抛光用抛光轮组件。
技术背景背景技术
确定性磁流变抛光技术是由美国Rochester大学COM光学加工中心首创,由美国QED公司完成产品化的新一代光学零件高精度计算机控制光学表面成形技术(CCOS)。确定性磁流变抛光技术的加工过程是利用磁流变抛光液在高梯度磁场下形成的“柔性抛光膜”来去除光学元件表面材料,此“柔性抛光模”即去除函数。抛光过程中材料的去除量是去除函数和驻留时间的卷积,如果去除函数不稳定就会造成实际材料去除量和期望材料去除量的偏差,从而不能达到高精度的光学表面,因此去除函数的稳定性在磁流变抛光过程中尤为重要。一般是通过控制磁流变抛光液成份和磁流变抛光工艺参数达到去除函数的稳定。影响去除函数的磁流变抛光工艺参数主要有以下几种,即抛光盘与工件间的间隙、磁场强度、抛光盘转速、磁流变液流量等等。其中磁场强度、抛光盘转速和磁流变液流量可通过闭环控制系统使其达到稳定,但是抛光盘和工件间的间隙目前还没有很好的方法使其稳定。同时抛光盘和工件间的间隙对去除函数有一定的影响,因此间隙自适应的调节对于磁流变超精密抛光加工工艺有重大意义。
目前,主要是人为调节抛光盘和工件间的间隙,在抛光过程开始之前通过人为调节使间隙达到期望值,这种方法有以下两个缺点:1、人为调节抛光盘和工件间的间隙精度不高,且对数控系统和机床的精度要求高;2、加工过程中抛光盘和工件间间隙的变化不能得到及时的修正,从而影响了加工精度。
发明内容发明内容
本发明要解决的技术问题就在于:针对现有技术存在的技术问题,本发明提供一种结构简单紧凑、成本低廉、安装方便、可靠性好、加工精度高、能够保证抛光轮与工件问间隙稳定的可自适应调节抛光间隙的磁流变抛光轮组件。
为解决上述技术问题,本发明采用以下技术方案。
一种可自适应调节抛光间隙的磁流变抛光轮组件,包括固定板以及安装于固定板下方的抛光轮,其特征在于:所述固定板的下方设有配重块,所述固定板与一摆动机构相连并可通过所述摆动机构完成摆动。
作为本发明的进一步改进:
所述摆动机构包括左摆臂、左摆轴、右摆臂以及右摆轴,所述固定板的一端通过左摆臂连接于左摆轴上,所述固定板的另一端通过右摆臂连接于右摆轴上。
所述抛光轮固定于转轴上,所述转轴的两端支承于转轴轴承上,所述转轴轴承的顶端通过支撑板与固定板连接。
与现有技术相比,本发明的优点就在于:
本发明可自适应调节抛光间隙的磁流变抛光轮组件,结构简单紧凑、成本低廉、安装方便、可靠性好、加工精度高、抗干扰能力较强,通过摆动机构即可实现抛光间隙的自适应调整,从而提高了去除函数的稳定性,提高了光学加工表面的质量,为进一步提高光学表面的加工精度奠定了基础。
附图说明附图说明
图1是本发明的主视结构示意图;
图2是本发明侧视的断面结构示意图;
图3是抛光间隙为x0时抛光轮装置的工况示意图;
图4是抛光间隙为x0时抛光轮装置的受力示意图;
图5是抛光间隙为x0-Δx时抛光轮装置的工况示意图。
图例说明
1、转轴轴承;2、转轴轴承端盖;3、左摆轴轴承;4、左摆轴;5、左摆轴轴承端盖;6、左摆臂;7、左支撑板;8、配重块;9、固定板;10、右摆臂;11、右摆轴轴承;12、右摆轴;13、右摆轴轴承端盖;14、右支撑板;15、转轴;16、抛光轮;
具体实施方式具体实施方式
以下将结合具体实施例和说明书附图对本发明做进一步详细说明。
如图1和图2所示,本发明可自适应调节抛光间隙的磁流变抛光轮组件,包括固定板9以及安装于固定板9下方的抛光轮16,抛光轮16位于工件待加工面的上方。固定板9的下方设有配重块8,固定板9与一摆动机构相连并可通过摆动机构完成摆动。抛光轮16固定于转轴15上并可在转轴15的带动下转动,转轴15的两端支承于转轴轴承1上,转轴轴承1的顶端通过支撑板与固定板9连接,支撑板包括左支撑板7和右支撑板14。
本实施例中,摆动机构包括左摆臂6、左摆轴4、右摆臂10以及右摆轴12,固定板9的一端通过左摆臂6、左摆轴轴承3连接于左摆轴4上,固定板9的另一端通过右摆臂10、右摆轴轴承11连接于右摆轴12上,固定板9可以绕左摆轴4、右摆轴12转动,左摆轴轴承3的端部设有左摆轴轴承端盖5。当抛光轮16和工件之间的间隙发生变化时,由于液体动压力的变化导致装置整体绕左摆轴4、右摆轴12的转矩发生变化;为了达到转矩平衡,固定板9带动抛光轮16在配重块8的作用下绕左摆轴4、右摆轴12转动,直至达到新的平衡,从而达到自适应调整抛光间隙的目的。
假设抛光轮16和工件之间的最佳间隙为x0,当抛光轮16和工件之间间隙变化Δx时,抛光装置的平衡被破坏。在配重块8的作用下,抛光轮16会向着靠近x0的方向运动,以下为分析和设计过程。图3为抛光间隙为x0时的工况示意图,以抛光装置为研究对象进行受力分析,图4是抛光间隙为x0时抛光轮装置的受力示意图。抛光轮16顺时针方向转动,图中Ft和Fn分别为磁流变抛光液对抛光轮16的切向力和法向力,G1、G2、G3和G4分别为配重块8、左右摆臂,摆轴及其轴承、左右支撑板和抛光轮16及其轴承的重力,Fx和Fy分别为摆轴对摆臂的作用力沿x,y方向的分力。点O、O1、O2、O3和O4分别是摆轴支点,配重块,左右摆臂、摆轴及其轴承,左右支撑板,抛光轮16及其轴承的重心,O5是磁流变抛光液对抛光轮16的力的作用点。设当抛光间隙为x0时摆轴相对于图1中逆时针旋转的角度为θ,此角度根据加工需要设定,为已知量。|OO2|、|OO3|、|OO4|、|O1A|、|OB|、|AB|和|O4O5|的长度分别为L2、L3、L4、h1、h2、L1和R,其中L2、L3、L4、h1、h2和R都是由所确定的结构决定,为已知常量,L1为未知量,需通过分析设计得到。求解支点O到各力的作用线的距离,首先分析点O到重力G1作用线的距离。在四边形ABO2O1中,求解出线段|O1O2|的长度如公式(1)。在四边形ABOO1中,求解线段|OO1|的长度如公式(2)。
在ΔOO1O2中,求解∠O1OO2,其表达式如公式(3)。
则点O到重力G1作用线的距离如公式(4),假设距离为l1。
其次分析点O到Ft和Fn力的作用线的距离,设分别为lt和ln,其表达式分别如公式(5)和公式(6)。
ln=L4·sin(θ) (5)
lt=L4·cos(θ)+R (6)
点O到Fx和Fy力的作用线的距离为0,到G2、G3和G4力的作用线的距离l2、l3和l4分别为L2·sin(θ)、L3·sin(θ)和L4·sin(θ)。则此工况下平衡方程如公式(7)。
通过公式(7)可求解出配重块4的重力和位置的关系如公式(8)所示。
通过以上方程组求得配重块8的重力与配重块8重心相对于支点的拓扑关系的关系式如公式(9)。
以上分析的是当抛光轮装置在最佳抛光间隙x0时的配重问题,以下将对抛光轮装置在抛光间隙变化时的间隙自适应问题。假设抛光轮16和工件之间间隙变化为Δx,且相对于抛光间隙缩小的方向,抛光间隙为x0-Δx。当抛光间隙变小时,磁流变抛光液对抛光轮16的切向力和法向力Ft和Fn会发生变化,其变化趋势与抛光间隙变化的方向相反,即抛光间隙变大时力变小,反之变大。此工况中,力变大。抛光轮装置的逆时针力矩大于顺时针力矩,因此抛光轮组件相对于支点逆时针旋转,知道达到力矩平衡,因此增大了抛光轮16和工件之间的抛光间隙,于是达到了抛光间隙自适应的目的。如图5为此时的工况图。此工况的受力示意图同图4,只是角度由θ变成θ-Δθ,则必须满足的转矩平衡方程如公式(10)。
将上式的左右两边分别展开得公式(11)和公式(12)。
右边=G3·L3+G4·L4-G2·L2-Fn·L4·sin(θ)·cos(Δθ)+Fn·L4·cos(θ)·sin(Δθ)-Ft·R-Ft·L4·cos(θ)cos(Δθ)+Ft·L4·sin(θ)sin(Δθ) (12)
抛光轮16抛光时的间隙变化为微米级,因此角度变化很小,可做近似处理,在此令sin(Δθ)=Δθ, 由于Δθ很小,则 将此近似带入公式(11)和公式(12),得到公式(13)和公式(14)。
右边=G3·L3+G4·L4-G2·L2-Fn·L4·sin(θ)-Ft·R-Ft·L4·cos(θ)+Fn·L4·cos(θ)·Δθ+Ft·L4·sin(θ)·Δθ (14)
将左边和右边做等号,得到此工况下的力矩平衡方程如公式(15)。
由公式(9),通过以下方程求解配重块8的重力及其配重块8的重心相对于支点的拓扑关系,方程组如(16)所示。通过此方程组可非别求出配重块8的重力和L1的值,从而达到抛光间隙自适应的目的。
以上所述仅是本发明的优选实施方式,本发明的保护范围并不仅局限于上述实施例,凡属于本发明思路下的技术方案均属于本发明的保护范围。应当指出,对于本技术领域的普通技术人员来说,在不脱离本发明原理前提下的若干改进和润饰,这些改进和润饰也应视为本发明的保护范围。
可自适应调节抛光间隙的磁流变抛光轮组件专利购买费用说明
![]()
Q:办理专利转让的流程及所需资料
A:专利权人变更需要办理著录项目变更手续,有代理机构的,变更手续应当由代理机构办理。
1:专利变更应当使用专利局统一制作的“著录项目变更申报书”提出。
2:按规定缴纳著录项目变更手续费。
3:同时提交相关证明文件原件。
4:专利权转移的,变更后的专利权人委托新专利代理机构的,应当提交变更后的全体专利申请人签字或者盖章的委托书。
Q:专利著录项目变更费用如何缴交
A:(1)直接到国家知识产权局受理大厅收费窗口缴纳,(2)通过代办处缴纳,(3)通过邮局或者银行汇款,更多缴纳方式
Q:专利转让变更,多久能出结果
A:著录项目变更请求书递交后,一般1-2个月左右就会收到通知,国家知识产权局会下达《转让手续合格通知书》。
动态评分
0.0