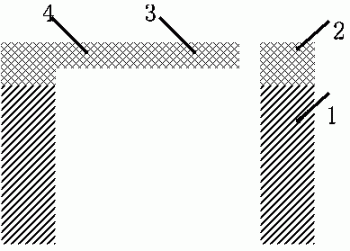
IPC分类号 : H01S5/00,H01S5/10,H01S5/30,H01S3/00,H01L21/00
专利摘要
本发明公开了一种氮化物非对称型回音壁模式光学微腔器件及制备方法,光学微腔器件包括硅衬底层、设置在硅衬底层上的氮化镓层,氮化镓层中设置有非对称型回音壁模式光学微腔和水平的支撑臂,非对称型回音壁模式光学微腔下方设置有贯穿硅衬底层的空腔,使非对称型回音壁模式光学微腔完全悬空,非对称型回音壁模式光学微腔通过支撑臂与氮化镓层连接,实现微腔内部光全反射传播,最终方向性的输出。本发明器件能够实现激光选频并且定向输出的功能、制造工艺简便、输出功率高。
权利要求
1.一种氮化物非对称型回音壁模式光学微腔器件,其特征在于,该器件以硅基氮化物晶片为载体,包括硅衬底层(1)、设置在所述硅衬底层(1)上的氮化镓层(2),所述氮化镓层(2)中设置有非对称型回音壁模式光学微腔(3)和水平的支撑臂(4),所述非对称型回音壁模式光学微腔(3)下方设置有贯穿硅衬底层(1)的空腔,使非对称型回音壁模式光学微腔(3)完全悬空,非对称型回音壁模式光学微腔(3)通过支撑臂(4)与氮化镓层(2)连接;
所述非对称型回音壁模式光学微腔(3)是由两个直径在20~30微米的半圆形氮化镓薄膜拼合而成,所述两个半圆形氮化镓薄膜的直径之差为1~2微米,其中一个半圆形氮化镓薄膜的一端与另一个半圆形氮化镓薄膜的一端相切。
2.一种制备氮化物非对称型回音壁模式光学微腔器件的方法,其特征在于,该方法以硅基氮化物晶片为载体,包括如下步骤:
(1)在硅基氮化物晶片的氮化镓层(2)上表面旋涂一层电子束光刻胶,采用电子束曝光技术在电子束光刻胶层上定义出非对称型回音壁模式光学微腔(3)和将所述非对称型回音壁模式光学微腔(3)连接到氮化镓层(2)上的水平的支撑臂(4),非对称型回音壁模式光学微腔(3)是由两个直径在20~30微米的半圆形氮化镓薄膜拼合而成,所述两个半圆形氮化镓薄膜的直径之差为1~2微米,其中一个半圆形氮化镓薄膜的一端与另一个半圆形氮化镓薄膜的一端相切;
(2)采用反应耦合等离子体刻蚀技术将所述步骤(1)中定义的非对称型回音壁模式光学微腔(3)和支撑臂(4)转移到氮化镓层(2)中,所述转移过程中反应耦合等离子体刻蚀深度为400~500nm;
(3)在硅基氮化物晶片的氮化镓层(2)上表面和硅衬底层(1)下表面旋涂一层电子束光刻胶,用以保护已加工器件,采用电子束曝光技术在硅衬底层(1)下表面的电子束光刻胶层上打开一个刻蚀窗口;
(4)将氮化镓层(2)作为刻蚀阻挡层,采用深硅刻蚀技术,通过刻蚀窗口将硅衬底层(1)贯穿刻蚀至氮化镓层(2)的下表面,在硅衬底层(1)中形成一个空腔;
(5)采用反应耦合等离子体刻蚀技术,在氮化镓层(2)下表面向上刻蚀,将非对称型回音壁模式光学微腔(3)下方的氮化镓材料刻穿,形成完全悬空的光学微腔结构,然后采用氧气等离子灰化方法去除硅衬底层(1)和氮化镓层(2)上的残余电子束刻胶,得到氮化物非对称型回音壁模式光学微腔器件。
说明书
技术领域
本文属于信息材料与器件领域,涉及基于氮化物的非对称型回音壁模式光学微腔器件及其制备过程。
背景技术
微腔型光电子器件具有尺寸小、易于集成、功耗低以及品质因子高等优点,同时光学微腔可以在极小的空间内产生巨大的光强,同时降低了腔内模式数目,影响腔内物质原子的自发福射特性,在微腔激光器、生化传感器以及光通信系统等领域有着广泛的应用。
回音壁模式的光学微腔(包括微球、微环或微盘等)是一种新型的高品质因子的集成光学器件。由于回音壁模式绕着微腔内壁全反射传播,光场被很好的限制在微腔中,因此通常需要波导、棱镜或者光纤锥等精密的倏逝波耦合系统将光信号提取出来。为了解决回音壁模式激光的方向性出射问题,通常有耦合方式和非对称结构两种方式。耦合腔能够产生模场畸变的超模式,还能对腔模的品质因子进行调制,从而降低激光阈值,进行模式选择。非对称腔避免了精密顆合的困难并且高效收集光信号。
同时,具有禁带宽度大、电子漂移饱和速度高、介电常数小、导热性能好等特点,更加适合于制作高温、高频及大功率电子器件。氮化物能覆盖从紫外光到可见光这样一个很宽范围的频谱,这是它们成为制备短波长蓝光激光器倍受关注的材料。
发明内容
技术问题:本发明提供一种能够实现激光选频并且定向输出的功能、制造工艺简便、输出功率高的氮化物非对称型回音壁模式光学微腔器件,并提供一种该微腔器件的制备方法。
技术方案:本发明的氮化物非对称型回音壁模式光学微腔器件,以硅基氮化物晶片为载体,包括硅衬底层、设置在硅衬底层上的氮化镓层,氮化镓层中设置有非对称型回音壁模式光学微腔和水平的支撑臂,非对称型回音壁模式光学微腔下方设置有贯穿硅衬底层的空腔,使非对称型回音壁模式光学微腔完全悬空,非对称型回音壁模式光学微腔通过支撑臂与氮化镓层连接。非对称型回音壁模式光学微腔是由两个直径在20~30微米的半圆形氮化镓薄膜拼合而成,两个半圆形氮化镓薄膜的直径之差为1~2微米,其中一个半圆形氮化镓薄膜的一端与另一个半圆形氮化镓薄膜的一端相切。
本发明的制备氮化物非对称型回音壁模式光学微腔器件的方法,包括如下步骤:
(1)在硅基氮化物晶片的氮化镓层上表面旋涂一层电子束光刻胶,采用电子束曝光技术在电子束光刻胶层上定义出非对称型回音壁模式光学微腔和将非对称型回音壁模式光学微腔连接到氮化镓层上的水平的支撑臂,非对称型回音壁模式光学微腔是由两个直径在20~30微米的半圆形氮化镓薄膜拼合而成,两个半圆形氮化镓薄膜的直径之差为1~2微米,其中一个半圆形氮化镓薄膜的一端与另一个半圆形氮化镓薄膜的一端相切;
(2)采用反应耦合等离子体刻蚀技术将步骤(1)中定义的非对称型回音壁模式光学微腔和支撑臂转移到氮化镓层中,转移过程中反应耦合等离子体刻蚀深度为400~500nm;
(3)在硅基氮化物晶片的氮化镓层上表面和硅衬底层下表面旋涂一层电子束光刻胶,用以保护已加工器件,采用电子束曝光技术在硅衬底层下表面的电子束光刻胶层上打开一个刻蚀窗口;
(4)将氮化镓层作为刻蚀阻挡层,采用深硅刻蚀技术,通过刻蚀窗口将硅衬底层贯穿刻蚀至氮化镓层的下表面,在硅衬底层中形成一个空腔;
(5)采用反应耦合等离子体刻蚀技术,在氮化镓层下表面向上刻蚀,将非对称型回音壁模式光学微腔下方的氮化镓材料刻穿,形成完全悬空的光学微腔结构,然后采用氧气等离子灰化方法去除硅衬底层和氮化镓层上的残余电子束刻胶,得到氮化物非对称型回音壁模式光学微腔器件。
本发明解决了微腔制备中因支撑问题带来的难度,提供了一种简易的微腔结构和较为简便的制备方法。本发明的光学微腔器件中,氮化物能覆盖从紫外光到可见光这样一个很宽范围的频谱,这是它们成为制备短波长蓝光激光器倍受关注的材料在LED、半导体激光等光学领域的广泛应用技术,采用氮化镓作为微腔器件的制作材料,能够实现从紫外光到可见光范围内的短波长光的选频,起到激光谐振腔的作用。本发明采用的非对称似圆形结构微腔,增加光在微腔中的传播光程,从而在相同能量泵浦的条件下大大提高出光效率。
有益效果:本发明与现有技术相比,具有以下优点:
(1)采用支撑臂方式,使得圆盘与支撑臂都采用同一种材料——氮化镓,氮化物能覆盖从紫外光到可见光这样一个很宽范围的频谱,这是它们成为制备短波长蓝光激光器倍受关注的材料。相比现有的立体柱状支撑,使得整个制备工艺更为简单,实现成本降低,在集成方面更加方便,实用性强。
(2)消除硅衬底,达到器件悬空,同时采用背后减薄技术,减薄氮化镓层,得到超薄悬空氮化物非对称型回音壁模式光学微腔器件,从而把光场模式控制在很小的范围内,实现单频模式选择。
(3)本发明采用非对称畸变圆形结构微腔,由两个直径相差微小的半圆组合在一起非对称型结构,使得光路在腔内全反射传输,增加光在微腔中的传播光程,从而在相同能量泵浦的条件下大大提高出光效率,最后通过消逝波耦合突出部分切线方向出射,实现高强度稳定输出,解决了方向可控性问题。
(4)选择氮化物材料,能覆盖从紫外光到可见光这样一个很宽范围的频谱,有利于实现紫外激光,是制备短波长激光器的优势材料,在增大信息的光存储密度、深海通信、材料加工、激光打印、大气污染监测等方面有着巨大的应用市场。
附图说明
图1为本发明氮化物非对称型回音壁模式光学微腔器件正视图;
图2为本发明氮化物非对称型回音壁模式光学微腔器件俯视图;
图3为本发明氮化物非对称型回音壁模式光学微腔器件侧视图;
图4为本发明氮化物非对称型回音壁模式光学微腔器件的制备工艺流程图。
图中有:硅衬底层1,氮化镓层2,非对称型回音壁模式光学微腔3,支撑臂4。
具体实施方式
下面结合说明书附图和实施例对本发明的技术方案做进一步的详细说明:
图1、图2、图3给出了本发明的氮化物非对称型回音壁模式光学微腔器件的结构示意图,以硅基氮化物晶片为载体,包括硅衬底层1、设置在硅衬底层1上的氮化镓层2,氮化镓层2中设置有非对称型回音壁模式光学微腔3和水平的支撑臂4,非对称型回音壁模式光学微腔3下方设置有贯穿硅衬底层1的空腔,使非对称型回音壁模式光学微腔3完全悬空,非对称型回音壁模式光学微腔3通过支撑臂4与氮化镓层2连接。非对称型回音壁模式光学微腔3是由两个直径分别为20微米~30微米的半圆形氮化镓薄膜在两者的半圆断面处拼合而成,两个半圆形氮化镓薄膜的直径之差为1~2微米,如图2所示,其中一个半圆形氮化镓薄膜的一端与另一个半圆形氮化镓薄膜的一端相切,两个半圆形氮化镓薄膜在另一端的结合部位则呈阶梯状。
本发明的实施例1中,非对称型回音壁模式光学微腔3的两个半圆形氮化镓薄膜分别为20微米和21微米,两者直径之差为1微米。
实施例2中,非对称型回音壁模式光学微腔3的两个半圆形氮化镓薄膜分别为28微米和30微米,两者直径之差为2微米。
实施例3中,非对称型回音壁模式光学微腔3的两个半圆形氮化镓薄膜分别为20微米和21.705微米,两者直径之差为1.705微米。
本发明采用光刻技术,在氮化镓层2中刻蚀出带支撑臂4的非对称型回音壁模式光学微腔3;采用深硅刻蚀技术,刻蚀掉非对称型回音壁模式光学微腔3下面的硅衬底层1,使非对称型回音壁模式光学微腔3悬空;采用反应耦合等离子体刻蚀技术,减薄氮化镓层2,最后得到所设计器件。
本发明的氮化物非对称型回音壁模式光学微腔器件的具体制备步骤如下:
(1)在硅基氮化物晶片的氮化镓层2上表面旋涂一层电子束光刻胶,采用电子束曝光技术在电子束光刻胶层上定义出设计图纸所定义的带支撑臂4的非对称型回音壁模式光学微腔3的结构;
(2)采用反应耦合等离子体刻蚀技术将步骤(1)中定义的非对称型回音壁模式光学微腔3和支撑臂4转移到氮化镓层2中,转移过程中反应耦合等离子体刻蚀深度为400~500nm;
(3)在硅基氮化物晶片的氮化镓层2上表面和硅衬底层1下表面旋涂一层电子束光刻胶,用以保护已加工器件,采用电子束曝光技术在硅衬底层1下表面的电子束光刻胶层上打开一个刻蚀窗口;
(4)将氮化镓层2作为刻蚀阻挡层,采用深硅刻蚀技术,通过刻蚀窗口将硅衬底层贯穿刻蚀至氮化镓层2的下表面,在硅衬底层1中形成一个空腔;
(5)采用反应耦合等离子体刻蚀技术,在氮化镓层2下表面向上刻蚀,将非对称型回音壁模式光学微腔3下方的氮化镓层1刻穿,形成完全悬空的光学微腔结构,然后采用氧气等离子灰化方法去除硅衬底层1和氮化镓层2上的残余电子束刻胶,得到氮化物非对称型回音壁模式光学微腔器件。
氮化物非对称型回音壁模式光学微腔器件及制备方法专利购买费用说明
![]()
Q:办理专利转让的流程及所需资料
A:专利权人变更需要办理著录项目变更手续,有代理机构的,变更手续应当由代理机构办理。
1:专利变更应当使用专利局统一制作的“著录项目变更申报书”提出。
2:按规定缴纳著录项目变更手续费。
3:同时提交相关证明文件原件。
4:专利权转移的,变更后的专利权人委托新专利代理机构的,应当提交变更后的全体专利申请人签字或者盖章的委托书。
Q:专利著录项目变更费用如何缴交
A:(1)直接到国家知识产权局受理大厅收费窗口缴纳,(2)通过代办处缴纳,(3)通过邮局或者银行汇款,更多缴纳方式
Q:专利转让变更,多久能出结果
A:著录项目变更请求书递交后,一般1-2个月左右就会收到通知,国家知识产权局会下达《转让手续合格通知书》。
动态评分
0.0