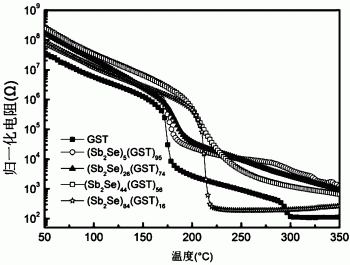
专利摘要
本发明公开了一种用于相变存储器的Ge-Sb-Te-Se薄膜材料及其制备方法,特点是该材料是一种由锗-锑-碲-硒四种元素组成的材料,其通式为(Sb2Se)x(Ge2Sb2Te5)y,其中Sb2Se摩尔百分含量为0%<x%≤84%,GST摩尔百分含量16%≤y%≤95%,x+y=100,具体包括以下步骤:将磁控溅射镀膜系统真空度控制为0-1.6×10-4Pa,溅射所需起辉气压为0.3Pa;然后将Sb2Se靶上的射频电源功率控制为3-13W,将GST靶上的射频电源功率控制为5-50W,溅射时间为10-60分钟,沉积得到Ge-Sb-Te-Se薄膜材料,优点是热稳定性好、数据保持能力强、相变速度快。
权利要求
1.一种用于相变存储器的Ge-Sb-Te-Se薄膜材料,其特征在于:该材料是一种由锗-锑-碲-硒四种元素组成的材料。
2.根据权利要求1所述的一种用于相变存储器的Ge-Sb-Te-Se薄膜材料,其特征在于:所述的Ge-Sb-Te-Se薄膜材料的化学结构式为(Sb2Se)x(Ge2Sb2Te5)y,其中Sb2Se 整体的摩尔百分含量为0%<x%≤84%,Ge2Sb2Te5整体的摩尔百分含量为16%≤y%≤95%,x+y=100。
3.根据权利要求2所述的一种用于相变存储器的Ge-Sb-Te-Se薄膜材料,其特征在于:所述的Ge-Sb-Te-Se薄膜材料采用Sb-Se合金靶和Ge-Sb-Te合金靶共溅射形成。
4.根据权利要求2所述的一种用于相变存储器的Ge-Sb-Te-Se薄膜材料,其特征在于:所述的Ge-Sb-Te-Se薄膜材料的化学结构式为(Sb2Se)44(Ge2Sb2Te5)56。
5.根据权利要求2所述的一种用于相变存储器的Ge-Sb-Te-Se薄膜材料,其特征在于:所述的Ge-Sb-Te-Se薄膜材料的化学结构式为(Sb2Se)84(Ge2Sb2Te5)16。
6.一种权利要求1所述的用于相变存储器的Ge-Sb-Te-Se薄膜材料的制备方法,其特征在于:采用Sb2Se靶和Ge2Sb2Te5合金靶两靶磁控共溅射而成,具体包括以下步骤:
(1)在磁控溅射镀膜系统中将Sb2Se靶材和Ge2Sb2Te5靶材分别安装在磁控射频溅射靶中,采用半导体为衬底;
(2)将磁控溅射镀膜系统的溅射腔室进行抽真空处理直至室内真空度达到1.6×10-4Pa,然后向溅射腔室内通入高纯氩气直至溅射腔室内气压达到溅射所需起辉气压0.3Pa;
(3)然后将Sb2Se靶上的射频电源功率控制为3-13W, 将Ge2Sb2Te5靶上的射频电源功率控制为5-50W,溅射时间为10分钟至60分钟,沉积得到厚度为161-330nm的薄膜材料,即为Ge-Sb-Te-Se薄膜材料,其化学结构式为(Sb2Se)x(Ge2Sb2Te5)y,其中Sb2Se 整体的摩尔百分含量为0%<x%≤84%,Ge2Sb2Te5整体的摩尔百分含量为16%≤y%≤95%,x+y=100。
7.根据权利要求6所述的一种用于相变存储器的Ge-Sb-Te-Se薄膜材料的制备方法,其特征在于:所述的Ge-Sb-Te-Se薄膜材料的化学结构式为(Sb2Se)44(Ge2Sb2Te5)56。
8.根据权利要求6所述的一种用于相变存储器的Ge-Sb-Te-Se薄膜材料的制备方法,其特征在于:所述的Ge-Sb-Te-Se薄膜材料的化学结构式为(Sb2Se)84(Ge2Sb2Te5)16。
说明书
技术领域
本发明涉及一种相变存储材料,尤其涉及一种用于相变存储器的Ge-Sb-Te-Se薄膜材料及其制备方法。
背景技术
相变存储器(PCRAM)具有循环寿命长、功耗低、可多级存储、高速读取、抗辐照、和制造工艺简单等优点,尤其器件尺寸可以缩小到10nm技术节点以下,这是其他存储技术无可比拟的。PCRAM被国际半导体工业协会认为最有可能取代Flash而成为未来存储器主流产品,具有广阔的市场前景。
相变存储器的基本原理是利用电脉冲或光脉冲产生的焦耳热,使相变存储材料在非晶态与晶态之间产生可逆转变,利用材料在高电阻值的非晶态和低电阻值的晶态之间的电阻差异来实现数据存储,数据的读出则通过测量电阻的状态来实现,相变就是利用高低电阻态之间的电阻差来实现“1” 和“0” 的存储。
改变相变存储介质材料的物理性质是提高相变存储器性能的常用方法。常用的相变存储材料体系主要是碲基材料,如Ge-Sb-Te、Si-Sb-Te、Ag-In-Sb-Te等。特别是GST已经广泛应用于相变光盘和相变存储器。目前商业上广泛使用的相变存储材料Ge2Sb2Te5的结晶温度为~150℃,结晶激活能2.24 eV,这两个数据决定了该材料只能在80℃左右保持十年,基本满足消费类电子产品的要求。然而,汽车电子产品要求存储数据在120℃下保持十年,空间应用的要求是150℃以上保持十年。Ge2Sb2Te5非晶态的低热稳定性严重限制了其应用范围。其次,晶态GST 材料的电阻较低,且材料具有较高的熔点(大约620℃),这使得相应器件的RESET 电流过大,带来了严重的功耗问题。这就需要我们探索具有更快相变速度的存储材料。如何提供一种热稳定性好,数据保持力强,相变速度快,是当前技术领域需要解决的问题。
发明内容
本发明所要解决的技术问题是提供一种热稳定性好、数据保持能力强、相变速度快的用于相变存储器的Ge-Sb-Te-Se薄膜材料及其制备方法。
本发明解决上述技术问题所采用的技术方案为:一种用于相变存储器的Ge-Sb-Te-Se薄膜材料,该材料是一种由锗-锑-碲-硒四种元素组成的材料。
所述的Ge-Sb-Te-Se薄膜材料的化学结构式为(Sb2Se)x(Ge2Sb2Te5)y,其中Sb2Se 整体的摩尔百分含量为0%<x%≤84%,Ge2Sb2Te5整体的摩尔百分含量为16%≤y%≤95%,x+y=100。
所述的Ge-Sb-Te-Se薄膜材料采用Sb-Se合金靶和Ge-Sb-Te合金靶共溅射形成。
所述的Ge-Sb-Te-Se薄膜材料的化学结构式为(Sb2Se)44(Ge2Sb2Te5)56。
所述的Ge-Sb-Te-Se薄膜材料的化学结构式为(Sb2Se)84(Ge2Sb2Te5)16。
一种用于相变存储器的Ge-Sb-Te-Se薄膜材料的制备方法,采用Sb2Se靶和Ge2Sb2Te5合金靶两靶磁控共溅射而成,具体包括以下步骤:
(1)在磁控溅射镀膜系统中将Sb2Se靶材和Ge2Sb2Te5靶材分别安装在磁控射频溅射靶中,采用半导体为衬底;
(2)将磁控溅射镀膜系统的溅射腔室进行抽真空处理直至室内真空度达到1.6×10-4Pa,然后向溅射腔室内通入高纯氩气直至溅射腔室内气压达到溅射所需起辉气压0.3Pa;
(3)然后将Sb2Se靶上的射频电源功率控制为3-13W, 将Ge2Sb2Te5靶上的射频电源功率控制为5-50W,溅射时间为10分钟至60分钟,沉积得到厚度为161-330nm的薄膜材料,即为Ge-Sb-Te-Se薄膜材料,其化学结构式为(Sb2Se)x(Ge2Sb2Te5)y,其中Sb2Se 整体的摩尔百分含量为0%<x%≤84%,Ge2Sb2Te5整体的摩尔百分含量为16%≤y%≤95%,x+y=100。
所述的Ge-Sb-Te-Se薄膜材料的化学结构式为(Sb2Se)44(Ge2Sb2Te5)56。
所述的Ge-Sb-Te-Se薄膜材料的化学结构式为(Sb2Se)84(Ge2Sb2Te5)16。
与现有技术相比,本发明的优点在于:本发明一种用于相变存储器的Ge-Sb-Te-Se薄膜材料及其制备方法,由锗-锑-碲-硒四种元素组成,通式为(Sb2Se)x(Ge2Sb2Te5)y,其中0<x≤84,16≤y≤95,通过调节四种元素的含量可以得到不同结晶温度、熔点、结晶速率和结晶前后电阻比率的存储材料。其中锑、碲能形成Sb-Sb和Sb-Te稳定相,这两相在纳米尺度复合,可以组成类似于GeTe和Sb2Te3的伪二元体系,因而材料比较稳定,不容易发生分相,因而具有更好的热稳定性和结晶速度,有助于提高器件的数据保持力和操作速度。适当调节Ge-Sb-Te-Se中元素比例(其中,掺杂元素的含量由溅射过程中的掺杂源与惰性气体的流量比值决定),进而可以得到比传统的Ge2Sb2Te5(GST)具有更高的结晶温度、更强的数据保持力、更低的熔点和更快的结晶速度,以及更宽的禁带宽度。
综上所述,与一般的存储材料相比,本发明提供的Ge-Sb-Te-Se薄膜材料,热稳定性好,数据保持能力强,结晶速度快,物理性能可调,有着较高的禁带宽度和较稳定的晶态组分。本发明提供的相变存储材料的制备方法,工艺简单,便于精确控制材料成分和后续工艺。使用所述相变存储材料Sb2Se-(Ge2Sb2Te5)制备成的相变存储器,具有操作速度快、电学性能稳定等优点。
附图说明
图1为不同组分的Ge-Sb-Te-Se薄膜材料的电阻-温度关系图;
图2为不同组分的Ge-Sb-Te-Se薄膜材料的数据保持能力计算结果图;
图3为 Ge-Sb-Te-Se薄膜材料的禁带宽度图谱和透过谱;
图4为170℃的退火温度下Ge-Sb-Te-Se薄膜材料的XRD图谱 ;
图5为200℃的退火温度下Ge-Sb-Te-Se薄膜材料的XRD图谱;
图6为260℃的退火温度下Ge-Sb-Te-Se薄膜材料的XRD图谱 ;
图7为350℃的退火温度下Ge-Sb-Te-Se薄膜材料的XRD图谱 。
具体实施方式
以下结合附图实施例对本发明作进一步详细描述。
实施例1
一种用于相变存储器的Ge-Sb-Te-Se薄膜材料,该材料是一种由锗-锑-碲-硒四种元素组成的材料,其中锑、碲能形成Sb-Sb和Sb-Te稳定相,这两相在纳米尺度复合,可以组成类似于GeTe和Sb2Te3的伪二元体系。
实施例2
一种用于相变存储器的Ge-Sb-Te-Se薄膜材料,该薄膜材料的化学结构式为(Sb2Se)x(Ge2Sb2Te5)y,其中Sb2Se 整体的摩尔百分含量为0%<x%≤84%,Ge2Sb2Te5整体的摩尔百分含量为16%≤y%≤95%,x+y=100,其具体包括以下步骤:
(1)在磁控溅射镀膜系统中将Sb2Se靶材和Ge2Sb2Te5靶材分别安装在磁控射频溅射靶中,采用半导体为衬底;
(2)将磁控溅射镀膜系统的溅射腔室进行抽真空处理直至室内真空度达到1.6×10-4Pa,然后向溅射腔室内通入高纯氩气直至溅射腔室内气压达到溅射所需起辉气压0.3Pa;
(3)然后将Sb2Se靶上的射频电源功率控制为3-13W, 将Ge2Sb2Te5靶上的射频电源功率控制为5-50W,溅射时间为10分钟至60分钟,沉积得到厚度为161-330nm的薄膜材料,即为Ge-Sb-Te-Se薄膜材料,其化学结构式为(Sb2Se)x(Ge2Sb2Te5)y,其中Sb2Se 整体的摩尔百分含量为0%<x%≤84%,Ge2Sb2Te5整体的摩尔百分含量为16%≤y%≤95%,x+y=100。
实施例3
同上述实施例2,其区别在于:制备过程中合金Sb2Se靶的溅射功率控制为0W,Ge2Sb2Te5靶材的溅射功率控制为40W,得到Ge2Sb2Te5相变存储薄膜材料。
实施例4
同上述实施例2,其区别在于:制备过程中合金Sb2Se靶的溅射功率控制为13W,Ge2Sb2Te5靶材的溅射功率控制为50W,得到(Sb2Se)5(Ge2Sb2Te5)95相变存储薄膜材料。
实施例5
同上述实施例2,其区别在于:制备过程中合金Sb2Se靶的溅射功率控制为3W,Ge2Sb2Te5靶材的溅射功率控制为50W,得到(Sb2Se)26(Ge2Sb2Te5)74相变存储薄膜材料。
实施例6
同上述实施例2,,其区别在于:制备过程中合金Sb2Se靶的溅射功率控制为13W,Ge2Sb2Te5靶材的溅射功率控制为20W,得到(Sb2Se)44(Ge2Sb2Te5)56相变存储薄膜材料。
实施例7
同上述实施例2,,其区别在于:制备过程中合金Sb2Se靶的溅射功率控制为12W,Ge2Sb2Te5靶材的溅射功率控制为5W,得到(Sb2Se)84(Ge2Sb2Te5)16相变存储薄膜材料。
对制备所述的相变存储薄膜Sb2Se-(Ge2Sb2Te5)和进行了各项测试,以评估相变存储材料的相变特性,包括结晶温度、热稳定性,数据保持能力。所述的Sb2Se-(Ge2Sb2Te5)也可以通过化学气相沉积,原子层沉积(ALD),电子束蒸发等方法制备。
试验结果分析
上述实施3-7制备的相变存储薄膜材料的具体组分如表1所示,
表1 制备的薄膜样品组分
图1为不同组分相变存储材料Sb2Se-(Ge2Sb2Te5)的电阻-温度关系图。从图中可以看出,相变存储材料Sb2Se-(Ge2Sb2Te5)的结晶温度可以调节在171-205oC之间,较GST(约140oC)高。相变存储材料的结晶温度随着Sb2Se含量的增大而升高。因而通过调节Sb2Se的含量可以方便控制相变存储材料Sb2Se-(Ge2Sb2Te5)的结晶温度。
如图2所示,Sb2Se-(Ge2Sb2Te5)的10年数据保持温度随着Sb2Se含量的增加而升高。当Sb2Se含量较低时(≤ 26mol%),10年数据保持温度较低(76度左右)。当Sb2Se含量大于44 mol%时,Sb2Se-(Ge2Sb2Te5)材料的数据保持力明显比GST好。同时可以看出,Sb2Se-(Ge2Sb2Te5)材料体系的热稳定性和数据保持力可以通过调节Sb2Se的含量来进行优化。
如图3的插图是利用红外/紫外分光光度计测量(Sb2Se)84 (GST)16薄膜得到的透过谱。图3是非晶态的 (Sb2Se)84 (GST)16的 与光子能量图。对于较高的值 ,吸收系数产出的能量遵循 , ,分别是该种物质的Tauc参数,普朗克常量,频率以及禁带宽度。计算可得非晶态(Sb2Se)84(GST)16的禁带宽度Eopt以及斜率量B1/2分别为0.71eV和796.4cm?1/2eV?1/2,高于GST(0.69eV和714.6 cm?1/2eV?1/2)。由于陷阱态的出现使它在电荷填充和电性转换的作用增大,所以非晶态材料拥有较高的禁带宽度是非常重要的。同时,更高的B1/2也意味着更高的无序性,以及更高的On/OFF 开关比。
如图4-图7所示,用X射线衍射(XRD)来对Sb2Se-GST膜的晶体结构来进行研究测定。这也表明,(Sb2Se)84(GST)16由Sb2Se和GST相结晶而成,并显示出单一面心立方结构。图4显示,在170℃退火下,(Sb2Se)26(Ge2Sb2Te5)74和(Sb2Se)5(Ge2Sb2Te5)95的有两个弱衍射峰。这个现象可以通过它们的较低结晶温度来解释。图5显示,(Sb2Se)44(Ge2Sb2Te5)56和 (Sb2Se)84(Ge2Sb2Te5)16薄膜的特征峰出现退火在200℃,这表明了它们都发生了晶化。而它们的结晶温度是200℃,这与R-T的结果是一致的。如图6所示,在260℃退火温度下,(Sb2Se)84(GST)16与其他组分相比表现出了更强的衍射强度,这表明它具有更高的结晶度。薄膜的结晶度越高,其紊乱程度越低,载流子密度越高,并且电子态更加离散。如图7所示,而当退火温度提高到350℃,薄膜结构由面心立方结构转为六方结构,在350℃时(Sb2Se)26(GST)74薄膜中面心立方结构和六方结构均有存在,而当把Sb2Se摩尔浓度提高到44%时,六方结构开始消失,仅有面心立方结构存在,它表明了Sb2Se的掺入可以抑制面心立方结构向六方结构的转变。 (Sb2Se)84(GST)16具有最小晶粒尺寸,使其具有更多晶界。并且与其他组分相比,在350℃时,由于它的载体更加分散,因此具有更高的电阻。
上述说明并非对本发明的限制,本发明也并不限于上述举例。本技术领域的普通技术人员在本发明的实质范围内,作出的变化、改型、添加或替换,也应属于本发明的保护范围,本发明的保护范围以权利要求书为准。
一种用于相变存储器的Ge-Sb-Te-Se薄膜材料及其制备方法专利购买费用说明
![]()
Q:办理专利转让的流程及所需资料
A:专利权人变更需要办理著录项目变更手续,有代理机构的,变更手续应当由代理机构办理。
1:专利变更应当使用专利局统一制作的“著录项目变更申报书”提出。
2:按规定缴纳著录项目变更手续费。
3:同时提交相关证明文件原件。
4:专利权转移的,变更后的专利权人委托新专利代理机构的,应当提交变更后的全体专利申请人签字或者盖章的委托书。
Q:专利著录项目变更费用如何缴交
A:(1)直接到国家知识产权局受理大厅收费窗口缴纳,(2)通过代办处缴纳,(3)通过邮局或者银行汇款,更多缴纳方式
Q:专利转让变更,多久能出结果
A:著录项目变更请求书递交后,一般1-2个月左右就会收到通知,国家知识产权局会下达《转让手续合格通知书》。
动态评分
0.0