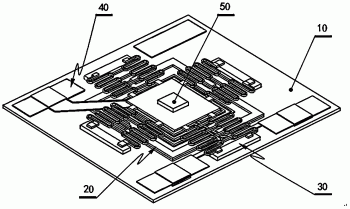
专利摘要
本发明公开了一种高度集成的电磁双稳态MEMS继电器及其制备方法。所述继电器是在单一基片上集成了包括电磁驱动、弹性支撑、信号切换等继电器所有系统和永磁体的MEMS器件。制备方法包括在基片上溅射种子层、旋涂光刻胶、绝缘层,通过光刻、电镀等工序形成平面线圈、封闭磁轭、悬臂梁、弹性平台、磁轭平台、动静触点、信号线、支撑结构,通过释放法形成气隙并在弹性平台上安装永磁体成为完整的继电器。本发明通过MEMS技术在单个基片上集成了电磁双稳态继电器的所有系统,提高了集成度,减小了继电器体积、降低了继电器功耗、保证了继电器工作的可靠性,且简化了制作工艺,适合工业化批量生产。
权利要求
1.一种高度集成的电磁双稳态MEMS继电器,包括基片和集成在基片上的电磁驱动系统、弹性支撑系统和永磁体,其特征在于:基片上还集成了信号切换系统;所述的电磁驱动系统包括多匝螺旋状平面线圈和封闭磁轭,线圈之间设有绝缘层,封闭磁轭分布于平面线圈的中央、底部和边缘;所述的弹性支撑系统包括磁轭平台和叠置在磁轭平台上面的弹性平台以及与弹性平台的四边分别固定连接的四个悬臂梁,每个悬臂梁的另一端均与一个支撑结构固定连接;所述的永磁体位于弹性支撑系统的弹性平台的上表面;所述的信号切换系统包括静触点、动触点和两个外接信号线,所述的静触点位于电磁驱动系统的上表面,与一个外接信号线连接,所述的动触点位于弹性支撑系统的底部,与另一个外接信号线连接;在动触点与静触点之间存在由四个支撑结构支撑所形成的气隙。
2.一种制备权利要求1所述的电磁双稳态MEMS继电器的方法,其特征在于,包括如下步骤:
a)将基片表面洗净、烘干,溅射铬铜种子层,在溅射了铬铜种子层的表面旋涂多层光刻胶,然后依次光刻、电镀铁镍层,旋涂绝缘材料并进行热处理、平整化,再电镀铜线圈、铁镍层,形成平面线圈和磁轭;
b)去除光刻胶、铬铜种子层,旋涂绝缘材料并进行热处理、平整化,在绝缘层表面旋涂光刻胶,依次光刻、电镀铜形成信号线,再依次电镀金、镍、铜形成静触点;
c)旋涂厚叠层光刻胶,依次光刻、电镀镍形成支撑结构;
d)旋涂一层光刻胶,依次光刻、依次电镀金、镍、铜形成动触点,电镀铁镍形成磁轭平台、电镀铁镍形成悬臂梁、弹性平台,电镀镍形成支撑结构;
e)缓慢去除叠层光刻胶,逐层去除铬铜种子层,采用释放法形成气隙;
f)在弹性平台的上表面安装永磁体。
3.如权利要求2所述的方法,其特征在于:步骤a)中旋涂的每一层光刻胶的厚度为15微米,光刻胶的曝光时间为200秒,显影时间为120秒。
4.如权利要求2所述的方法,其特征在于:步骤b)采用离子束干法刻蚀去除铬铜种子层,刻蚀时间为90秒。
5.如权利要求2所述的方法,其特征在于:步骤a)和步骤b)中所述的热处理均指先将涂好绝缘材料的基片在2小时内加热升温到250℃,再保温2小时,随后自然冷却至室温。
6.如权利要求2所述的方法,其特征在于:步骤c)中的厚叠层光刻胶的厚度为80微米,厚叠层光刻胶的曝光时间为7分钟,显影时间为30分钟。
7.如权利要求2所述的方法,其特征在于:步骤c)首次烘厚叠层光刻胶时,以0.3~0.5℃/分钟的速率升温至110℃,第二次甩厚叠层光刻胶后,进行烘胶的温度要低于110℃。
8.如权利要求2所述的方法,其特征在于:步骤e)采用刻蚀反应去除叠层光刻胶和铬铜种子层,去除叠层光刻胶的刻蚀剂为质量百分比浓度为0.5~1.5%的氢氧化钠水溶液,去除铜种子层的刻蚀剂采用体积比为1:1的双氧水与氨水的混合液,去除铬种子层的刻蚀剂采用质量百分比浓度为0.5~3%的高锰酸钾水溶液,刻蚀反应温度不低于30℃,并以低于0.15微米/分的线速度进行搅拌。
9.如权利要求2所述的方法,其特征在于:步骤e)中形成气隙的释放法是先将器件悬空放入甲醇溶液中,加磁力慢速搅拌浸泡至少1小时,再将器件悬空放入乙醇溶液中,加磁力慢速搅拌浸泡至少3小时。
10.如权利要求2或9所述的方法,其特征在于:所述气隙的间距为155~165μm。
说明书
技术领域
本发明涉及一种高度集成的电磁双稳态MEMS继电器及其制备方法,属于微电子机械技术领域。
背景技术
继电器是通过小电流控制大电流运作的一种“自动开关”,通过自动接通/断开来转换电路。在电路中,通过远程控制,可用继电器实现安全保护、电路切换等功能,广泛应用于电源管理、仪器仪表、自动控制和通讯连接等领域。
在现今的继电器市场,通信继电器已占据了25%以上的份额。通信继电器主要应用于网络、仪器仪表、自动控制等能够通过远程或者间接自动进行开关转换的场合。随着信息技术的发展,通信已经从传统的语音信号转化为集语音、数据、音视频以及图像等复杂信号并扩展至数据领域,便携式通讯设备以及相应的标准也已经得到极大的发展和提高,因此,对通信领域的电子元器件—通信继电器也提出了更高的要求。
第一代、第二代通信继电器起始于20世纪70~80年代,到90年代已实现第三代和第四代的量产。第四代通讯继电器相对于第一代通讯继电器体积已经缩小了50%,功耗降低了80%。随着通信技术的发展,需要增加数据传输、降低运行成本,这都对通信继电器体积、功耗和可靠性提出了更高的要求,而采用传统精密机械加工的微型继电器的工艺已经达到了极限。微电子机械系统(Micro Electro Mechanical Systems,简称MEMS)技术的出现,突破了通信继电器的发展瓶颈,为通信继电器的进一步发展提供了新的概念和途径。MEMS技术与继电器的融合,能够保持传统机电继电器接触电阻小、绝缘电阻高、隔离度高等优势,同时,采用微加工工艺可实现通讯继电器的批量制造,实现所制通讯继电器体积小、功耗低、功能多和可靠性高的特点,并可继承固态继电器集成制造的生产优势和机电继电器电器综合性能好的技术优势,代表了未来通信继电器的发展方向。
随着MEMS继电器器件尺寸的缩小,各种不同驱动方式的继电器其驱动原理已经产生了较大的变化。当然,各种驱动类型和结构也都有优缺点,其性能也不尽相同,但随着MEMS继电器尺寸的减小,电磁驱动继电器的优势较静电驱动继电器的优势则越发明显。静电驱动MEMS继电器由于结构简单,非常易于加工制备,然而驱动电压过高,不易于和传统集 成电路工艺(Integrated Circuit,简称IC)兼容,也容易造成两电极之间的绝缘层击穿,降低器件寿命。相对于静电驱动的MEMS继电器,电热驱动型微继电器能够产生较大的能量密度,具有更大的输出力,显示出更为明显的输出位移,然而,电热继电器的散热过程通常需要较长的时间。相对于采用前述两种方式驱动的继电器,电磁驱动型继电器具有行程大、绝缘性能好、响应速度快、且有良好的力-位移非线性,能够适应各种不同的环境,综合性能更加突出。
Gary D.Gray Jr.等在《传感器与执行器》杂志发表的“电磁驱动双稳态驱动器第一部超低开关功耗和建模”(《Sensors and Actuators》A,Vol119,2005,489~501“Magnetically bistable actuator Part 1.Ultra-low switching energy and modeling)一文中,提出一种两片式装配而成的电磁MEMS继电器,上片衬底制备平面线圈,下片衬底制备悬臂梁及支撑结构,上下衬底通过信号柱进行支撑和封装,悬臂梁在永磁体所产生的磁场中处于第一个稳定状态,随着线圈中通入脉冲电流,悬臂梁在外电磁场力的作用下切换向另一稳态,并借助于永磁体实现第二个稳态的保持,其基本工作原理是借助于在上衬底的线圈中通入脉冲电流来实现双稳态的切换,借助于永磁体实现保持。该继电器输出位移大,响应速度快,功耗低。然而,在该设计中,基于两衬底式的装配难以实现电磁继电器的高度集成、批量制造。
B.Rogger等在第八届微电子传感器与执行器会议(TRANSDUCERS,95 the 8th International Conference on Solid-State Sensors and Actuators and Eurosensors IX)上发表的“基于两层LIGA工艺的集成电磁驱动器”(Fully batch fabricated magnetic microactuators using two layer LIGA process)一文中,提出了采用X射线光刻技术(LIGA技术)制备基于立体螺旋线圈结构的电磁继电器,它由聚甲基丙烯酸甲酯(PMMA)牺牲层技术结合二次LIGA技术实现铁镍磁芯及立体螺旋线圈组成。通入电流后,悬臂梁实现面内往复运动,断开或者闭合触点。然而,立体螺线管线圈的制备方法复杂,且LIGA技术成本较高,效率低,受外形尺寸的限制多,单片制造线圈容纳的线圈匝数相对要少。
发明内容
针对现有技术存在的上述问题,本发明的目的是提供一种高度集成的电磁双稳态MEMS继电器及其制备方法,使其满足体积小、功耗低、集成度高、综合性能好,且制备方便、生产成本低、易于工业化批量生产的要求。
为达上述目的,本发明采用如下技术方案:
一种高度集成的电磁双稳态MEMS继电器,包括基片和集成在基片上的电磁驱动系统、 弹性支撑系统和永磁体,其特征在于:基片上还集成了信号切换系统;所述的电磁驱动系统包括多匝螺旋状平面线圈和封闭磁轭,封闭磁轭分布于平面线圈的中央、底部和边缘;所述的弹性支撑系统包括磁轭平台和叠置在磁轭平台上面的弹性平台以及与弹性平台的四边分别固定连接的四个悬臂梁,每个悬臂梁的另一端均与一个支撑结构固定连接;所述的永磁体位于弹性支撑系统的弹性平台的上表面;所述的信号切换系统包括静触点、动触点和两个外接信号线,所述的静触点位于电磁驱动系统的上表面,与一个外接信号线连接,所述的动触点位于弹性支撑系统的底部,与另一个外接信号线连接;在动触点与静触点之间存在由四个支撑结构支撑所形成的气隙。
作为优选方案,线圈之间设有绝缘层,所述绝缘层的厚度为10~24μm。
作为优选方案,所述平面线圈的形状为方形、矩形或圆形。
作为优选方案,所述平面线圈为单层线圈,线圈的厚度为22~26μm,宽度为12~15μm。
作为优选方案,所述的支撑结构设在电磁驱动系统与弹性支撑系统之间。
作为优选方案,所述气隙的间距为155~165μm。
一种制备上述高度集成的电磁双稳态MEMS继电器的方法,包括如下步骤:
a)将基片表面洗净、烘干,溅射铬铜种子层,在溅射了铬铜种子层的表面旋涂多层光刻胶,然后依次光刻、电镀铁镍层,旋涂绝缘材料并进行热处理、平整化,再电镀铜线圈、铁镍层,形成平面线圈和磁轭;
b)去除光刻胶、铬铜种子层,旋涂绝缘材料并进行热处理、平整化,在绝缘层表面旋涂光刻胶,依次光刻、电镀铜形成信号线,再依次电镀金、镍、铜形成静触点;
c)旋涂厚叠层光刻胶,依次光刻、电镀镍形成支撑结构;
d)旋涂一层光刻胶,依次光刻、依次电镀金、镍、铜形成动触点,电镀铁镍形成磁轭平台、电镀铁镍形成悬臂梁、弹性平台,电镀镍形成支撑结构;
e)缓慢去除叠层光刻胶,逐层去除铬铜种子层,采用释放法形成气隙;
f)在弹性平台的上表面安装永磁体。
步骤a)中旋涂的每一层光刻胶的厚度为15微米,光刻胶的曝光时间为200秒,显影时间为120秒。
步骤b)采用离子束干法刻蚀去除铬铜种子层,刻蚀时间为90秒。
步骤a)和步骤b)中所述的热处理均指先将涂好绝缘材料的基片在2小时内加热升温到250℃,再保温2小时,随后自然冷却至室温。
步骤c)中的厚叠层光刻胶的厚度为80微米,厚叠层光刻胶的曝光时间为7分钟,显影 时间为30分钟;首次烘厚叠层光刻胶时,以0.3~0.5℃/分钟的速率升温至110℃,第二次甩厚叠层光刻胶后,进行烘胶的温度要低于110℃。
步骤e)采用刻蚀反应去除叠层光刻胶和铬铜种子层,去除叠层光刻胶的刻蚀剂为质量百分比浓度为0.5~1.5%的氢氧化钠水溶液,去除铜种子层的刻蚀剂采用体积比为1:1的双氧水与氨水的混合液,去除铬种子层的刻蚀剂采用质量百分比浓度为0.5~3%的高锰酸钾水溶液,刻蚀反应温度不低于30℃,并以低于0.15微米/分的线速度进行搅拌。
步骤e)中形成气隙的释放法是先将器件悬空放入甲醇溶液中,加磁力慢速搅拌浸泡至少1小时,再将器件悬空放入乙醇溶液中,加磁力慢速搅拌浸泡至少3小时。
本发明提供的一种高度集成的电磁双稳态MEMS继电器的工作原理是这样的:
电磁双稳态MEMS继电器等效的磁路所产生的磁感应强度大部分都集中在气隙之间,因此,气隙间电磁力的大小决定了继电器的工作状态。当气隙间距逐渐变小时,磁力增大,从而吸引弹性悬臂梁使继电器闭合。相反,当气隙间距变大时,磁力减小,悬臂梁在弹性回复力的作用下回复至初始状态,继电器断开。
因此,当需要将继电器由断开态切换至闭合状态时,需要在平面线圈中通入电流,增加气隙中的磁感应强度,使作用在弹性支撑结构上的磁力增大,直到磁力克服弹性变形力,弹性平台被吸引向下,直至静触点与动触点闭合,外接电路形成通路。由于永磁体设置在弹性支撑系统的上表面,因此,在平面线圈通电后,随着气隙间距的逐渐减小,所产生的磁场能够增加气隙中磁感应强度,加强气隙中的合磁力。当继电器闭合后,永磁体所产生磁力的能够保持继电器保持在闭合状态,无需再给平面线圈通电,因此降低了静态功耗。而当需要将继电器由闭合状态切换至断开状态时,则可通入反向电流,使平面线圈产生反向电磁力来削弱永磁体所产生的磁力,从而使作用在弹性平台上总的合磁力减小。当合磁力小于弹性回复力时,弹性平台在自身回复力的作用下向远离电磁驱动器方向运动,静触点和动触点分离,断开外接电路。
由于本发明提供的一种高度集成的电磁双稳态MEMS继电器将电磁驱动系统、弹性支撑系统、信号切换系统和永磁体通过MEMS技术集成为一体,因此,继电器的体积可以更小、工作可靠性更高,并可通过精确控制动触点和静触点之间的气隙,实现驱动位移和绝缘性能的精确控制,通过精确控制电磁力的大小来实现继电器对电路的可靠切换。
与现有技术相比,本发明的有益效果在于:
1)提高了电磁双稳态MEMS继电器的集成度,减小了继电器的体积、降低了继电器的功耗、保证了继电器工作的可靠性、提高了继电器的各项综合性能;
2)实现了在单基片上继电器各系统的整体集成制造,简化了生产工艺,缩短了工艺周期,降低了制造难度,为工业化批量制造提供了一种低成本、高效率的生产方法;
3)由于采用了将永磁体设置在弹性支撑系统上表面的设计,因此,可以在无功耗的前提下,实现继电器闭合工作状态的保持。
附图说明
图1是本发明提供的一种高度集成的电磁双稳态MEMS继电器的立体结构示意图。
图2是本发明所提供的一种电磁驱动系统的平面结构示意图。
图3是本发明提供的一种弹性支撑系统的平面结构示意图。
图4是本发明提供的一种信号切换系统的平面结构示意图。
图中:10、基片;20、电磁驱动系统;21、平面线圈;22、封闭磁轭;30、弹性支撑系统;31、磁轭平台;32、弹性平台;33、悬臂梁;34、支撑结构;40、信号切换系统;41、静触点;42、动触点;43、外接信号线Ⅰ;44、外接信号线Ⅱ;50、永磁体。
具体实施方式
下面结合附图和实施例对本发明的技术方案做进一步详细、完整地说明。
实施例:
如图1所示,本发明提供的一种高度集成的电磁双稳态MEMS继电器,包括:基片10和集成在基片10上的电磁驱动系统20、弹性支撑系统30、信号切换系统40和永磁体50,永磁体50位于弹性支撑系统30的上面。
如图2所示,所述的电磁驱动系统20包括多匝螺旋状平面线圈21和封闭磁轭22,封闭磁轭22分布于平面线圈21的中央、底部和边缘;线圈之间设有绝缘层;平面线圈的形状可以为方形、矩形或则圆形,本实施例中为方形;所述平面线圈21优选为单层线圈,线圈的厚度优选为22~26μm,宽度优选为12~15μm。
如图3所示,所述的弹性支撑系统30包括磁轭平台31和叠置在磁轭平台31上面的弹性平台32以及与弹性平台32的四边分别固定连接的四个悬臂梁33,每个悬臂梁33的另一端均与一个支撑结构34固定连接。
如图4所示,所述的信号切换系统40包括静触点41、动触点42和两个外接信号线,所述的静触点41位于电磁驱动系统20的上表面,与外接信号线Ⅱ44(图中,因信号线44 被遮挡,仅用其接线桩表示)连接,所述的动触点42位于弹性支撑系统30的底部,与外接信号线Ⅰ43连接,图中所示的动触点42位置是动触点42与静触点41在接触时的状态结构;在动触点42与静触点41之间存在由四个支撑结构34支撑所形成的气隙,气隙的间距优选为155~165μm。
上述高度集成的电磁双稳态MEMS继电器的制备方法如下:
a)取一块1mm厚的玻璃基片10,将其表面洗净、烘干,在基片10上溅射100nm铬铜种子层;旋涂15μm正性光刻胶并烘干,曝光200秒后显影120秒,电镀10μm底层铁镍衬底;旋涂15μm正性光刻胶并烘干,曝光200秒后显影120秒,在基片中央和边缘电镀10μm铁镍层;用丙酮溶解光刻胶,并用离子束干法刻蚀去除铁镍层的种子层;旋涂10~24μm的聚酰亚胺层,进行亚胺化热处理:在2小时内加热升温到250℃,再保温2小时,随后自然冷却至室温;再研磨抛光聚酰亚胺层,溅射100nm铬铜种子层,旋涂20μm正性光刻胶并烘干,曝光220秒后显影150秒,电镀厚度为24μm、宽度为12~15μm的铜线圈;旋涂5μm正性光刻胶并烘干,曝光200秒后显影120秒,在基片中央和边缘电镀10μm铁镍层;旋涂5μm正性光刻胶并烘干,曝光40秒后显影60秒,电镀5μm微铜过孔和第一层线圈引脚;形成总面积不超过1mm2的单层方形螺旋状平面线圈21和封闭磁轭22;
b)用丙酮溶解光刻胶,用离子束刻蚀法去除线圈匝间种子层;旋涂聚酰亚胺层并程控烘干,进行亚胺化热处理:在2小时内加热升温到250℃,再保温2小时,随后自然冷却至室温;研磨抛光聚酰亚胺层;溅射铬铜种子层,旋涂20μm正性光刻胶并烘干,曝光220秒后显影150秒,分别电镀15μm铜形成信号线43、44,以及两端铜线圈引脚;在正性光刻胶上再旋涂15μm正性光刻胶并烘干,曝光200秒后显影120秒,依次电镀10μm铜、1μm镍和0.5μm金作静触点41。
c)旋涂80μm正性光刻胶并烘干,曝光7分钟后显影30分钟,电镀80μm镍支撑结构;再次旋涂80μm正性光刻胶并烘干,曝光7分钟后显影30分钟,电镀80μm镍形成支撑结构34。
d)研磨电镀后的正胶表面,形成平整的表面,溅射铬铜种子层;旋涂15μm正性光刻胶并烘干,曝光200秒后显影120秒,依次电镀金0.5μm、镍1μm、10μm铜作为动触点42;旋涂5μm正性光刻胶并烘干,曝光45秒后显影65秒,电镀10μm镍支撑结构,研磨,烘胶;溅射铬铜种子层,旋涂15μm正性光刻胶并烘干,曝光40秒后显影60秒,电镀10μm铁镍,形成磁轭平台31;旋涂5μm正性光刻胶并烘干,曝光45秒后显影65秒,电镀10μm镍做做支撑层,研磨,烘胶;溅射铬铜种子层,旋涂15μm正性光刻胶并烘干,曝光40秒 后显影60秒,电镀12μm铁镍形成弹性平台32和悬臂梁33。
e)将上述集成了相应系统的基片放入质量百分比浓度为1%的NaOH水溶液中,在温度不低于30℃的条件下,用磁力搅拌器以线速度低于0.15微米/分的速度进行搅拌,逐渐去除光刻胶牺牲层;采用体积比为1:1的双氧水与氨水的混合液去除铜种子层;采用质量百分比浓度为2%的高锰酸钾水溶液去除铬种子层;将上述基片悬空放入甲醇溶液中,用磁力搅拌器慢速搅拌浸泡至少1小时;再悬空放入乙醇溶液中,用磁力搅拌器慢速搅拌浸泡至少3个小时,形成气隙;
(f)在上述弹性平台32的上表面安装尺寸为1mm×1mm×0.6mm的永磁体50。
本发明提供的一种高度集成的电磁双稳态MEMS继电器的开关功能是这样实现的:
首先,在电磁双稳态MEMS继电器电磁驱动系统20的平面线圈21中通入电流,通过平面线圈21通电后产生的磁场来改变磁路中总磁通量的大小,增大或减小气隙中的合磁力,借助于磁力和弹性支撑系统30的弹性变形力之间的变化,实现继电器在闭合与断开状态之间的切换,然后,借助于永磁体50实现稳态的保持。
当需要将继电器由断开状态切换至闭合状态时,在平面线圈21中通入电流,使气隙中的总磁通量增加,作用在弹性平台32的磁力增大以克服弹性变形力,从而将磁轭平台31下拉到吸合位置,接通外接电路,随后无需通电,借助于永磁体50的磁力使继电器保持在闭合状态。因为无需通电,因而没有能耗。当需要将继电器由闭合状态切换至断开状态时,可以通入反向电流,使气隙中的总磁通量减少,作用在中央弹性平台32上的磁力减小,小于弹性回复力。弹性平台32在弹性回复力的作用下远离电磁驱动系统20,静触点41和动触点42分离,断开外接电路,实现其开关功能。
效果试验
利用测试装置,对制备的上述高度集成电磁双稳态微MEMS继电器动态响应特性及双稳态工作机制进行测试实验。测试装置由功率放大器、波形发生器、直流电源、和示波器构成。
将上述高度集成电磁双稳态微MEMS继电器接入测试装置,通入脉冲电流,示波器显示该继电器处于闭合状态,外接电路接通;当停止通入电流,外接电路能够一直保持在接通状态,说明该继电器能够借助于永磁体50的磁力使继电器保持在闭合状态。当继电器通入大小相同但方向相反的驱动电压后,继电器断开同时外接电路断路,说明本发明提供的高度集成的电磁双稳态MEMS继电器具有良好的双稳态特性,工作性能可靠、稳定。
通过示波器观察输入、输出电压之间的时间差,可以测试出继电器的响应时间。测试 结果表明,本发明提供的高度集成的电磁双稳态MEMS继电器响应时间为0.96毫秒,综合性能良好,达到了本发明的目的。
最后有必要在此说明的是:上述实施例只用于对本发明的技术方案做进一步详细说明,仅用于帮助理解本发明的技术内容,不能理解为对本发明保护范围的限制。本领域的技术人员根据本发明的上述内容做出的非本质改进和调整均属于本发明所要求的保护范围。
一种高度集成的电磁双稳态MEMS继电器及其制备方法专利购买费用说明
![]()
Q:办理专利转让的流程及所需资料
A:专利权人变更需要办理著录项目变更手续,有代理机构的,变更手续应当由代理机构办理。
1:专利变更应当使用专利局统一制作的“著录项目变更申报书”提出。
2:按规定缴纳著录项目变更手续费。
3:同时提交相关证明文件原件。
4:专利权转移的,变更后的专利权人委托新专利代理机构的,应当提交变更后的全体专利申请人签字或者盖章的委托书。
Q:专利著录项目变更费用如何缴交
A:(1)直接到国家知识产权局受理大厅收费窗口缴纳,(2)通过代办处缴纳,(3)通过邮局或者银行汇款,更多缴纳方式
Q:专利转让变更,多久能出结果
A:著录项目变更请求书递交后,一般1-2个月左右就会收到通知,国家知识产权局会下达《转让手续合格通知书》。
动态评分
0.0