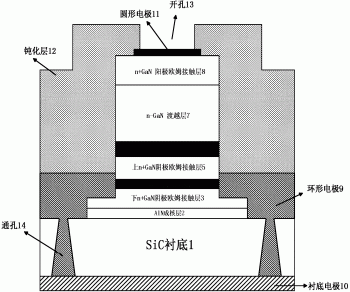
专利摘要
本发明公开了一种基于notch结构的GaN耿氏二极管及其制作方法,主要解决现有耿氏器件中渡越层位错浓度高、散热性差的问题。该二极管自下而上为:SiC衬底、AlN成核层、下n+GaN阴极欧姆接触层、AlGaN电子发射层、上n+GaN阴极欧姆接触层、GaNnotch层、n-GaN渡越层和n+GaN阳极欧姆接触层的多层结构,Al组分自下而上由0%线性渐变到20%。在下n+GaN阴极欧姆接触层的上方和SiC衬底的下方分别设有环形电极和衬底电极,n+GaN阳极欧姆接触层的上方为圆形电极,环形电极和圆形电极上方设有钝化层。本发明能显著降低位错浓度,减小“死区”长度,适用于太赫兹频段工作。
权利要求
1.一种基于notch结构的GaN耿氏二极管,包括主体部分和辅体部分,该主体部分自下而上包括:SiC衬底(1)、AlN成核层(2)、下n+GaN阴极欧姆接触层(3)、上n+GaN阴极欧姆接触层(5)、GaN notch层(6)、n-GaN渡越层(7)和n+GaN阳极欧姆接触层(8);辅体部分包括环形电极(9)、衬底电极(10)、圆形电极(11)、钝化层(12)、开孔(13)和通孔(14);环形电极(9)和衬底电极(10)作为器件的阴极,分别位于下n+GaN阴极欧姆接触层(3)的上方和SiC衬底(1)的下方,圆形电极(11)作为器件的阳极位于n+GaN阳极欧姆接触层(8)的上方,钝化层(12)位于环形电极(9)和圆形电极(11)的上方,开孔(13)和通孔(14)分别位于钝化层(12)和SiC衬底(1)内,通孔(14)将环形电极(9)与衬底电极(10)相连,形成纵向器件结构;
其特征在于:下n+GaN阴极欧姆接触层(3)与上n+GaN阴极欧姆接触层(5)之间设有AlGaN电子发射层(4),以阻挡位错,提高GaN Notch层(6)和n-GaN渡越层(7)的GaN结晶质量;
所述AlGaN电子发射层(4),采用厚度为100~200nm的渐变Al组分AlGaN结构,该Al组分自下而上由0%线性渐变到20%。
2.如权利要求1所述的基于notch结构的GaN耿氏二极管,其特征在于SiC衬底(1)选用4H-SiC半绝缘型衬底或者4H-SiC导通型衬底或者6H-SiC半绝缘型衬底或者6H-SiC导通型衬底。
3.如权利要求1所述的基于notch结构的GaN耿氏二极管,其特征在于AlN成核层(2)的厚度为8~10nm。
4.如权利要求1所述的基于notch结构的GaN耿氏二极管,其特征在于下n+GaN阴极欧姆接触层(3)的厚度为200~300nm,掺杂浓度为1~2×1018cm-3。
5.如权利要求1所述的基于notch结构的GaN耿氏二极管,其特征在于上n+GaN阴极欧姆接触层(5)的厚度为200~300nm,掺杂浓度为1~2×1018cm-3。
6.如权利要求1所述的基于notch结构的GaN耿氏二极管,其特征在于GaN Notch层(6)的厚度为100~200nm。
7.如权利要求1所述的基于notch结构的GaN耿氏二极管,其特征在于n-GaN渡越层(7)的厚度为1~2μm,掺杂浓度为1~2×1017cm-3。
8.如权利要求1所述的基于notch结构的GaN耿氏二极管,其特征在于n+GaN阳极欧姆接触层(8)的厚度为100~400nm,掺杂浓度为1~2×1018cm-3。
9.一种基于notch结构的GaN耿氏二极管的制作方法,包括如下步骤:
(1)在导通型或绝缘型SiC衬底上,采用金属有机物化学气相淀积MOCVD的方法,外延生长厚度为8~10nm的AlN成核层;
(2)在已外延的AlN成核层上,用金属有机物化学气相淀积MOCVD的方法,外延生长掺杂浓度为1~2×1018cm-3、厚度为200~300nm的下n+GaN阴极欧姆接触层;
(3)在已外延的下n+GaN阴极欧姆接触层上,利用金属有机物化学气相淀积MOCVD的方法,外延生长厚度为100~200nm,Al组份浓度自下而上由0%线性渐变到20%的AlGaN层,构成AlGaN电子发射层;
(4)在AlGaN电子发射层上,利用金属有机物化学气相淀积MOCVD的方法,外延生长掺杂浓度为1~2×1018cm-3、厚度为200~300nm的上n-GaN阴极欧姆接触层;
(5)在已外延的上n-GaN阴极欧姆接触层上,利用金属有机物化学气相淀积MOCVD的方法,外延生长厚度为100~200nm无掺杂GaN Notch层;
(6)在所述的GaN Notch层上,利用金属有机物化学气相淀积MOCVD的方法,外延生长掺杂浓度为1~2×1017cm-3、厚度为1~2um的n-GaN渡越层;
(7)在所述n-GaN渡越层上,利用金属有机物化学气相淀积MOCVD的方法,外延生长掺杂浓度为1~2×1018cm-3、厚度为100~400nm的n+GaN阳极欧姆接触层;
(8)采用刻蚀技术对SiC衬底上的外延层进行刻蚀至SiC衬底的上表面,形成直径为d0的大圆形台面,30μm<d0<60μm;
(9)在所述大圆形台面上继续进行刻蚀至下n+GaN阴极欧姆接触层,形成直径为d1的小圆形台面,10μm<d1<20μm;
(10)在小圆形台面和刻蚀露出的下n+GaN阴极欧姆接触层上淀积Ti/Al/Ni/Au多层金属,经金属剥离,在小圆形台面上形成圆形电极,即耿氏二极管的阳极,在阴极欧姆接触层面上形成环形电极;
(11)在950℃的温度下,通入Ar2进行时间为50秒钟的快速热退火,使下n+GaN阴极欧姆接触层与圆形电极金属、以及n+GaN阳极欧姆接触层与环形电极金属之间形成欧姆接触;
(12)在SiC衬底背面刻蚀形成n个通孔,n>=1,刻蚀深度至环形电极;
(13)在刻蚀形成的SiC通孔以及SiC衬底背面淀积Ti/Al/Ni/Au多层金属,形成阳极衬底电极,衬底电极与环形连接电极一起构成耿氏二极管阴极;
(14)采用PECVD的方法在环形电极、圆形电极、露出的n+GaN阳极欧姆接触的上方淀积厚度为200~400nm的SiN钝化层,并在小圆形台面开孔13,露出耿氏二极管阳极,完成整个器件的制作。
说明书
技术领域
本发明属于微电子器件技术领域,特别涉及宽带隙半导体GaN材料的耿氏二极管,可用于高频、大功率器件制作。
技术背景
GaN材料作为新型宽禁带半导体,由于其具有禁带宽度大、化学性质稳定、临界击穿电场高、电子饱和速度大、异质结二维电子气浓度高等特点,在毫米波大功率电子器件领域受到了广泛的关注。与传统III-V族化合物半导体GaAs相比,GaN的负阻振荡基频频率达到750GHz,远远超过GaAs的140GHz,此外,对于GaN基的电子器件,其输出功率也比GaAs基的电子器件高出1~2个数量级,可以达到几百毫瓦甚至几瓦。因此,研究GaN基的毫米波大功率器件具有重要意义。
在已经提出的耿氏器件结构中,最经典的就是“三明治”结构:两边的n型重掺杂区分别作为器件的阴极和阳极欧姆接触层,中间是n型均匀掺杂的电子渡越层。根据仿真实验,在n型重掺杂阴极欧姆接触层和n型均匀掺杂电子渡越层之间加上一层薄薄的低掺杂notch掺杂层,可以明显缩短死区长度,降低电子渡越层中电场峰值,使得电子渡越层内的电场分布更加平坦,从而可以明显改善器件的耿氏效应。因此,近年来的文献报道中提出了一些基于notch掺杂结构的耿氏器件,如单凹槽(notch)掺杂层的非均匀掺杂有源区结构、多凹槽(notch)掺杂层的非均匀掺杂有源区结构等等。
虽然上述带有notch掺杂结构耿氏器件的电学特性在器件仿真方面得到了很好的验证,但是在实际的制造过程中,由于没有引入有效的位错过滤机制,使得大量位错延伸到电子渡越层,导致该层的体材料位错浓度过高,从而影响器件的电特性。
发明内容
本发明的目的在于提供一种基于notch结构的GaN耿氏二极管及其制作方法,以阻挡位错,改善notch层和渡越层的GaN结晶质量,从而提高器件渡越层中畴的稳定性。
为实现上述目的,本发明的基于notch结构的GaN耿氏二极管,包括主体部分和辅体部分,该主体部分自下而上包括:SiC衬底、AlN成核层、下n+GaN阴极欧姆接触层、AlGaN电子发射层、上n+GaN阴极欧姆接触层、GaN notch层、n-GaN渡越层和n+GaN阳极欧姆接触层;辅体部分包括环形电极、衬底电极、圆形电极、钝化层、开孔和通孔;环形电极和衬底电极作为器件的阴极,分别位于下n+GaN阴极欧姆接触层的上方和SiC衬底的下方,圆形电极作为器件的阳极位于n+GaN阳极欧姆接触层的上方,钝化层位于环形电极和圆形电极的上方;开孔和通孔分别位于钝化层和SiC衬底内,通孔将环形电极与衬底电极相连,形成纵向器件结构;
所述AlGaN电子发射层厚度为100~200nm,该Al组分自下而上由0%线性渐变到20%。
作为优选,所述SiC衬底为4H-SiC半绝缘型衬底、4H-SiC导通型衬底、6H-SiC半绝缘型衬底或者6H-SiC导通型衬底。
作为优选,所述AlN成核层的厚度为8~10nm。
作为优选,所述下n+GaN阴极欧姆接触层的厚度为200~300nm,掺杂浓度为1~2×1018cm-3。
作为优选,所述上n+GaN阴极欧姆接触层的厚度为200~300nm,掺杂浓度为1~2×1018cm-3。
作为优选,所述GaN notch层的厚度为100~200nm。
作为优选,所述n-GaN渡越层的厚度为1~2um,掺杂浓度为1~2×1017cm-3。
作为优选,所述n+GaN阳极欧姆接触层的厚度为100~400nm,掺杂浓度为1~2×1018cm-3。
为实现上述目的,本发明的GaN耿氏二极管制作方法,包括如下步骤:
(1)在导通型或绝缘型SiC衬底上,采用金属有机物化学气相淀积MOCVD的方法,外延生长厚度为8~10nm的AlN成核层;
(2)在已外延的AlN成核层上,用金属有机物化学气相淀积MOCVD的方法,外延生长掺杂浓度为1~2×1018cm-3、厚度为200~300nm的下n+GaN阴极欧姆接触层;
(3)在已外延的下n+GaN阴极欧姆接触层上,利用金属有机物化学气相淀积MOCVD的方法,外延生长厚度为100~200nm,Al组份浓度自下而上由0%线性渐变到20%的AlGaN层,构成AlGaN电子发射层;
(4)在AlGaN电子发射层上,利用金属有机物化学气相淀积MOCVD的方法,外延生长掺杂浓度为1~2×1018cm-3、厚度为200~300nm的上n-GaN阴极欧姆接触层;
(5)在已外延的上n-GaN阴极欧姆接触层上,利用金属有机物化学气相淀积MOCVD的方法,外延生长厚度为100~200nm无掺杂GaN Notch层;
(6)在所述的GaN Notch层上,利用金属有机物化学气相淀积MOCVD的方法,外延生长掺杂浓度为1~2×1017cm-3、厚度为1~2um的n-GaN渡越层;
(7)在所述n-GaN渡越层上,利用金属有机物化学气相淀积MOCVD的方法,外延生长掺杂浓度为1~2×1018cm-3、厚度为100~400nm的n+GaN阳极欧姆接触层;
(8)采用刻蚀技术对SiC衬底上的外延层进行刻蚀至SiC衬底的上表面,形成直径为d0的大圆形台面,30um<d0<60um;
(9)在所述大圆形台面上继续进行刻蚀至下n+GaN阴极欧姆接触层,形成直径为d1的小圆形台面,10um<d1<20um;
(10)在小圆形台面和刻蚀露出的下n+GaN阴极欧姆接触层上淀积Ti/Al/Ni/Au多层金属,经金属剥离,在小圆形台面上形成圆形电极,即耿氏二极管的阳极,在阴极欧姆接触层面上形成环形电极;
(11)在950℃的温度下,通入Ar2进行时间为50秒钟的快速热退火,使下n+GaN阴极欧姆接触层与圆形电极金属、以及n+GaN阳极欧姆接触层与环形电极金属之间形成欧姆接触;
(12)在SiC衬底背面刻蚀形成n个通孔,n>=1,刻蚀深度至环形电极;
(13)在刻蚀形成的SiC通孔以及SiC衬底背面淀积Ti/Al/Ni/Au多层金属,形成阳极衬底电极,衬底电极与环形连接电极一起构成耿氏二极管阴极;
(14)采用PECVD的方法在环形电极、圆形电极、露出的n+GaN阳极欧姆接触的上方淀积厚度为200~400nm的SiN钝化层,并在小圆形台面开孔13,露出耿氏二极管阳极,完成整个器件的制作。
本发明由于在阴极欧姆接触层中加入了AlGaN电子发射层,具有如下优点:
A.改善器件的工作频率和转换效率。
由于AlGaN与GaN的禁带宽度不同,因此在极化效应的作用下,AlGaN/GaN异质结的GaN一侧会形成二维电子气;一旦二维电子气中的电子获得足够的能量,就会挣脱势阱的束缚,注入高能电子,因此该AlGaN层能起到热电子发射作用,从而有助于降低“死区”长度,改善器件的工作频率和转换效率。
B.降低位错浓度,防止位错延伸至GaN notch层和n-GaN渡越层。
由于AlGaN与GaN之间存在应力,这种应力能使得通过AlGaN层的位错生长方向发生弯曲,从而实现位错的湮灭,降低了位错的浓度。
随着Al组分浓度的升高,AlGaN与GaN之间的应力逐渐增大,但Al组分增大的同时,AlGaN与GaN之间的晶格失配也越来越大,为了平衡位错过滤和晶格失配这两个因素,本发明采用渐变AlGaN结构,该结构在实现晶格失配最小化的同时,对位错进行了有效的过滤。
附图说明
图1是本发明GaN基耿氏二极管的剖面结构图;
图2是图1的俯视图;
图3是AlGaN电子发射层的放大示意图;
图4是本发明制作GaN耿氏二极管的工艺流程图。
具体实施方式
参照图1、图2,本发明的GaN耿氏二极管器件结构包括主体部分和辅体部分。主体部分自下而上为:SiC衬底1、AlN成核层2、下n+GaN阴极欧姆接触层3、AlGaN电子发射层4、上n+GaN阴极欧姆接触层5、GaN notch层6、n-GaN渡越层7和n+GaN阳极欧姆接触层8;辅体部分包括:环形电极9、衬底电极10、圆形电极11、钝化层12、开孔13和通孔14。其中:
SiC衬底1为器件提供物理支撑,同时也能起到散热的作用,环形电极9通过开在SiC衬底1的通孔14与衬底电极10相连,形成纵向器件结构,通孔14的个数为n,n>=1;AlN成核层2的厚度为8~10nm,能起到改变生长模式、降低位错的作用;下n+GaN阴极欧姆接触层3的掺杂浓度为1~2×1018cm-3,厚度为200~300nm,在该层上设有大圆形台面,台面的直径为d0,30um<d0<60um;上n+GaN阴极欧姆接触层5的掺杂浓度为1~2×1018cm-3,厚度为200~300nm;GaN notch层6的厚度为100~200nm,无掺杂,该层能起到降低“死区”长度的作用;n-GaN渡越层7的掺杂浓度为1~2×1017cm-3,厚度为1~2um,该层的掺杂浓度与厚度将决定耿式二极管的工作频率和工作模式;n+GaN阳极欧姆接触层8的掺杂浓度为1~2×1018cm-3,厚度为100~400nm,在该层上设有小圆形台面,台面的直径为d1,10um<d1<20um。如图2所示,中心圆形为二极管的阳极,外侧的圆环为环形电极9,通孔14以及衬底电极10在图中没有画出。
n+GaN阳极欧姆接触层8的上方淀积Ti/Al/Ni/Au多层金属形成圆形电极11,构成器件的阳极;环形电极9和衬底电极10分别位于下n+GaN阴极欧姆接触层3的上方和SiC衬底1的下方,二者共同作为器件的阴极。
AlGaN电子发射层4采用厚度为100~200nm的线性渐变Al组分AlGaN电子发射层,如图3所示,该层的Al组分浓度自下而上由0%线性渐变到20%,以在实现对位错的有效过滤。
参照图4,本发明GaN耿氏二极管的制作方法,给出如下三种实施例:
实施例1:制作4H-SiC导通型衬底的GaN耿氏二极管。
步骤一,减薄衬底。
选用直径为2英寸的4H-SiC导通型衬底,对背面进行减薄,直至衬底厚度为150um。
步骤二,外延生长AlN成核层。
采用MOCVD的方式,在保持压力为40Torr、温度为650℃的条件下,同时通入三甲基铝与氮气,在4H-SiC导通型衬底上生长厚度为10nm的AlN成核层。
步骤三,外延生长下n+GaN阴极欧姆接触层。
采用MOCVD的方式,将温度升高到1060℃,在保持压力为40Torr的条件下,同时通入三甲基镓、氮气和n型掺杂源—硅烷,外延生长厚度为240nm,掺杂浓度为1.5×1018cm-3的下n+GaN阴极欧姆接触层。
步骤四,外延生长AlGaN电子发射层。
采用MOCVD的方式,将反应室中的压力升高到150Torr,同时通入三甲基镓、氮气和三甲基铝,且三甲基铝的通入计量线性增加,在保持温度为1060℃的条件下,外延生长厚度为150nm的AlGaN电子发射层。
步骤五,外延生长上n+GaN阴极欧姆接触层。
采用MOCVD的方式,将温度升高到1060℃,在保持压力为40Torr的条件下,同时通入三甲基镓、氮气和n型掺杂源—硅烷,外延生长厚度为240nm,掺杂浓度为1.5×1018cm-3的上n+GaN阴极欧姆接触层。
步骤六,外延生长GaN notch层。
继续采用MOCVD的方式,保持反应室中的气压为40Torr,同时通入三甲基镓、氮气和n型掺杂源—硅烷,在保持温度为1060℃的条件下,外延生长厚度为150nm,且无掺杂的GaN notch层。
步骤七,外延生长n-GaN渡越层。
继续采用MOCVD的方式,保持反应室中的气压为40Torr,同时通入三甲基镓、氮气和n型掺杂源—硅烷,在保持温度为1060℃的条件下,外延生长厚度为1um,掺杂浓度为1×1017cm-3的n-GaN渡越层。
步骤八,外延生长n+GaN阴极欧姆接触层。
继续采用MOCVD的方式,同时通入三甲基镓、氮气和n型掺杂源—硅烷,在保持气压为40Torr,温度为1060℃的条件下,外延生长厚度为200nm,掺杂浓度为1.5×1018cm-3的n+GaN阴极欧姆接触层,形成GaN多层外延层。
步骤九,刻蚀形成大圆形台面。
9.1)采用光刻的方法,在GaN多层外延层上形成直径为40um的大圆形掩膜图形;
9.2)采用反应离子刻蚀技术,用BCl3/Cl2气体对GaN多层外延层进行刻蚀,刻蚀至露出4H-SiC导通型衬底表面为止,形成大圆形台面。
步骤十,刻蚀形成小圆形台面。
10.1)采用光刻的方法,在大圆形台面上形成直径为15um的同轴小圆形台面掩膜图形;
10.2)采用反应离子刻蚀RIE技术,用BCl3/Cl2气体对大圆形台面进行刻蚀,刻蚀深度进入到下n+GaN阴极欧姆接触层中100nm,形成小圆形台面。
步骤十一,形成圆形电极、环形电极和欧姆接触。
11.1)采用真空电子束蒸发技术,在经上述步骤处理后的样品表面依次蒸发
Ti/Al/Ni/Au多层金属,厚度分别为35nm/125nm/55nm/165nm,再采用金属剥离技术,形成圆形电极和环形电极;
11.2)再在950℃温度的氩气气氛中,进行50秒钟的快速热退火处理,使圆形电极金属、环形电极金属与接触的GaN材料形成欧姆接触。
步骤十二,刻蚀形成通孔14。
12.1)采用光刻的方法,在4H-SiC导通型衬底的背面形成4个直径为10um的通孔掩模图形;
12.2)采用反应离子RIE刻蚀技术,用BCl3/Cl2气体对SiC衬底进行刻蚀,一直刻蚀至环形电极表面,形成通孔14。
步骤十三,形成GaN耿氏二极管的阴极。
13.1)采用真空电子束蒸发的方式,在6H-SiC衬底的背面依次蒸发厚度为35nm的Ti、125nm的Al、55nm的Ni以及200nm的Au;
13.2)采用金属剥离技术,形成衬底电极,注入金属后的通孔14将衬底电极与环形电极相连,构成GaN耿氏二极管的阴极。
步骤十四,外延生长SiN钝化层。
采用PECVD的方式,同时通入的硅烷和氮气,在压力为40Torr、温度为1000℃的条件下,在经过上述步骤处理后的样品上外延生长厚度为200nm的SiN钝化层。
步骤十五,露出二极管的阳极。
采用RIE刻蚀的方法,用CF4气体对SiN钝化层进行刻蚀,一直刻蚀至圆形电极表面,形成开孔13,露出二极管的阳极,完成器件的制作,最终形成的耿氏二极管管芯剖面如图1所示。
实施例2:制作4H-SiC半绝缘型衬底的GaN耿氏二极管。
步骤1,选用直径为2英寸的4H-SiC半绝缘型衬底,对背面进行减薄,直至衬底厚度为150um。
步骤2,将4H-SiC半绝缘型衬底放入MOCVD反应室,设定生长温度为600℃,向反应室中同时通入三甲基铝与氮气,在保持压力为40Torr的条件下,生长厚度为8nm的AlN成核层。
步骤3,将已经生长了AlN成核层的衬底升高到1000℃,向反应室中同时通入三甲基镓、氮气和n型掺杂源—硅烷,在保持压力为40Torr的条件下,生长厚度为200nm,掺杂浓度为1.0×1018cm-3的下n+GaN阴极欧姆接触层。
步骤4,将MOCVD反应室中的气压升高到100Torr,同时通入三甲基镓、氮气和三甲基铝,且三甲基铝的通入计量线性增加,在保持温度为1000℃的条件下,外延生长厚度为100nm的AlGaN电子发射层。
步骤5,将MOCVD反应室中的气压下降到40Torr,同时通入三甲基镓、氮气和n型掺杂源—硅烷,生长厚度为200nm,掺杂浓度为1.0×1018cm-3的上n+GaN阴极欧姆接触层。
步骤6,保持MOCVD反应室中的气压在40Torr,同时通入三甲基镓、氮气,在保持温度为1000℃的条件下,外延生长厚度为100nm,且无掺杂的GaN notch层。
步骤7,保持MOCVD反应室中的气压在40Torr,同时通入三甲基镓、氮气和n型掺杂源—硅烷,在保持温度为1000℃的条件下,外延生长厚度为1um,掺杂浓度为1×1017cm-3的n-GaN渡越层。
步骤8,继续采用MOCVD的方式,同时通入三甲基镓、氮气和n型掺杂源—硅烷,在保持气压为40Torr,温度为1000℃的条件下,外延生长厚度为100nm,掺杂浓度为1.0×1018cm-3的n+GaN阴极欧姆接触层,形成GaN多层外延层。
步骤9,将上述GaN多层外延层从MOCVD反应室中拿出,在GaN多层外延层上进行光刻,形成直径为30um的大圆形掩膜图形,再采用反应离子刻蚀技术,用BCl3/Cl2气体对GaN多层外延层进行刻蚀,刻蚀至露出4H-SiC衬底表面为止,形成大圆形台面。
步骤10,在形成的大圆形台面上进行光刻,形成直径为10um的同轴小圆形台面掩膜图形;再采用反应离子刻蚀技术,用BCl3/Cl2气体对大圆形台面进行刻蚀,刻蚀深度进入到下n+GaN阴极欧姆接触层中100nm,形成小圆形台面。
步骤11,用真空电子束蒸发设备在经上述步骤处理后的样品表面依次蒸发
Ti/Al/Ni/Au多层金属,厚度分别为30nm/120nm/50nm/160nm,经过金属剥离形成圆形电极和环形电极,再在950℃温度的氩气气氛中进行50秒钟的快速热退火处理,形成GaN欧姆接触。
步骤12,在4H-SiC衬底的背面形成4个直径为10um的通孔掩模图形,再采用反应离子RIE刻蚀的方法,用BCl3/Cl2气体对SiC衬底进行刻蚀,一直刻蚀至环形电极表面,形成通孔14。
步骤13,用真空电子束蒸发设备在4H-SiC衬底的背面依次蒸发Ti/Al/Ni/Au多层金属,厚度分别为30nm/120nm/50nm/200nm,经过金属剥离形成衬底电极,注入金属后的通孔14将衬底电极与环形电极相连,构成GaN耿氏二极管的阴极。
步骤14,将经过上述步骤处理后的样品放入PECVD反应室,向反应室中同时通入的硅烷和氮气,在压力为40Torr、温度为1000℃的条件下,外延生长厚度为200nm的SiN钝化层。
步骤15,采用RIE刻蚀的方法,用CF4气体对SiN钝化层进行刻蚀,一直刻蚀至圆形电极表面,形成开孔13,露出二极管的阳极,完成器件的制作,最终形成的耿氏二极管管芯剖面如图1所示。
实施例3:制作6H-SiC导通型衬底的GaN耿氏二极管。
步骤A,减薄衬底。
选用直径为2英寸的6H-SiC导通型衬底,对背面进行减薄,直至衬底厚度为150um。
步骤B,制作AlN成核层和下n+GaN阴极欧姆接触层。
在MOCVD反应室中,保持压力为60Torr、温度为650℃的条件下,同时通入三甲基铝与氮气,在6H-SiC导通型衬底上生长厚度为10nm的AlN成核层;继续采用MOCVD工艺,将温度升高到1100℃,保持压力为60Torr,再同时通入三甲基镓、氮气和n型掺杂源—硅烷,外延生长厚度为300nm,掺杂浓度为2×1018cm-3的下n+GaN阴极欧姆接触层。
步骤C,外延生长AlGaN电子发射层和上n+GaN阴极欧姆接触层。
在MOCVD反应室中,将压力升高到200Torr;在保持温度为1100℃的条件下,向MOCVD反应室中同时通入三甲基镓、氮气和三甲基铝;使三甲基铝的通入计量线性增加,外延生长厚度为200nm,Al组分浓度由0%线性渐变到20%的AlGaN电子发射层。降低压力为60Torr,再同时通入三甲基镓、氮气和n型掺杂源—硅烷,外延生长厚度为300nm,掺杂浓度为2×1018cm-3的上n+GaN阴极欧姆接触层。
步骤D,外延生长GaN notch层。
继续采用MOCVD的方式,将反应室中的气压下降到40Torr,同时通入三甲基镓、氮气和n型掺杂源—硅烷,在保持温度为1060℃的条件下,外延生长厚度为200nm,且无掺杂的GaN notch层。
步骤E,外延生长n-GaN渡越层和n+GaN阳极欧姆接触层。
在MOCVD反应室中,将气压上升到60Torr,同时向MOCVD反应室通入三甲基镓、氮气和n型掺杂源—硅烷,在保持温度为1100℃的条件下,外延生长厚度为2um,掺杂浓度为2×1017cm-3的n-GaN有源层;
继续采用MOCVD的方式,同时向MOCVD反应室通入三甲基镓、氮气和n型掺杂源—硅烷,在保持气压为60Torr,温度为1100℃的条件下,外延生长厚度为400nm,掺杂浓度为2×1018cm-3的n+GaN阳极欧姆接触层,形成GaN多层外延层。
步骤F,大圆形台面的形成。
利用光刻技术,在GaN多层外延层上形成直径为60um的大圆形掩膜图形;采用反应离子刻蚀技术,用BCl3/Cl2气体对GaN多层外延层进行刻蚀,刻蚀至露出6H-SiC导通型衬底表面为止,形成大圆形台面。
步骤G,小圆形台面的形成。
利用光刻技术,在大圆形台面上形成直径为20um的同轴小圆形台面掩膜图形;
采用反应离子刻蚀RIE技术,用BCl3/Cl2气体对大圆形台面进行刻蚀,刻蚀深度进入到下n+GaN阴极欧姆接触层中150nm,形成小圆形台面。
步骤H,圆形电极、环形电极和欧姆接触的形成。
采用真空电子束蒸发的方式,在经上述步骤处理后的样品表面依次蒸发Ti/Al/Ni/Au多层金属,其厚度分别为35nm/125nm/55nm/165nm;
采用金属剥离技术,形成圆形电极和环形电极。再在950℃温度的氩气气氛中,进行50秒钟的快速热退火处理,形成GaN欧姆接触。
步骤I,形成通孔和耿式二极管的阴极
首先,利用光刻技术,在6H-SiC导通型衬底的背面形成4个直径10um的通孔掩模图形;
接着,采用反应离子RIE刻蚀技术,用BCl3/Cl2气体对SiC衬底进行刻蚀,一直刻蚀至环形电极表面,形成通孔14;
接着,采用真空电子束蒸发的方式,在6H-SiC导通型衬底的背面依次蒸发厚度为35nm的Ti、125nm的Al、55nm的Ni以及200nm的Au;
接着,采用金属剥离技术,形成衬底电极,
最后,向通孔14中注入金属,将衬底电极与环形电极相连,构成GaN耿氏二极管的阴极。
步骤J,外延生长SiN钝化层。
采用PECVD的方式,同时通入的硅烷和氮气,在压力为60Torr、温度为1100℃的条件下,在经过上述步骤处理后的样品上外延生长厚度为400nm的SiN钝化层。
步骤K,形成耿式二极管阳极。
采用RIE刻蚀的方法,用CF4气体对SiN钝化层进行刻蚀,一直刻蚀至圆形电极表面形成开孔13,露出二极管的阳极,完成器件的制作,最终形成的耿氏二极管管芯剖面如图1所示。
基于notch结构的GaN耿氏二极管及制作方法专利购买费用说明
![]()
Q:办理专利转让的流程及所需资料
A:专利权人变更需要办理著录项目变更手续,有代理机构的,变更手续应当由代理机构办理。
1:专利变更应当使用专利局统一制作的“著录项目变更申报书”提出。
2:按规定缴纳著录项目变更手续费。
3:同时提交相关证明文件原件。
4:专利权转移的,变更后的专利权人委托新专利代理机构的,应当提交变更后的全体专利申请人签字或者盖章的委托书。
Q:专利著录项目变更费用如何缴交
A:(1)直接到国家知识产权局受理大厅收费窗口缴纳,(2)通过代办处缴纳,(3)通过邮局或者银行汇款,更多缴纳方式
Q:专利转让变更,多久能出结果
A:著录项目变更请求书递交后,一般1-2个月左右就会收到通知,国家知识产权局会下达《转让手续合格通知书》。
动态评分
0.0