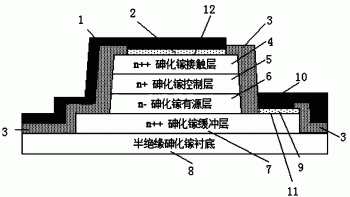
专利摘要
本发明公开一种强场负脉冲耿氏二极管,包括外延片,外延片包括自下而上依次设置的半绝缘砷化镓衬底、n++砷化镓缓冲层、n-砷化镓有源层、n+砷化镓控制层和n++砷化镓接触层,其中n-砷化镓有源层长5~10微米,掺杂浓度为5×1015~8×1015cm-3,本发明还公开一种强场负脉冲耿氏二极管的制备方法,利用适当的器件结构实现耿氏二极管工作于逆向耿氏偶极畴模式下,能够使现有耿氏二极管的输出功率和效率提高数倍,解决了目前耿氏二极管输出效率低下的问题。
权利要求
1.一种强场负脉冲耿氏二极管,其特征在于,包括外延片,外延片包括自下而上依次设置的半绝缘砷化镓衬底(8)、n++砷化镓缓冲层(7)、n-砷化镓有源层(6)、n+砷化镓控制层(5)和n++砷化镓接触层(4),所述n++砷化镓缓冲层(7)上表面设置有阳极欧姆接触层(9),阳极欧姆接触层(9)上表面设置有阳极引线(10),所述n++砷化镓接触层(4)上表面设置有阴极欧姆接触层(2),阴极欧姆接触层(2)上表面设置有阴极引线(1),所述外延片外层除半绝缘砷化镓衬底(8)的其余部分设置有Si3N4钝化层(3)。
2.根据权利要求1所述的强场负脉冲耿氏二极管,其特征在于,所述的n++砷化镓缓冲层(7)长600~850纳米,掺杂浓度为5×1018~9×1018cm-3。
3.根据权利要求1所述的强场负脉冲耿氏二极管,其特征在于,所述的n+砷化镓控制层(5)长600~1500纳米,掺杂浓度为1×1016~3×1016cm-3。
4.根据权利要求1所述的强场负脉冲耿氏二极管,其特征在于,所述的n-砷化镓有源层(6)长5~10微米,掺杂浓度为5×1015~8×1015cm-3。
5.根据权利要求1所述的强场负脉冲耿氏二极管,其特征在于,所述的n++砷化镓接触层(4)长600~900纳米,掺杂浓度为5×1018~9×1018cm-3。
6.一种强场负脉冲耿氏二极管的制备方法,其特征在于,制备得到一种逆向强场负脉冲耿氏二极管,包括外延片,所述外延片包括自下而上依次设置的半绝缘砷化镓衬底(8)、n++砷化镓缓冲层(7)、n-砷化镓有源层(6)、n+砷化镓控制层(5)和n++砷化镓接触层(4),所述n++砷化镓缓冲层(7)上表面设置有阳极欧姆接触层(9),阳极欧姆接触层(9)上表面设置有阳极引线(10),所述n++砷化镓接触层(4)上表面设置有阴极欧姆接触层(2),阴极欧姆接触层(2)上表面设置有阴极引线(1),所述外延片外层除半绝缘砷化镓衬底(8)的其余部分设置有Si3N4钝化层(3),具体按照以下步骤实施:
步骤1、制备外延片,在半绝缘砷化镓衬底(8)上依次外延生长n++砷化镓缓冲层(7)、n-砷化镓有源层(6)、n+砷化镓控制层(5)、n++砷化镓接触层(4),其中,所述的n++砷化镓缓冲层(7)长600~850纳米,掺杂浓度为5×1018~9×1018cm-3;所述的n+砷化镓控制层(5)长600~1500纳米,掺杂浓度为1×1016~3×1016cm-3;所述的n-砷化镓有源层(6)长5~10微米,掺杂浓度为5×1015~8×1015cm-3;所述的n++砷化镓接触层(4)长600~900纳米,掺杂浓度为5×1018~9×1018cm-3;
步骤2、清洗外延片,在外延片上匀一层9912光刻胶,经前烘、曝光、显影和后烘后,用湿法腐蚀,露出n++砷化镓接触层(7)的上表面,形成下台面(11),剥离光刻胶;
步骤3、清洗外延片,再次匀一层9912光刻胶,经前烘、曝光、显影和后烘后,用湿法腐蚀,露出半绝缘砷化镓衬底(8),形成器件间的电学隔离,去除光刻胶;
步骤4、清洗外延片,在外延片上用PECVD方法生长一层5000埃的Si3N4钝化层(3);
步骤5、清洗外延片,在外延片上匀一层9912光刻胶,利用RIE刻蚀设备在Si3N4钝化层(3)上且靠近n++砷化镓接触层(4)和n++砷化镓缓冲层(7)的上表面的位置分别刻孔,分别露出n++砷化镓接触层(4)和n++砷化镓接触层(7)的上表面,形成上台面(12)和下台面(11);
步骤6、清洗外延片,在外延片上依次蒸渡Ni/Ge/Au/Ge/Ni/Au,蒸发金属的厚度分别为40~50A,40~50A,600~620A,75~85A,25~35A,1500~2300A;
步骤7、在合金炉中合金,加热温度360~380℃,保持15~25s,在上台面(12)上形成阴极欧姆接触层(2),在下台面(11)上形成阳极欧姆接触层(9);
步骤8、清洗外延片,在外延片上匀一层9912光刻胶,经前烘、曝光、显影和后烘,分别露出合金电极层阴极欧姆接触层(2)和阳极欧姆接触层(9),溅射钛金起镀层,以制备阴极引线(1)和阳极引线(10);
步骤9、清洗外延片,在外延片上匀一层9920光刻胶,经前烘、曝光、显影和后烘,再匀打底胶和漂洗后,电镀3um软金,然后去掉9920胶;
步骤10、清洗外延片,在外延片上匀一层AZ5214光刻胶,然后前烘,曝光、反转、显影和后烘,经打底胶后用去金液漂洗,再用漂钛液漂洗15秒,最后用丙酮浸泡,去除AZ5214光刻胶,在阴极欧姆接触层(2)的上表面上制备得到阴极引线(1),在阳极欧姆接触层(9)的上表面上制备得到阳极引线(10),经上述工艺步骤,最终形成强场负脉冲耿氏二极管。
说明书
技术领域
本发明属于微波技术领域,具体涉及一种强场负脉冲耿氏二极管,本发明还涉及一种强场负脉冲耿氏二极管的制备方法。
背景技术
耿氏效应(Gunn effect)是1963年,由耿氏(J.B.Gunn)发现的一种效应。一定的恒定直流电压加到一小块N型砷化镓相对面的接触电极上时,便产生微波振荡。在N型砷化镓薄片的二端制作良好的欧姆接触电极,并加上直流电压使产生的电场超过3kV/cm时,由于砷化镓的负微分迁移率特性,就会产生电流振荡,其频率可达109Hz,这就是耿氏二极管。这种在半导体本体内产生高频电流的现象称为耿氏效应。
耿氏二极管存在多种工作模式,如延迟偶极畴模式,猝灭偶极畴模式,LSA模式等,其输出特性各有特点。耿氏二极管作为微波源器件,噪声低功率大使其获得广泛的应用,但效率低的特点一直是限制其应用的重要因素。目前耿氏二极管的效率处于大约10%的水平。如何产生更大功率和更高效率的耿氏器件一直是微波技术领域追求的方向。逆向偶极畴是一种全新的耿氏器件工作模式。在逆向模式下工作的逆向耿氏二极管其输出电脉冲效率远大于普通的耿氏二极管。
发明内容
本发明的目的是一种强场负脉冲耿氏二极管,利用适当的器件结构实现强场负脉冲耿氏二极管工作于逆向耿氏偶极畴模式下,能够使现有强场负脉冲耿氏二极管的输出功率和效率提高数倍,解决了目前耿氏偶极管输出效率低下的问题。
本发明的另一个目的是提供一种强场负脉冲耿氏二极管的制备方法。
本发明所采用的第一种技术方案是,一种强场负脉冲耿氏二极管,包括外延片,外延片包括自下而上依次设置的半绝缘砷化镓衬底、n++砷化镓缓冲层、n-砷化镓有源层、n+砷化镓控制层和n++砷化镓接触层,n++砷化镓缓冲层上表面设置有阳极欧姆接触层,阳极欧姆接触层上表面设置有阳极引线,n++砷化镓接触层上表面设置有阴极欧姆接触层,阴极欧姆接触层上表面设置有阴极引线,外延片外层除半绝缘砷化镓衬底的其余部分设置有Si3N4钝化层。
本发明所采用的第二种技术方案是,一种强场负脉冲耿氏二极管的制备方法,制备得到一种逆向强场负脉冲耿氏二极管,包括外延片,外延片包括自下而上依次设置的半绝缘砷化镓衬底、n++砷化镓缓冲层、n-砷化镓有源层、n+砷化镓控制层和n++砷化镓接触层,n++砷化镓缓冲层上表面设置有阳极欧姆接触层,阳极欧姆接触层上表面设置有阳极引线,n++砷化镓接触层上表面设置有阴极欧姆接触层,阴极欧姆接触层上表面设置有阴极引线,外延片外层除半绝缘砷化镓衬底的其余部分设置有Si3N4钝化层,具体按照以下步骤实施:
步骤1、制备外延片,在半绝缘砷化镓衬底上依次外延生长n++砷化镓缓冲层、n-砷化镓有源层、n+砷化镓控制层、n++砷化镓接触层,其中,n++砷化镓缓冲层长600~850纳米,掺杂浓度为5×1018~9×1018cm-3;n+砷化镓控制层长600~1500纳米,掺杂浓度为1×1016~3×1016cm-3;n-砷化镓有源层长5~10微米,掺杂浓度为5×1015~8×1015cm-3;n++砷化镓接触层长600~900纳米,掺杂浓度为5×1018~9×1018cm-3;
步骤2、清洗外延片,在外延片上匀一层9912光刻胶,经前烘、曝光、显影和后烘后,用湿法腐蚀,露出n++砷化镓接触层的上表面,形成下台面,剥离光刻胶;
步骤3、清洗外延片,再次匀一层9912光刻胶,经前烘、曝光、显影和后烘后,用湿法腐蚀,露出半绝缘砷化镓衬底,形成器件间的电学隔离,去除光刻胶;
步骤4、清洗外延片,在外延片上用PECVD方法生长一层5000埃的Si3N4钝化层;
步骤5、清洗外延片,在外延片上匀一层9912光刻胶,利用RIE刻蚀设备在Si3N4钝化层上且靠近n++砷化镓接触层和n++砷化镓缓冲层上表面的位置分别刻孔,分别露出n++砷化镓接触层和n++砷化镓接触层的上表面,即形成上台面和下台面;
步骤6、清洗外延片,在外延片上依次蒸渡Ni/Ge/Au/Ge/Ni/Au,蒸发金属的厚度分别为40~50A,40~50A,600~620A,75~85A,25~35A,1500~2300A;
步骤7、在合金炉中合金,加热温度360~380℃,保持15~25s,在上台面上形成阴极欧姆接触层,在下台面上形成阳极欧姆接触层;
步骤8、清洗外延片,在外延片上匀一层9912光刻胶,经前烘、曝光、显影和后烘,分别露出合金电极层阴极欧姆接触层和阳极欧姆接触层,溅射钛金起镀层,以制备阴极引线和阳极引线;
步骤9、清洗外延片,在外延片上匀一层9920光刻胶,经前烘、曝光、显影和后烘,再匀打底胶和漂洗后,电镀3um软金,然后去掉9920胶;
步骤10、清洗外延片,在外延片上匀一层AZ5214光刻胶,然后前烘,曝光、反转、显影和后烘,经打底胶后用去金液漂洗,再用漂钛液漂洗15秒,最后用丙酮浸泡,去除AZ5214光刻胶,在阴极欧姆接触层的上表面上制备得到阴极引线,在阳极欧姆接触层的上表面上制备得到阳极引线,经上述工艺步骤,最终形成强场负脉冲耿氏二极管。
本发明的特点还在于,
n++砷化镓缓冲层长600~850纳米,掺杂浓度为5×1018~9×1018cm-3。
n+砷化镓控制层长600~1500纳米,掺杂浓度为1×1016~3×1016cm-3。
n-砷化镓有源层长5~10微米,掺杂浓度为5×1015~8×1015cm-3。
n++砷化镓接触层长600~900纳米,掺杂浓度为5×1018~9×1018cm-3。
本发明建立在申请人新发现的逆向耿氏偶极畴理论基础上,利用砷化镓,LnP,GaN等具有负微分迁移率的半导体,制成的强场负脉冲耿氏二极管。与目前的耿氏器件相比(在此称之为正向畴器件),所产生的电流波形相反。正向耿氏畴器件产生的典型波形为直流电流上周期性的出现电流尖峰,而逆向耿氏偶极畴器件产生的电流为直流电流上周期性的出现向下的电场尖峰,将直流电流分割成类似方波的平顶脉冲串。由此引起的有效微波输出效率则恰好为正向耿氏偶极畴的无效直流分量,当正向偶极畴器件输出功率为10%时,逆向耿氏偶极畴器件工作效率理论上可达90%。逆向耿氏偶极畴二极管可获得远大于正向耿氏偶极畴器件的微波输出功率。可广泛应用于天线、雷达、开关电源等领域。
附图说明
图1是本发明强场负脉冲耿氏二极管的结构示意图;
图2是本发明强场负脉冲耿氏二极管的平面结构示意图;
图3是本发明强场负脉冲耿氏二极管的工作原理图。
图中,1.阴极引线,2.阴极欧姆接触层,3.Si3N4钝化层,4.n++砷化镓接触层,5.n+砷化镓控制层,6.n-砷化镓有源层,7.n++砷化镓缓冲层,8.半绝缘砷化镓衬底,9.阳极欧姆接触层,10.阳极引线,11.下台面,12.上台面。
具体实施方式
下面结合附图和具体实施方式对本发明进行详细说明。
本发明是提供一种强场负脉冲耿氏二极管,包括外延片,所述外延片包括自下而上依次设置的半绝缘砷化镓衬底8、n++砷化镓缓冲层7、n-砷化镓有源层6、n+砷化镓控制层5和n++砷化镓接触层4,n++砷化镓缓冲层7上表面设置有阳极欧姆接触层9,阳极欧姆接触层9上表面设置有阳极引线10,n++砷化镓接触层4上表面设置有阴极欧姆接触层2,阴极欧姆接触层2上表面设置有阴极引线1,外延片外层除半绝缘砷化镓衬底8的其余部分设置有Si3N4钝化层3,其中,n++砷化镓缓冲层7长600~850纳米,掺杂浓度为5×1018~9×1018cm-3;n-砷化镓有源层6长5~10微米,掺杂浓度为5×1015~8×1015cm-3;n+砷化镓控制层5长600~1500纳米,掺杂浓度为1×1016~3×1016cm-3;n++砷化镓接触层4长600~900纳米,掺杂浓度为5×1018~9×1018cm-3。
本发明还提供一种强场负脉冲耿氏二极管的制备方法,制备得到一种逆向强场负脉冲耿氏二极管,包括外延片,所述外延片包括自下而上依次设置的半绝缘砷化镓衬底8、n++砷化镓缓冲层7、n-砷化镓有源层6、n+砷化镓控制层5和n++砷化镓接触层4,n++砷化镓缓冲层7上表面设置有阳极欧姆接触层9,阳极欧姆接触层9上表面设置有阳极引线10,n++砷化镓接触层4上表面设置有阴极欧姆接触层2,阴极欧姆接触层2上表面设置有阴极引线1,外延片外层除半绝缘砷化镓衬底8的其余部分设置有Si3N4钝化层3,具体按照以下步骤实施:
步骤1、制备外延片,在半绝缘砷化镓衬底8上依次外延生长n++砷化镓缓冲层7、n-砷化镓有源层6、n+砷化镓控制层5、n++砷化镓接触层4,其中,n++砷化镓缓冲层7长600~850纳米,掺杂浓度为5×1018~9×1018cm-3;n+砷化镓控制层5长600~1500纳米,掺杂浓度为1×1016~3×1016cm-3;n-砷化镓有源层6长5~10微米,掺杂浓度为5×1015~8×1015cm-3;n++砷化镓接触层4长600~900纳米,掺杂浓度为5×1018~9×1018cm-3;
步骤2、清洗外延片,在外延片上匀一层9912光刻胶,经前烘、曝光、显影和后烘后,用湿法腐蚀,露出n++砷化镓接触层7的上表面,形成下台面11,剥离光刻胶;
步骤3、清洗外延片,再次匀一层9912光刻胶,经前烘、曝光、显影和后烘后,用湿法腐蚀,露出半绝缘砷化镓衬底8,形成器件间的电学隔离,去除光刻胶;
步骤4、清洗外延片,在外延片上用PECVD方法生长一层5000埃的Si3N4钝化层3;
步骤5、清洗外延片,在外延片上匀一层9912光刻胶,利用RIE刻蚀设备在Si3N4钝化层3上且靠近n++砷化镓接触层4和n++砷化镓缓冲层7上的位置分别刻孔,分别露出n++砷化镓接触层4和n++砷化镓接触层7的上表面,即形成上台面12和下台面11;
步骤6、清洗外延片,在外延片上依次蒸渡Ni/Ge/Au/Ge/Ni/Au,蒸发金属的厚度分别为40~50A,40~50A,600~620A,75~85A,25~35A,1500~2300A;
步骤7、在合金炉中合金,加热温度360~380℃,保持15~25s,在上台面12上形成阴极欧姆接触层2,在下台面11上形成阳极欧姆接触层9;
步骤8、清洗外延片,在外延片上匀一层9912光刻胶,经前烘、曝光、显影和后烘,分别露出合金电极层阴极欧姆接触层2和阳极欧姆接触9,溅射钛金起镀层,以制备阴极引线1和阳极引线10;
步骤9、清洗外延片,在外延片上匀一层9920光刻胶,经前烘、曝光、显影和后烘,再匀打底胶和漂洗后,电镀3um软金,然后去掉9920胶;
步骤10、清洗外延片,在外延片上匀一层AZ5214光刻胶,然后前烘,曝光、反转、显影和后烘,经打底胶后用去金液漂洗,再用漂钛液漂洗15秒,最后用丙酮浸泡,去除AZ5214光刻胶,在阴极欧姆接触层2的上表面上制备得到阴极引线1,在阳极欧姆接触层9的上表面上制备得到阳极引线10,经上述工艺步骤,最终形成强场负脉冲耿氏二极管。
在保持控制层掺杂浓度为有源层掺杂浓度2-5倍的比例下,可以对控制层、有源层掺杂浓度以及厚度进行不同的改动,各种改动均视为本发明保护范围。不同的浓度和厚度能够改变本发明器件的输出频率、功率及效率等指标。
本发明的关键参数是控制层掺杂浓度和有源层掺杂浓度,以及两者之间的控制层掺杂浓度高于有源层掺杂浓度的大小关系,以及适当的比例关系。与常规的耿氏二极管相比,强场负脉冲耿氏二极管的关键区别在于有源层掺杂浓度高于控制层掺杂浓度,这与常规耿氏二极管恰好相反。有源层掺杂浓度范围在5×1015~8×1015之间,与其匹配的控制层掺杂浓度为有源层掺杂浓度的2-5倍。采用较低的掺杂浓度时器件发热小,稳定,但输出电流低,有源区采用较高掺杂浓度时器件输出功率高,但发热量随之增大。
图3为本发明工作原理图,其中,a)图为器件结构示意图,b)图为砷化镓速场特性曲线,c)图为器件内电场演化原理图,E*1为逆向畴内电场,Ep为负微分迁移率起始电场,Eb为偏置电场,E2为逆向畴畴外电场,d)图为器件内电位演化原理图,t1曲线和t2曲线分别为t1时刻和t2时刻器件内的电位分布;在负微分迁移率半导体中,为了分析方便,忽略位移电流,并假定空间电荷层沿着载流子输运方向仅有极小的延伸。在图3中,设光生电子空穴对的初始分离引起的微小电场屏蔽区如图1(b)中曲线t1所示。设偏置电场Eb在负微分电导区并大于Ep,当器件内存在一个低阻区时,电场分布如图3(c)中曲线t1所示,电场屏蔽区左侧为电子积累层,右侧为耗尽层。积累层和耗尽层之间的电场与偏置电场相反,形成反向增长的偶极畴电场。
此过程可用以下公式描述:
砷化镓的速场特性可以用下式表示:
v=(μ1E+vv(E/Ea)4)/(1+(E/Ea)4) (1)
其中E为砷化镓内电场,Vv为砷化镓电子饱和漂移速度,取值8.5×106cm/s,Ea为砷化镓负微分电导率起始电场,U1为砷化镓低场迁移率。在忽略扩散的条件下,载流子连续性方程如下:
其中n(x,t)为电子浓度,Jn(x,t)为电子电流密度,e为电子电量。将电流密度
Jn(x,t)=eμnn(x,t)E(x,t) (3)
带入(2)式可得:
其中μn为电子迁移率,E(x,t)为电场强度。根据边界条件t=t0n(x,t)=n(x,t0),方程(4)的解为:
在瞬态条件下,(5)式可表达为:
并根据泊松方程:
此处Δn(x,t)=n(x,t)-p(x,t),p(x,y)为空穴浓度。将(6)(7)带入(5)可得:
(8)式中,等式右侧第一项表示电子非均匀空间分布在输运过程中引起的电子浓度的变化,第二项表示电子在τ为负值时,由于负微分迁移率引起的电子浓度的空间指数积累。
上述理论推导表明,在砷化镓材料内,电场处于负微分电导区时,任何电子的空间微扰都会引起电子在空间的指数积累。当逆向强场负脉冲耿氏二极管内空间存在如图3(c)所示的空间电荷控制区时,低于平均偏置电场的控制区引起该区域电子漂移速度加快,形成向前积累的偶极畴,此偶极畴积累层在前而耗尽层在后,与常规的偶极畴恰好相反,称之为逆向畴。逆向畴形成的畴电场与偏置电场反向,并以指数规律反向增长。
当逆向偶极畴增长至畴外电流与畴内电流相等(图3(b)中J1点),或者电子扩散与电子在畴内积累相平衡时,逆向偶极畴的生长停止。由于逆向偶极畴的存在,当逆向偶极畴漂移至阳极被阳极吸收,会形成一个反向电流,将直流信号短暂的截断,使输出电流呈现类似方波的脉冲串。此脉冲串输出的有效微波功率恰好是现有耿氏偶极畴器件的无效功率部分,现有耿氏偶极二极管效率约为10%,而逆向强场负脉冲耿氏二极管的效率可达80%以上。使输出微波功率提高8倍。这对现有的各类基于强场负脉冲耿氏二极管的微波源都具有极大的价值。可应用于超宽带天线技术、微波技术、开关电源技术等技术领域。
本发明提供的强场负脉冲耿氏二极管,为了逆向畴的充分生长,逆向强场负脉冲耿氏二极管的工作电场大于20kV/cm。这对常规耿氏二极管通常早已击穿。
一种强场负脉冲耿氏二极管及其制备方法专利购买费用说明
![]()
Q:办理专利转让的流程及所需资料
A:专利权人变更需要办理著录项目变更手续,有代理机构的,变更手续应当由代理机构办理。
1:专利变更应当使用专利局统一制作的“著录项目变更申报书”提出。
2:按规定缴纳著录项目变更手续费。
3:同时提交相关证明文件原件。
4:专利权转移的,变更后的专利权人委托新专利代理机构的,应当提交变更后的全体专利申请人签字或者盖章的委托书。
Q:专利著录项目变更费用如何缴交
A:(1)直接到国家知识产权局受理大厅收费窗口缴纳,(2)通过代办处缴纳,(3)通过邮局或者银行汇款,更多缴纳方式
Q:专利转让变更,多久能出结果
A:著录项目变更请求书递交后,一般1-2个月左右就会收到通知,国家知识产权局会下达《转让手续合格通知书》。
动态评分
0.0