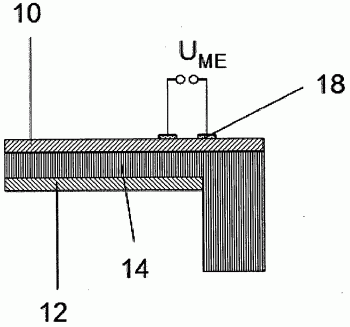
专利摘要
本发明提出一种新型的磁电传感器,该磁电传感器能够以薄层技术的已知方法制造并且对于预先确定的磁场比已知的弯曲梁传感器输出高出多倍的ME电压。称为分离层ME传感器的构造的特征在于铁电的(10)和磁致伸缩的相(12)之间的厚的介电层(14)的配置结构以及在一侧施加在铁电体(10)上的电极配置结构(18),该电极配置结构构造用于沿着层延展获取ME电压。以有利的方式,该构造可以通过对常规的介电基底(14)在前侧和背侧上涂敷各一个功能层(10、12)容易地制造。
权利要求
1.磁电(ME)传感器,其包括由磁致伸缩层(12)、铁电层(10)和介电载体层(14)构成的层堆叠,其特征在于,
a.载体层(14)比铁电层(10)厚,并且
b.载体层(14)设置在磁致伸缩层(12)和铁电层(10)之间,并且
c.在铁电层(10)上设置有电极配置结构(18),该电极配置结构构造用于沿着层延展获取信号电压,其中,
d.电极配置结构(18)的指间距大于铁电层(10)的厚度。
2.按照权利要求1所述的ME传感器,其特征在于,所述电极配置结构(18)的指间距大于所述载体层(14)的厚度。
3.按照权利要求1或2所述的ME传感器,其特征在于,所述载体层(14)由具有大于20GPa的弹性模量的材料构成。
4.按照权利要求1、2或3所述的ME传感器,其特征在于,所述载体层(14)由玻璃、优选由二氧化硅、陶瓷或半导体、优选由硅构成。
5.按照上述权利要求之一所述的ME传感器,其特征在于,所述铁电层(10)由锆钛酸铅(PZT)构成。
6.按照上述权利要求之一所述的ME传感器,其特征在于,所述磁致伸缩层(12)由非结晶磁性材料类构成。
7.用于制造按照上述权利要求之一所述的ME传感器的方法,具有如下步骤:
a.将构成铁电层(10)的材料施加到介电基底(14)的第一平坦侧上,
b.在温度超过500℃时使材料结晶,同时构成铁电层(10),该铁电层的厚度小于所述基底(14)的预先已知的厚度,
c.将构造用于沿着层延展获取信号电压的电极配置结构(18)施加到所述铁电层(10)上,其中指间距大于所述铁电层(10)的厚度,
d.将磁致伸缩层(12)施加到所述基底(14)的第二平坦侧上,
e.在温度低于500℃时对所述磁致伸缩层(12)进行磁极化,并且
f.在温度处于所述铁电层(10)的居里温度之下时沿着层延展交替地对所述铁电层(10)进行电极化。
8.按照权利要求7所述的方法,其特征在于,所述磁致伸缩层(12)作为多层式层系统沉积在基底上。
9.按照权利要求8所述的方法,其特征在于,所述磁致伸缩层(12)利用由反铁磁的和铁磁的材料构成的彼此交替的层构成并且在预先确定的磁场中经受热处理以构成交换偏置。
说明书
技术领域
本发明涉及一种用于测量磁场的磁电(ME)传感器,该磁电传感器包括由磁致伸缩层、铁电层和不导电的(即介电的)载体层构成的层堆叠。
背景技术
磁电复合体数年以来是传感机构的研究领域中的重心,其目的是测量非常小的、通常与时间相关的磁场。磁电复合体包括磁致伸缩的和压电的相。铁电体也视为压电材料。
磁场H引起磁致伸缩的相的长度变化,该长度变化通过机械耦合传递到压电体上并且在那里产生机械的拉应力或剪应力。通过压电电压常数g在压电材料中引起介电的极化,该极化宏观地产生可测量的磁电电压UME。在这里可获得的电压UME(即也是ME电压)直接与压磁系数dm、压电电压常数g、两个相k的耦合和压电材料的层厚z成正比(方程1)。
通常磁电复合体以简单的平板电容器的型式设计构造。在这里,压电材料(例如氮化铝、AlN,锆钛酸铅、PZT)作为介电体处于两个作为电极起作用的导电层之间。通常磁致伸缩的相构造为至少其中一个电极,如果本来应该使用金属的磁致伸缩的材料的话。金属材料的优点在于磁致伸缩效果的特性。最高的压磁系数在金属的、非结晶的材料,如 (FeCoSiB)中可见。
此外已知的是,将磁电复合体设计构造为薄层复合体,所述薄层复合体通常作为其他构件具有用于功能层的载体。这样的复合体的使用在要求的结构尺寸小时并且用于制造传感器阵列是有利的。在此,另一个优点在于放弃在其他情况下在紧凑材料中通常的连接技术的胶粘技术。借助胶粘层取消所述相之间的分界面上的层,该层可能部分吸收磁致伸缩的长度变化。由此,此外也改进薄层ME传感器的可重复性。
薄层ME传感器经常构造为一侧夹紧的弯曲梁。在此示出,以谐振运行的弯曲梁由于高性能具有非常高的磁电电压(H.Greve,E.Woltermann,H.-J.Quenzer,B.Wagner,and E.Quandt,"Giant magnetoelectric coefficients in(Fe90Co10)78Si12B10-AlN thin film composites",Applied Physics Letters,vol.96,2010,p.182501)。
在图1中勾画按照现有技术的ME弯曲梁传感器。在一侧固定的基底条14上首先设置有下电极16,在该下电极上设置有压电层10并且又在该压电层上设置有金属的磁致伸缩层12。ME电压UME正如画出的那样在下电极16和磁致伸缩层12之间获取。
按照图1的弯曲梁传感器的制造以微观系统工程学的方法进行。典型的基底14是硅晶片,各个层以已知的方法如阴极溅射(喷镀)或气相沉积(physical vapour deposition、PVD)或溶胶-凝胶(Sol-Gel)方法施加到所述硅晶片上。涂敷的晶片通常平版印刷地结构化,然后紧接着分离真正的弯曲梁。
在薄层ME传感器中,基底14构成前序部分中提及的层堆叠的集成的组成部分,因为功能层(铁电、磁致伸缩)10、12由于它们的小厚度不能自承载。前序部分中提及的载体层可以以基底14标识。
正如已经解释的那样,可测量的ME电压与激励的磁场强度的比例与压电体的层厚或压电相上的电极的间距成比例。因此,通过预先确定的磁场强度度引起的ME电压可以简单地通过增大压电体的层厚来增大。
但关于薄层ME传感器,在利用微观系统技术的通常方法时,该方式受限制。此外,由内应力和小的沉积速率产生限制。
备选方案从文献US 2008/0193780A1得出。提出一种按照层堆叠(Layer Stack)的结构型式的ME传感器,其核心构成环氧化物基质中的平行延伸的铁电纤维(在那里例如锆钛酸铅、PZT)的配置结构。在这样构成的层形的铁电复合体的两个平坦侧上分别设置有一个叉指电极(IDT)、一个作为电绝缘体的薄的聚合物膜(参看在那里的图2、28A和28B以及段落0057“insulating field”)和一个金属的磁致伸缩层( )。电极的配置结构在此这样进行,即,具有相同极性的电极指直接相叠地靠置。通过极化,铁电复合体的极化矢量可以沿着纤维方向(纵向)在相反极性的相邻电极指之间空间上交替地取向。该文献说明“推拉单元(push-pull units)”并且在此参阅那里的图2的局部放大图200。
通过IDT获取信号原则上允许:通过选择电极的指间距来确定用于预定的磁场的ME电压有多大。原则上适用:指间距越大,则ME电压越大。
为了避免误解,应该在这里并且在下面澄清:电极配置结构的指间距表示两个不相互触点接通的电极的最小间距亦或备选地表示这一路段的长度,在该路段上在施加预先确定的电压到电极上时存在最大的电场强度。特别涉及叉指电极地,电极的相啮合的指并且因此到处相同地存在的指间距对本领域技术人员也作为概念而常见。
按照US 2008/0193780A1的ME传感器几乎不可以称为薄层ME传感器,因为铁电复合体的厚度必须至少相应于以100至350μm给出的铁电纤维的厚度。复合板似乎是自承载的,并且它在两侧以聚合物膜遮盖,该聚合物膜按照所有外观已经载有一对叉指电极。两侧的触点接通也许用于在必需的电极化期间在厚的复合板内部产生较均一的场分布。以25μm的层厚施加到聚合物膜上的磁致伸缩的材料应当在那里在涂敷时不产生高的温度或者经受高的温度,因为否则聚合物可能受到损害。US 2008/0193780A1的传感器的制造总体上看来是有问题的或至少是耗费的并且与大量生产证实的方法不兼容。
作为现有技术的其他文件此外给出文献US 2007/252593A1、US2011/077663A1、JP 11126449A和US 2008/145693A1。
如果考虑沿着铁电层的延展获取ME电压的构思并且将其转用到ME传感器、尤其是以微观系统技术通用的方法可制造的薄层ME传感器上,则存在更多问题。
ME传感器的典型的铁电层是陶瓷的并且通常以也包含有机材料(例如在溶胶-凝胶-方法或丝网印刷中)的Precursor的形式涂敷到基底上。在温度超过500℃时的热处理中,该层热解和结晶。该铁电层的制造可以备选地通过阴极溅射或脉冲的激光沉积来进行。但在这些情况下沉积也在温度较高时进行,并且需要随后的超过500℃的热处理用于结晶。
通过构造用于沿着层延展获取电压的电极取代常规的下电极不予考虑,因为因此必须考虑,铁电体的结晶由于存在的结构化的电极层(例如由贵金属铂或金制成)受干扰。但为了可以将这样的电极在铁电体结晶之后设置在铁电层上,该铁电层必须具有露出的外面。
容易想到,将层配置结构的次序反转,即首先将磁致伸缩的材料施加到基底上并且又将铁电体施加到该磁致伸缩的材料上。这也可以称为倒转的层顺序。
磁致伸缩的材料仍需要磁各向异性,以便完全具有磁致伸缩特性。当磁致伸缩的材料在受控制的条件下在磁场中沉积或事后在磁场中热处理时,例如可以引起磁各向异性。另一种可能性从(至今未公开的)EP 11171354.1得出。此后,磁致伸缩层制造为由交替的铁磁的(FM)和反铁磁的(AFM)层构成的多层式层系统,在该多层式层系统中可以构成交换偏置(Exchange Bias)。AFM层的可调节的取向这样“抑制住(pinnt)”FM层的磁偶极,使得在不存在在其他情况下用于设立适当的工作点需要的偏置(Bias)磁场的情况下沿着可确定的方向在各层中也产生高的压磁系数。使用按照EP 11171354.1的多层式层系统被视为非常有利对于制造传感器阵列,因为在各个传感器之间的磁相互作用非常小并且这些传感器因此不相互干扰。
当然对于上面提到的磁致伸缩层完全不能使这些层经受用于使陶瓷铁电体结晶必需的温度,因为所述层由此可能受到持久的损害。例如可能在使用多层时由于扩散破坏层构造或者在非结晶的层中在温度提高时进行结晶。
甚至当具有倒转的层顺序(如上所述)的ME传感器的构造实现时,最迟在以叉指电极或类似物对铁电层进行电极化时存在问题,即,电极的明显扩大的指间距也要求施加相应增大的电压,因此达到106和107V/m之间的必需的电场强度。在具有几微米范围内的层厚的薄层ME传感器中这是非常有问题的,因为磁致伸缩的材料以小间距对置于铁电层的一侧上的电极配置结构,所述磁致伸缩的材料通常是金属的并且因此使电场强烈失真。这样几乎不能实现铁电体的可良好重复的或甚至均匀的极化。如果电压选择过大并且因此通过磁致伸缩层最后可能闭合电路,相反甚至必须考虑铁电体的电击穿。
发明内容
在这种背景下本发明的任务是,提出一种新型的ME传感器,该ME传感器与常规的弯曲梁传感器相比能实现获取明显更高的ME电压并且同时以常规的涂敷方法可制造。
该任务通过一种磁电传感器得以解决,该磁电传感器包括由磁致伸缩层、铁电层和不导电的载体层构成的层堆叠,其特征在于,载体层比铁电层厚并且设置在磁致伸缩层和铁电层之间,并且此外在铁电层上设置有电极配置结构,该电极配置结构构造用于沿着层延展获取信号电压,其中,电极配置结构的指间距大于铁电层的厚度。
从属权利要求给出按照权利要求1的ME传感器的有利构造方案或者提供一种制造方法。
本发明的基本构思在于,将ME传感器的两个功能层在空间上彼此分开,其方式是,将由介电材料构成的层设置在两者之间。各功能层的间距在此应该比铁电层的厚度大、优选大多倍。由此,各功能层之间的介电层不仅具有电绝缘的目的而且具有间隔保持的目的。新的ME传感器的功能层两个都是层堆叠的外层。对于新的ME传感器设计提出并且此外使用概念分离层ME传感器(“separator ME sensor”,SMES)。
就此否定至今通用的观点,即,只有当磁致伸缩的和压电的相非常靠近或甚至直接彼此重叠地设置时,磁电复合体才可能示出良好的ME传感器特性。正如实验示出的那样,磁致伸缩层的应沿着层延展进行的长度变化能够轻易地也穿过厚的分离层传递到铁电层上。
可以将磁致伸缩层视为机械的剪切波(连续地或脉冲地)的发射极,该剪切波传播通过分离层并且在构成电极化的情况下在铁电层中被吸收。虽然在此考虑衰减损耗,但运输的机械能总是还足以与用于获取ME电压的电极配置结构的现在扩大的指间距相互作用针对相同的磁场强度获得比现有技术中明显更强的信号。
众所周知,层界限上的高机械阻力对比不利于机械能传递。介电分离层因此应该在其质量密度和音速方面与功能层至少是类似的。优选所述介电分离层具有不太小的弹性模量。就这点而言,实际上所有聚合物不被考虑作为分离层材料。这也是与US 2008/0193780A1的教导的重要区别,该教导将薄的聚合物膜设置在功能层之间,以便载有IDT并且使其电绝缘。关于通过该膜的机械能运输的效率,该文献没有报告,尽管这看起来不是当然的。聚合物作为陶瓷铁电体的载体本来是不合适的,因为聚合物不能经受层的结晶。分离层材料的弹性模量应该优选大于20GPa。
以有利的方式,常规的基底最好适合作为介电分离层,用于ME传感器的功能层沉积在所述基底上。优选这些基底由玻璃、尤其是二氧化硅、陶瓷(例如氧化铝,Al2O3)构成或者由半导体、例如硅晶片构成。例如硅的弹性模量为107GPa,SiO2的弹性模量为94GPa。
因此,对于分离层ME传感器的制造完全不需要特意制造分离层。相反可以对常规的基底简单地在两个平坦侧上以两个功能层中各一个功能层涂敷,从而基底本身为分离层。在此,基底的厚度是预先已知的并且通常与所述一个功能层的厚度相比大非常多。所述基底的厚度通常为大约50和500μm之间、优选100和200μm之间。功能层的厚度通常处于小一个数量级。
将用于沿着层延展获取电压的电极配置结构施加到基底的以铁电体、优选锆钛酸铅(PZT)涂敷的平坦侧上,所述电极配置结构的指间距大于铁电层的厚度、优选甚至大于分离层的厚度。电极的指间距由此比在按照现有技术的弯曲梁传感器中更大、优选甚至大至少一个数量级,在现有技术中电极仅恰好通过铁电的层厚间隔开。
原则上,可设立的指间距向上仅由完成的传感器的尺寸限制。当然在指间距处于毫米范围内的情况下已经有必要以千伏电压对铁电体进行极化。通常将这在油浴中进行,因此不会由于空气构成弧光。优选由非结晶磁性材料构成的并且具有金属导电性的磁致伸缩层还在极化之前设置在基底的第二平坦侧上,因为磁致伸缩层的磁各向异性的设立要求在磁场(“field annealing”)中以典型250-350℃的热处理。电极化又要求铁电体的居里温度之下的温度,从而电极化在传感器制造的热顺序中必须构成最后的步骤。由此在极化时,导体已经处于基底(分离层)的另一侧上,该导体使场在那里塌陷。因此,极化电压的一部分也跨越介电分离层降低,并且这部分应不导致电击穿。但幸好通用的基底的击穿场强非常高,例如对于硅大约为30MV/m并且对于SiO2直到1GV/m。
无问题地可能的是,制造分离层ME传感器,所述分离层ME传感器在铁电层上具有构造用于获取信号电压的电极配置结构,当处于功能层之间的介电分离层为100μm或更厚时,所述电极配置结构具有数毫米范围内的指间距。
附图说明
下面借助附图和实施例进一步说明本发明。
其中示出:
图1按照现有技术的平板电容器设计中的磁电弯曲梁传感器的示意图;
图2作为分离层ME传感器的磁电弯曲梁传感器的示意图;
图3对于分离层ME传感器(图2,fR≈1100Hz)和按照现有技术的传感器(图1,fR≈2390Hz)在共振情况下用于弯曲梁的ME电压的测量曲线。
具体实施方式
在图1中可看出按照现有技术的弯曲梁传感器的示意图,其已经进一步在上面解释。分离层ME传感器为了对照在图2中勾画。铁电层10和磁致伸缩层12在这里处于同一基底14的对置的平坦侧上。基底材料构成分离层14,该分离层在图2中不符合比例地示出。实际上分离层14典型地比每个所述功能层10、12厚一个数量级。用于获取ME电压的电极配置结构18只设置在外面上(在铁电层10的上侧上)并且测量沿着层延展产生的电压。当在磁致伸缩层12中由于沿着所述层起作用的磁场产生长度变化时,这些电压在铁电体10中产生,所述长度变化然后传递到分离层14上并且传递到铁电层12上。
用于制造分离层ME传感器的方法可以以如下步骤实施:
1.将构成铁电层10的材料(例如离心涂镀溶胶-凝胶-前体(Sol-Gel-Precursor)或阴极溅射铁电体)施加到介电基底14的第一平坦侧上,
2.在温度超过500℃时,使所述材料结晶,同时构成铁电层10,该铁电层的厚度小于基底14的预先已知的厚度,
3.将构造用于沿着层延展获取信号电压的电极配置结构18(例如通过在利用平版印刷的遮盖的情况下喷镀铂)施加到铁电层10上,其中指间距大于铁电层10的厚度,
4.将磁致伸缩层12施加到基底14的第二平坦侧上,
5.在温度低于500℃时,对磁致伸缩层12进行磁极化(“field annealing”),并且
6.在温度处于铁电层10的居里温度之下时,沿着层延展交替地对铁电层10进行电极化。
交替地进行电极化在此理解为,在极化过程结束时在不同极性的每两个相邻电极指之间在铁电层平面中产生极化矢量,所述极化矢量交替以相反的(交替的)方向示出(参考“push-pull units”,US2008/0193780A1)。
上述方法在步骤2、5和6中具有三个热处理。在此重要的是,以下降的次序经过相应的最高温度。步骤4和5也能够同时实施,这对本领域技术人员是已知的。
分离层ME传感器作为实施例可如下制造:
作为基底例如使用包括热氧化的二氧化硅层的硅晶片(525μm厚)。首先将作为扩散势垒的二氧化锆层和晶核开始层并且之后将PZT层分别借助溶胶-凝胶方法施加到所述氧化层上。借助光刻法将一对常规的叉指电极(例如在这里具有指间距5-20μm)和接下来的金的阴极溅射施加到在大约700℃时结晶的PZT层(厚度1-2μm)上。此后所述基底机械地通过磨削和对基底背侧的抛光变薄到大约150-200μm的剩余厚度。磁致伸缩层 (FeCoSiB)(厚度大约4μm)通过阴极溅射施加到该抛光的、非常光滑的背侧上。最后通过锯削分离所述梁。
此外为了对照,由相同的材料产生平板电容器设计中的常规的弯曲梁传感器(如图1中那样)。在两种情况下,磁致伸缩层在施加之后在温度明显处于500℃之下时、典型地在250℃和350℃之间的温度间隔中磁性极化,用于设立磁各向异性。
在梁作为磁电传感器可用之前,必须进行铁电的PZT层的电极化。在这里层复合体加热到大约140℃并且在此在两种情况下施加10MV/m的电场(例如在用于分离层ME传感器的指间距为20μm时具有电压200V或者在用于平板电容器设计中的弯曲梁传感器的PZT层厚为2.5μm时具有大约25V)。在温度恒定情况下15分钟之后进行冷却到室温。在这里也保持电场的施加。在极化步骤之后所述传感器可用。
图3示出传感器的磁电电压输出,这时施加待测量的磁场,该磁场具有幅值1Oe和在弯曲梁的机械的谐振频率范围内的频率(该谐振频率与构造相关地在这里区分)。分离层ME传感器的ME信号(上面的图)大约比平板电容器设计中的常规的弯曲梁传感器的ME电压信号大因数5-6(下面的图)。
按照本发明的传感器设计的优点在于:
1.可能的是,恰好正如在用于按照图1的弯曲梁传感器的常规制造方法中那样,在铁电层结晶之后才将磁致伸缩层置于基底上。倒转的层顺序的所反应缺点没有出现。
2.铁电层具有外面,任意的电极配置结构可以施加到所该外面上,该电极配置结构能实现沿着层获取电压。这可以在最简单的情况下是一对叉指电极(IDT),但也可考虑两个相互触点接通的IDT,这两个IDT包括在其指之间延伸的、弯曲形的对应电极。在该构造方案中,无论如何都是非常自由的。
3.因为可以按照喜好设立电极的指间距,所以现时在传感器制造时具有自由度,该自由度可以在多个数量级的范围上视使用者的需求和可能性来选择。在现有技术中,电极间距通过层厚调节的过程费用来限制。
4.磁致伸缩层可以构造为多层式层系统。优选可以以喷镀法交替施加由反铁磁的(AFM)和铁磁的(FM)材料构成的薄层(几纳米厚),所述薄层按照(还未公开的)EP 11171354.1在合适的“磁极化(field annealing)”时构成交换偏置,这使得设置永磁的偏置磁场变得多余。但是,AFM/FM层系统应该沉积在尽可能光滑的并且无结构的基底(例如硅晶片)上。它们在粗糙的和无规律地结构化的陶瓷铁电体上至少较困难地设立,例如借助清除结构的中间层。当在制造分离层ME传感器时实施同一基底的两个平坦侧的涂敷时,精确的多层式层系统的设置是没有问题的。
在这里应该提到,以ME传感器的功能层的两侧基底涂敷的方案当然也可能用于常规的弯曲梁设计。为此首先将面状的下电极和铁电体施加到基底前侧上,然后将面状的上电极施加到其上并且最后将磁致伸缩层施加到基底背侧上。该设计相对于现有技术具有在以上第4点所述的优点,并且当然第1点也适用。当然,只有当以这种方式可以使用具有与至今可能的相比更高的压磁系数的磁致伸缩层系统时,才可能期待更高的ME电压。此外在这里一般将尽可能薄的分离层设置在各功能层之间,因为在铁电体极化时本来就没有电压可能跨越分离层降低。分离层在这里具有完全不同的任务,也就是提供有利地结构化的表面。就这点而言该“几乎常规的”传感器设计符合按照本发明的分离层ME传感器的之前所述的方案,此外,所述分离层ME传感器的特征在于沿着层延展获取电压,不在下面并且在这里也不被要求。
最后提到,在本说明书中,概念“载体层”、“分离层”和“基底”都被用于表示ME传感器中的同一材料并且就这点而言应该作为同义词适用。在这里对于技术主题列举三个概念的原因如下:
a)概念“分离层”最好地涉及发明构思,但对于ME传感器领域中的本领域技术人员不是常用的。因此该概念在权利要求中不应使用。
b)介电“基底”虽然在每个薄层ME传感器中存在,但分离层ME传感器不必强制地以薄层技术制造。例如也可能使用自承载的、预制的铁电陶瓷板作为基底。因为(正如已经解释的那样)在设置和预处理磁致伸缩层之后才可以进行该板沿着其延展的极化,所以当利用高的电压用于极化时,在这里也需要分离层。该分离层因此可能以任何适当的涂敷方法施加到铁电板上,紧接着将磁致伸缩层设置到分离层上。介电分离层因此不是必须强制地是基底,而是也可以特意被涂敷。
c)当研究(并且在此例如切开)任意的符合功能的、已经隔离的薄层ME传感器时,通常找到两个非常薄的功能层和机械地稳定和承载两个功能层的一个介电层。不管该承载的层过去是否为基底或者是否本身作为层被施加,本领域技术人员为此可以接受概念“载体层”。
附图标记列表
10 铁电层
12 磁致伸缩层
14 载体层
16 下电极
18 电极配置结构
ME 磁电传感器
UME 电压
磁电传感器和其制造方法专利购买费用说明
![]()
Q:办理专利转让的流程及所需资料
A:专利权人变更需要办理著录项目变更手续,有代理机构的,变更手续应当由代理机构办理。
1:专利变更应当使用专利局统一制作的“著录项目变更申报书”提出。
2:按规定缴纳著录项目变更手续费。
3:同时提交相关证明文件原件。
4:专利权转移的,变更后的专利权人委托新专利代理机构的,应当提交变更后的全体专利申请人签字或者盖章的委托书。
Q:专利著录项目变更费用如何缴交
A:(1)直接到国家知识产权局受理大厅收费窗口缴纳,(2)通过代办处缴纳,(3)通过邮局或者银行汇款,更多缴纳方式
Q:专利转让变更,多久能出结果
A:著录项目变更请求书递交后,一般1-2个月左右就会收到通知,国家知识产权局会下达《转让手续合格通知书》。
动态评分
0.0