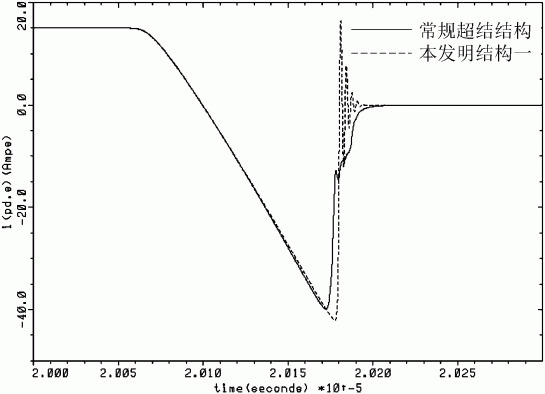
专利摘要
本发明涉及一种带软恢复体二极管的超结功率MOSFET,属于半导体功率器件技术领域,通过在现有的超结功率MOSFET中设置新的耐压层,改变衬底区的结构,或增加缓冲区以及辅助区,有效地提高寄生体二极管反向恢复电流的软度,改善反向恢复特性,同时不增加器件的比导通电阻。反向恢复电流软度的提高使得器件在开关过程中不易产生振荡,抑制了电磁干扰信号,器件工作更加安全可靠。因此,本发明超结功率MOSFET器件特别适用于逆变器硬开关电路。
权利要求
1.一种带软恢复体二极管的超结功率MOSFET,其特征在于:所述超结功率MOSFET由多个重复元胞结构相互拼接而成;
所述元胞结构包含漏电极(01)、源电极(02)、栅电极(03)、源区(10)、源体区(20)、第一漂移区(11)、第二漂移区(21)、衬底区(12)、栅区(30)和绝缘层(40);
所述元胞结构呈上表面不规则的柱状,所述漏电极(01)置于最底层,所述衬底区(12)的下表面与所述漏电极(01)完全贴合;
所述第一漂移区(11)的一侧与第二漂移区(21)的一侧相互接触,所述第一漂移区(11)的另一侧与第二漂移区(21)的另一侧分别形成元胞结构外表面,所述衬底区(12)的两侧分别与元胞结构的外表面齐平,且衬底区(12)在所述第一漂移区(11)一侧的外表面高于在所述第二漂移区(21)的外表面;
所述衬底区(12)在所述第一漂移区(11)一侧的上表面向上凸起,且衬底区(12)的凸起部分上表面与所述第一漂移区(11)的下表面完全接触,且延伸至第二漂移区(21)内,所述第二漂移区(21)的下表面与所述衬底区(12)非凸起部分上表面相互接触,所述第二漂移区(21)的上表面面积大于其下表面面积;
所述源区(10)嵌入所述源体区(20),且所述源区(10)的上表面与所述源体区(20)的上表面齐平,所述源体区(20)的下表面与所述第二漂移区(21)的上表面完全接触,所述源体区(20)的外侧与元胞结构的外表面齐平,所述源体区(20)内侧与所述第一漂移区(11)接触;
所述源电极(02)的下表面分别与所述源区(10)的上表面与所述源体区(20)的上表面接触;
所述栅电极(03)、栅区(30)和绝缘层(40)依次层叠设置,所述绝缘层(40)的表面还与所述源区(10)、源体区(20)和第一漂移区(11)接触;
所述源区(10)、第一漂移区(11)、衬底区(12)、源体区(20)、第二漂移区(21)和栅区(30)均由半导体材料制成,所述漏电极(01)、源电极(02)和栅电极(03)均由金属材料制成;
所述源区(10)、第一漂移区(11)、衬底区(12)、栅区(30)与所述源体区(20)、第二漂移区(21)的掺杂类型不同;
当所述源区(10)、第一漂移区(11)、衬底区(12)和栅区(30)的掺杂类型为N型时,所述源体区(20)、第二漂移区(21)的掺杂类型为P型;
当所述源区(10)、第一漂移区(11)、衬底区(12)和栅区(30)的掺杂类型为P型时,所述源体区(20)、第二漂移区(21)的掺杂类型为N型。
2.根据权利要求1所述的一种带软恢复体二极管的超结功率MOSFET,其特征在于:所述栅电极(03)、栅区(30)和绝缘层(40)依次层叠设置且均向外凸起,所述绝缘层(40)的下表面分别与所述源区(10)、源体区(20)和第一漂移区(11)接触;
所述衬底区(12)与所述第二漂移区(21)接触的面积大于与所述第一漂移区(11)接触的面积。
3.根据权利要求2所述的一种带软恢复体二极管的超结功率MOSFET,其特征在于:所述衬底区(12)基于非凸起部分上表面分为两部分,其中凸起部分划分为缓冲区(14),所述缓冲区(14)由半导体材料制成且掺杂类型与所述源区(10)相同,所述缓冲区(14)的掺杂浓度低于所述衬底区(12)的掺杂浓度,且所述缓冲区(14)的掺杂浓度高于所述第一漂移区(11)的掺杂浓度。
4.根据权利要求2所述的一种带软恢复体二极管的超结功率MOSFET,其特征在于:所述元胞结构还包含辅助区(15),所述辅助区(15)由半导体材料制成且掺杂类型与所述源区(10)相同,所述辅助区(15)的下表面与所述衬底区(12)非凸起部分上表面完全接触,所述辅助区(15)的一侧与所述衬底区(12)的凸起部分一侧相互接触,所述辅助区(15)的外表面与所述第二漂移区(21)的外表面齐平,所述辅助区(15)的上表面与所述第二漂移区(21)的下表面接触。
5.根据权利要求3所述的一种带软恢复体二极管的超结功率MOSFET,其特征在于:所述元胞结构还包含辅助区(15),所述辅助区(15)由半导体材料制成且掺杂类型与所述源区(10)相同,所述辅助区(15)的下表面与所述衬底区(12)上表面相互接触,所述辅助区(15)的一侧与所述缓冲区(14)一侧相互接触,所述辅助区(15)的外表面与所述第二漂移区(21)的外表面齐平,所述辅助区(15)的上表面与所述第二漂移区(21)的下表面接触。
6.根据权利要求1所述的一种带软恢复体二极管的超结功率MOSFET,其特征在于:所述栅电极(03)、栅区(30)和绝缘层(40)依次层叠设置,所述绝缘层(40)呈反L形且两侧包裹住所述栅区(30),所述栅区(30)和绝缘层(40)的上表面与所述源体区(20)的上表面齐平,所述绝缘层(40)的内侧表面与所述源区(10)、源体区(20)和第一漂移区(11)接触,所述绝缘层(40)的下表面与第一漂移区(11)接触。
7.根据权利要求6所述的一种带软恢复体二极管的超结功率MOSFET,其特征在于:所述衬底区(12)基于非凸起部分上表面分为两部分,其中凸起部分划分为缓冲区(14),所述缓冲区(14)由半导体材料制成且掺杂类型与所述源区(10)相同,所述缓冲区(14)的掺杂浓度低于所述衬底区(12)的掺杂浓度,且所述缓冲区(14)的掺杂浓度高于所述第一漂移区(11)的掺杂浓度。
8.根据权利要求6所述的一种带软恢复体二极管的超结功率MOSFET,其特征在于:所述元胞结构还包含辅助区(15),所述辅助区(15)由半导体材料制成且掺杂类型与所述源区(10)相同,所述辅助区(15)的下表面与所述衬底区(12)非凸起部分上表面相互接触,所述辅助区(15)的内侧与所述衬底区(12)的凸起部分内侧相互接触,所述辅助区(15)的外表面与所述第二漂移区(21)的外表面齐平,所述辅助区(15)的上表面与所述第二漂移区(21)的下表面接触。
9.根据权利要求7所述的一种带软恢复体二极管的超结功率MOSFET,其特征在于:所述元胞结构还包含辅助区(15),所述辅助区(15)由半导体材料制成且掺杂类型与所述源区(10)相同,所述辅助区(15)的下表面与所述衬底区(12)上表面相互接触,所述辅助区(15)的内侧与所述缓冲区(14)内侧相互接触,所述辅助区(15)的外表面与所述第二漂移区(21)的外表面齐平,所述辅助区(15)的上表面与所述第二漂移区(21)的下表面接触。
10.根据权利要求1所述的一种带软恢复体二极管的超结功率MOSFET,其特征在于:所述半导体材料为硅、砷化镓、氮化镓或者碳化硅。
说明书
技术领域
本发明属于半导体功率器件技术领域,涉及一种带软恢复体二极管的超结功率MOSFET。
背景技术
超结(Superjunction)功率MOSFET(Metal-Oxide-Semiconductor Field EffectTransistor)即金属-氧化物-半导体场效应晶体管,是为改善传统功率MOSFET中击穿电压(BV)与比导通电阻(RON,SP)之间的矛盾而提出的,它将击穿电压与比导通电阻之间的关系由传统功率MOSFET的RON,SP∝BV
超结功率MOSFET中存在一个由源体区、漂移区、衬底区组成的寄生体二极管,它在感性负载电路中可用于续流,使电路中的元器件数量得以减少。但是,超结功率MOSFET的寄生体二极管有两个缺点:一是反向恢复电荷大,引起较高的反向恢复功耗;二是反向恢复电流变化快,软度差,在高速开关过程中会引起振荡,产生电磁干扰。这两个缺点限制了超结功率MOSFET在硬开关电路中的应用。
商用产品通常会在器件制造过程中使用少子寿命控制技术来减小体二极管的反向恢复电荷,例如使用电子、质子或氦离子辐照,或者使用金、铂等重金属掺杂。少子寿命控制技术一方面会增加器件的反向漏电,另一方面会影响器件的可靠性。另一类解决方案是改进器件结构,其代表是半超结结构,具体措施是在超结部分和衬底之间添加了一层场终止区。场终止区在体二极管反向电流恢复过程中提供过剩载流子,使反向恢复电流缓慢衰减。场终止区的掺杂浓度一般远低于超结柱,即电阻率大于超结柱,这使得半超结结构的比导通电阻大于具有相同电压等级的超结结构。
发明内容
有鉴于此,本发明的目的在于提供一种带软恢复体二极管的超结功率MOSFET,提出一种新的耐压层技术,该技术可以有效地提高寄生体二极管反向恢复电流的软度,改善反向恢复特性,同时不增加器件的比导通电阻。恢复电流软度的提高使得器件在开关过程中不易产生振荡,抑制了电磁干扰信号,器件工作更加安全可靠。
为达到上述目的,本发明提供如下技术方案:
一种带软恢复体二极管的超结功率MOSFET,所述超结功率MOSFET由多个重复元胞结构相互拼接而成;
所述元胞结构包含漏电极01、源电极02、栅电极03、源区10、源体区20、第一漂移区11、第二漂移区21、衬底区12、栅区30和绝缘层40;
所述元胞结构呈上表面不规则的柱状,所述漏电极01置于最底层,所述衬底区12的下表面与所述漏电极01完全贴合;
所述第一漂移区11的一侧与第二漂移区21的一侧相互接触,所述第一漂移区11的另一侧与第二漂移区21的另一侧分别形成元胞结构外表面,所述衬底区12的两侧分别与元胞结构的外表面齐平,且衬底区12在所述第一漂移区11一侧的外表面高于在所述第二漂移区21的外表面;
所述衬底区12在所述第一漂移区11一侧的上表面向上凸起,且衬底区12的凸起部分上表面与所述第一漂移区11的下表面完全接触,且延伸至第二漂移区21内,所述第二漂移区21的下表面与所述衬底区12非凸起部分上表面相互接触,所述第二漂移区21的上表面面积大于其下表面面积;
所述源区10嵌入所述源体区20,且所述源区10的上表面与所述源体区20的上表面齐平,所述源体区20的下表面与所述第二漂移区21的上表面完全接触,所述源体区20的外侧与元胞结构的外表面齐平,所述源体区20内侧与所述第一漂移区11接触;
所述源电极02的下表面分别与所述源区10的上表面与所述源体区20的上表面接触;
所述栅电极03、栅区30和绝缘层40依次层叠设置,所述绝缘层40的表面还与所述源区10、源体区20和第一漂移区11接触;
所述源区10、第一漂移区11、衬底区12、源体区20、第二漂移区21和栅区30均由半导体材料制成,所述漏电极01、源电极02和栅电极03均由金属材料制成;
所述源区10、第一漂移区11、衬底区12、栅区30与所述源体区20、第二漂移区21的掺杂类型不同;
当所述源区10、第一漂移区11、衬底区12和栅区30的掺杂类型为N型时,所述源体区20、第二漂移区21的掺杂类型为P型;
当所述源区10、第一漂移区11、衬底区12和栅区30的掺杂类型为P型时,所述源体区20、第二漂移区21的掺杂类型为N型。
进一步,所述栅电极03、栅区30和绝缘层40依次层叠设置且均向外凸起,所述绝缘层40的下表面分别与所述源区10、源体区20和第一漂移区11接触;
所述衬底区12与所述第二漂移区21接触的面积大于与所述第一漂移区11接触的面积。
进一步,所述衬底区12基于非凸起部分上表面分为两部分,其中凸起部分划分为缓冲区14,所述缓冲区14由半导体材料制成且掺杂类型与所述源区10相同,所述缓冲区14的掺杂浓度低于所述衬底区12的掺杂浓度,且所述缓冲区14的掺杂浓度高于所述第一漂移区11的掺杂浓度。
进一步,所述元胞结构还包含辅助区15,所述辅助区15由半导体材料制成且掺杂类型与所述源区10相同,所述辅助区15的下表面与所述衬底区12非凸起部分上表面完全接触,所述辅助区15的一侧与所述衬底区12的凸起部分一侧相互接触,所述辅助区15的外表面与所述第二漂移区21的外表面齐平,所述辅助区15的上表面与所述第二漂移区21的下表面接触。
进一步,所述元胞结构还包含辅助区15,所述辅助区15由半导体材料制成且掺杂类型与所述源区10相同,所述辅助区15的下表面与所述衬底区12上表面相互接触,所述辅助区15的一侧与所述缓冲区14一侧相互接触,所述辅助区15的外表面与所述第二漂移区21的外表面齐平,所述辅助区15的上表面与所述第二漂移区21的下表面接触。
进一步,所述栅电极03、栅区30和绝缘层40依次层叠设置,所述绝缘层40呈反L形且两侧包裹住所述栅区30,所述栅区30和绝缘层40的上表面与所述源体区20的上表面齐平,所述绝缘层40的内侧表面与所述源区10、源体区20和第一漂移区11接触,所述绝缘层40的下表面与第一漂移区11接触。
进一步,所述衬底区12基于非凸起部分上表面分为两部分,其中凸起部分划分为缓冲区14,所述缓冲区14由半导体材料制成且掺杂类型与所述源区10相同,所述缓冲区14的掺杂浓度低于所述衬底区12的掺杂浓度,且所述缓冲区14的掺杂浓度高于所述第一漂移区11的掺杂浓度。
进一步,所述元胞结构还包含辅助区15,所述辅助区15由半导体材料制成且掺杂类型与所述源区10相同,所述辅助区15的下表面与所述衬底区12非凸起部分上表面相互接触,所述辅助区15的内侧与所述衬底区12的凸起部分内侧相互接触,所述辅助区15的外表面与所述第二漂移区21的外表面齐平,所述辅助区15的上表面与所述第二漂移区21的下表面接触。
进一步,所述元胞结构还包含辅助区15,所述辅助区15由半导体材料制成且掺杂类型与所述源区10相同,所述辅助区15的下表面与所述衬底区12上表面相互接触,所述辅助区15的内侧与所述缓冲区14内侧相互接触,所述辅助区15的外表面与所述第二漂移区21的外表面齐平,所述辅助区15的上表面与所述第二漂移区21的下表面接触。
进一步,所述半导体材料为硅、砷化镓、氮化镓或者碳化硅。
本发明的有益效果在于:本发明可以有效地提高寄生体二极管反向恢复电流的软度,改善反向恢复特性,同时不增加器件的比导通电阻。反向恢复电流软度的提高使得器件在开关过程中不易产生振荡,抑制了电磁干扰信号,器件工作更加安全可靠。本发明超结功率MOSFET器件特别适用于逆变器硬开关电路。
附图说明
为了使本发明的目的、技术方案和有益效果更加清楚,本发明提供如下附图进行说明:
图1为现有半超结MOSFET结构图;
图2为本发明实施例的第一种结构示意图;
图3为本发明实施例的第二种结构示意图;
图4为本发明实施例的第三种结构示意图;
图5为本发明实施例的第四种结构示意图;
图6为本发明实施例的第五种结构示意图;
图7为本发明实施例的第六种结构示意图;
图8为本发明实施例的第七种结构示意图;
图9为本发明实施例的第八种结构示意图;
图10为本发明实施例第一种结构与常规超结结构的体二极管反向恢复电流示意图。
具体实施方式
下面将结合附图,对本发明的优选实施例进行详细的描述。
如图所示,其中附图标记为01漏电极,02源电极,03栅电极,10源区,11第一漂移区,12衬底区,13场终止区,14缓冲区,15辅助区,20源体区,21第二漂移区,30栅区,40绝缘层。源区10、第一漂移区11、衬底区12、缓冲区14、辅助区15、源体区20、第二漂移区21和栅区30均由半导体材料制成,漏电极01、源电极02和栅电极03均由金属材料制成。
图1为现有的半超结MOSFET元胞结构图,其中场终止区13设置在12衬底区上,其上表面与11第一漂移区和21第二漂移区的下表面接触,其中源区10、第一漂移区11、衬底区12、场终止区13、栅区30的掺杂类型相同为第一种导电类型,源体区20、第二漂移区21的掺杂类型相同为第二种导电类型。
本发明提供了一种超结功率MOSFET,其元胞结构包括:由第一种导电类型的第一漂移11区和第二种导电类型的第二漂移区21组成的耐压层,耐压层有两个表面;在上表面中设有至少一个第二种导电类型的半导体源体区20,源体区20之内又至少有一个第一种导电类型的重掺杂的半导体源区10,部分源区10和部分源体区20通过导体相连,构成器件的源电极02;在部分源区10和部分源体区20以及部分耐压层的表面覆盖有绝缘层40,在绝缘层40上覆盖有作为器件栅电极的第一种导电类型的重掺杂的半导体多晶硅栅区30,栅区30的部分表面覆盖有导体,作为器件的栅电极03;在下表面中设有一个第一种导电类型的重掺杂的半导体衬底区12,在衬底区12表面覆盖有作为漏电极01的导体。
耐压层中的第一漂移区11和的第二漂移区21直接接触;第二漂移区21的厚度大于第一漂移区11的厚度。
第一漂移区11和第二漂移区21与源体区20和衬底区12均直接接触;第一漂移区11和第二漂移区21的接触面垂直于源体区20和衬底区12;第二漂移区21与衬底区12的接触面积大于第一漂移区11与衬底区12的接触面积。
部分源区10、部分源体区20、绝缘层40、栅区30、栅电极03和部分第一漂移区11构成器件的第一种导电类型的MOSFET栅极结构。
本发明最重要之处在于第二漂移区21的厚度大于第一漂移区11的厚度,这一点正好和半超结MOSEFT结构相反。如图1所示,在半超结MOSEFT结构中,第一漂移区11的厚度大于第二漂移区21的厚度。与常规超结MOSFET结构相比,可以认为本发明结构的第二漂移区21延伸至衬底区12里面。延伸部分在体二极管导通时会积累一定量的非平衡载流子。在体二极管反向恢复过程中,当超结结构部分载流子浓度突然减小时,这些积累的载流子及时予以补充,从而保证反向恢复电流平滑衰减,实现软恢复。
本发明结构的正向阻断特性与第二漂移区21中的延伸部分密切有关,基本要求是在第二漂移区中,被衬底区包围的部分的宽度小于被第一漂移区包围的部分的宽度。
第一导电类型为N型时,第二导电类型为P型;第一导电类型为P型时,第二导电类型为N型。
半导体材料可以是硅材料,也可以是砷化镓、氮化镓或者碳化硅等材料。
第一漂移区11可以通过一个掺杂浓度低于衬底区12的第一种导电类型的半导体缓冲区14与衬底区12间接接触,缓冲区14的掺杂浓度应大于第一漂移区11的掺杂浓度。
第二漂移区21可以通过一个轻掺杂的第一种导电类型的半导体辅助区15与衬底区12间接接触。
元胞栅极结构可以是平面型栅极结构,也可以是沟槽型栅极结构。
元胞栅极结构可以是条形、六角形、矩形和圆形等形状,耐压层中第一漂移区和第二漂移区的排列方式可以是条形、六角形、矩形和圆形等。
如图2所示,元胞为平面栅结构且延伸区被重掺杂的衬底区包围,元胞结构包含漏电极01、源电极02、栅电极03、源区10、源体区20、第一漂移区11、第二漂移区21、衬底区12、绝缘层40和栅区30。
元胞结构呈上表面不规则的柱状,漏电极01置于最底层,衬底区12的下表面与漏电极01完全贴合。
第一漂移区11的一侧与第二漂移区21的一侧相互接触,第一漂移区11的另一侧与第二漂移区21的另一侧分别形成元胞结构外表面,衬底区12的两侧分别与元胞结构的外表面齐平,且衬底区12在第一漂移区11一侧的外表面高于在第二漂移区21的外表面。
衬底区12在第一漂移区11一侧的上表面向上凸起,且衬底区12的凸起部分上表面与第一漂移区11的下表面完全接触,且延伸至第二漂移区21内,第二漂移区21的下表面与衬底区12非凸起部分上表面相互接触,第二漂移区21的上表面面积大于其下表面面积。
源区10嵌入源体区20,且源区10的上表面与源体区20的上表面齐平,源体区20的下表面与第二漂移区21的上表面完全接触,源体区20的外侧与元胞结构的外表面齐平,源体区20内侧与第一漂移区11接触。
源电极02的下表面分别与源区10的上表面与源体区20的上表面接触,栅电极03、栅区30和绝缘层40依次层叠设置,绝缘层40的表面还与源区10、源体区20和第一漂移区11接触。
栅电极03、栅区30和绝缘层40依次层叠设置且均向外凸起,绝缘层40的下表面分别与源区10、源体区20和第一漂移区11接触,衬底区12与第二漂移区21接触的面积大于与第一漂移区11的面积。
如图3所示,元胞为平面栅结构且延伸区被中等掺杂的缓冲区包围,衬底区12基于非凸起部分上表面分为两部分,其中凸起部分划分为缓冲区14,缓冲区14的掺杂浓度低于衬底区12的掺杂浓度,且缓冲区14的掺杂浓度高于第一漂移区11的掺杂浓度。
如图4所示,元胞为平面栅结构且延伸区被重掺杂的衬底区包围、延伸区中包含轻掺杂辅助区,元胞结构还包含辅助区15,辅助区15的下表面与衬底区12非凸起部分上表面完全接触,辅助区15的一侧与衬底区12的凸起部分一侧相互接触,辅助区15的外表面与第二漂移区21的外表面齐平,辅助区15的上表面与第二漂移区21的下表面接触。
如图5所示,元胞为平面栅结构且延伸区被中等掺杂的缓冲区包围、延伸区中包含轻掺杂辅助区,元胞结构还包含辅助区15,辅助区15的下表面与衬底区12上表面相互接触,辅助区15的一侧与缓冲区14一侧相互接触,辅助区15的外表面与第二漂移区21的外表面齐平,辅助区15的上表面与第二漂移区21的下表面接触。
如图6所示,元胞为沟槽栅结构且延伸区被重掺杂的衬底区包围,栅电极03、栅区30和绝缘层40依次层叠设置,绝缘层40呈反L形且两侧包裹住栅区30,栅区30和绝缘层40的上表面与源体区20的上表面齐平,绝缘层40的内侧表面与源区10、源体区20和第一漂移区11接触,绝缘层40的下表面与第一漂移区11接触。
如图7所示,元胞为沟槽栅结构且延伸区被中等掺杂的缓冲区包围,衬底区12基于非凸起部分上表面分为两部分,其中凸起部分划分为缓冲区14,缓冲区14的掺杂浓度低于衬底区12的掺杂浓度,且缓冲区14的掺杂浓度高于第一漂移区11的掺杂浓度。
如图8所示,元胞为沟槽栅结构且延伸区被重掺杂的衬底区包围、延伸区中包含轻掺杂辅助区,元胞结构还包含辅助区15,辅助区15的下表面与衬底区12非凸起部分上表面相互接触,辅助区15的内侧与衬底区12的凸起部分内侧相互接触,辅助区15的外表面与第二漂移区21的外表面齐平,辅助区15的上表面与第二漂移区21的下表面接触。
如图9所示,元胞为沟槽栅结构且延伸区被中等掺杂的缓冲区包围、延伸区中包含轻掺杂辅助区,元胞结构还包含辅助区15,辅助区15的下表面与衬底区12上表面相互接触,辅助区15的内侧与缓冲区14内侧相互接触,辅助区15的外表面与第二漂移区21的外表面齐平,辅助区15的上表面与第二漂移区21的下表面接触。
如图10所示为本发明实施例的第一种结构与常规超结结构的体二极管反向恢复电流示意图,传统结构反向恢复电流变化快,如图中虚线所示,存在振荡,本发明的反向恢复电流平滑衰减,基本没有振荡产生,如图中实线所示。由此抑制了电磁干扰信号,器件工作更加安全可靠。
最后说明的是,以上优选实施例仅用以说明发明的技术方案而非限制,尽管通过上述优选实施例已经对本发明进行了详细的描述,但本领域技术人员应当理解,可以在形式上和细节上对其作出各种各样的改变,而不偏离本发明权利要求书所限定的范围。
一种带软恢复体二极管的超结功率MOSFET专利购买费用说明
![]()
Q:办理专利转让的流程及所需资料
A:专利权人变更需要办理著录项目变更手续,有代理机构的,变更手续应当由代理机构办理。
1:专利变更应当使用专利局统一制作的“著录项目变更申报书”提出。
2:按规定缴纳著录项目变更手续费。
3:同时提交相关证明文件原件。
4:专利权转移的,变更后的专利权人委托新专利代理机构的,应当提交变更后的全体专利申请人签字或者盖章的委托书。
Q:专利著录项目变更费用如何缴交
A:(1)直接到国家知识产权局受理大厅收费窗口缴纳,(2)通过代办处缴纳,(3)通过邮局或者银行汇款,更多缴纳方式
Q:专利转让变更,多久能出结果
A:著录项目变更请求书递交后,一般1-2个月左右就会收到通知,国家知识产权局会下达《转让手续合格通知书》。
动态评分
0.0